ニュース
Intelがガラス基板を本格採用へ、2020年代後半から:「ムーアの法則」継続に向け(1/2 ページ)
Intelは、パッケージ基板の材料にガラスを採用することを発表した。データセンターやAI(人工知能)などワークロードが高い用途をターゲットに、ガラス基板パッケージを採用したチップを2020年代後半にも投入する計画だ。
Intelは2023年9月18日(米国時間)、次世代のパッケージング技術としてガラス基板を採用することを発表した。ガラス基板パッケージを用いたチップを2020年代後半にも投入する予定だ。従来の有機基板を用いるパッケージに比べて、より高性能かつ高密度なパッケージを実現できるとする。データセンターやAI(人工知能)、グラフィックスなど大規模なワークロードが必要な用途に向ける。Intelは、「ガラス基板パッケージにより、データセントリックのアプリケーションに向けて、『ムーアの法則』を継続できるようになる」と述べる。
ガラス基板は、高温への耐性がある、回路パターンのゆがみが少ない、平たん性があるといった特長を持つ。こうした特性を生かすと、高密度なインターコネクトや、高い歩留まりでの大型フォームファクターを実現できるとする。Intelは「従来の有機基板は低コストかつ製造しやすいというメリットがある。だがガラス基板を用いれば、電気的および機械的に、より優れた特性を持つパッケージを実現できる」と強調した。
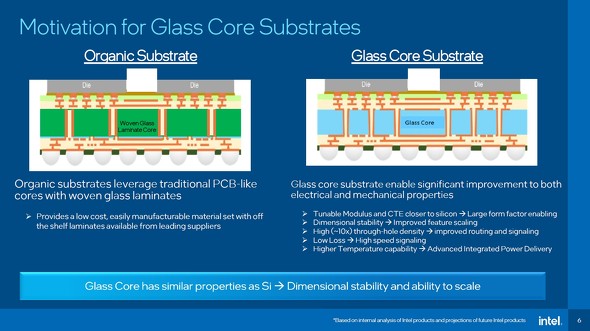
ガラス基板を用いたパッケージの利点。シリコンに近いCTEを持つガラス基板を使うことで、大面積のパッケージを実現しやすくなる、スルーホールの密度を高められるので内部の通信が高速になる、などが挙げられている[クリックで拡大] 出所:Intel
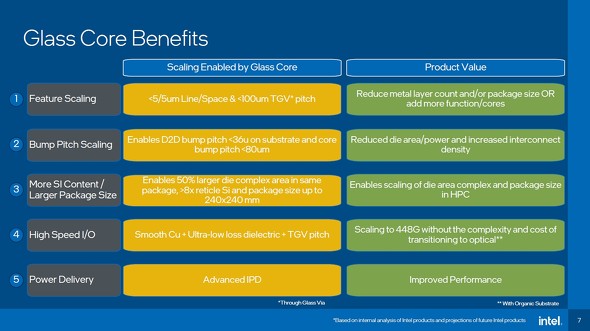
ガラス基板を用いる利点の詳細。5/5μmのL/Sや、ピッチが100μm未満のTSV(Through Glass Via)、80μm未満のバンプピッチ、240×240mmの大面積パッケージなどが可能になるとしている[クリックで拡大] 出所:Intel
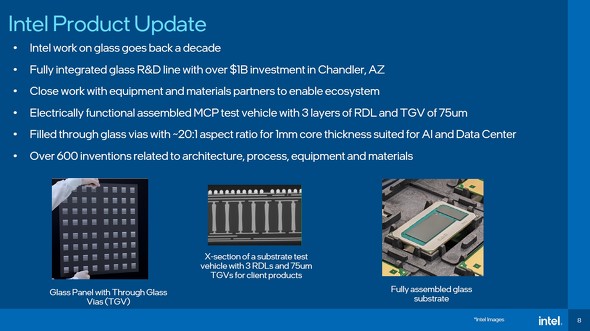
ガラス基板パッケージの試作品の詳細。中央の写真(テストチップの断面の電子顕微鏡写真)には、3層のRDL(再配線層)と、ピッチが75μmでアスペクト比が20:1のTSV(Through Glass Via)が示されている[クリックで拡大] 出所:Intel
Copyright © ITmedia, Inc. All Rights Reserved.