EUV露光に残された課題――ペリクルの現在地と展望とは:湯之上隆のナノフォーカス(86)(2/5 ページ)
2025年11月に都内で開催されたimecのフォーラム「ITF Japan 2025」から、三井化学による極端紫外線(EUV)露光用ペリクル(保護膜)の講演を解説する。最先端の半導体製造に不可欠なEUV露光だが、実は、ペリクルに関しては依然として多くの課題がある。三井化学はそれをどう解決しようとしているのか。
EUVペリクルが果たす役割
図3を用いて、EUVペリクルが果たす役割について説明する。ペリクルとは、レチクル表面への異物付着を防ぐために設置される薄い保護膜である。
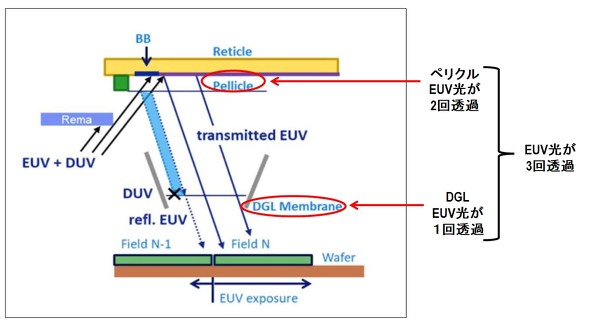
図3:EUVペリクルとDynamic Gas Lock(DGL)の役割[クリックで拡大] 出所:Mark van de Kerkhof, et al (ASML)., “High-transmission EUV pellicles supporting >400W source power”, Proc. of SPIE Vol. 12051 120510B-1 の図にに筆者加筆
もしレチクルそのものに異物が付着すれば、露光時にその影がウエハー上のレジストに投影され、欠陥を生じさせる。しかし、レチクル上に設置されたペリクルに異物が付着した場合、その異物は焦点外に位置するため、ウエハー上に欠陥を生じさせることはない。すなわち、ペリクルの第1の役割は、レチクルを異物から保護することである。
ここで、EUVペリクルは、波長248nmのKrFや波長193nmのArF露光装置に用いられる、透過型の従来ペリクルとは使用条件がまったく異なる。KrFやArF露光では、透過型のレチクルとレンズを用いるため、ペリクルはこれらの波長の光を一度透過すれば機能を果たす。
一方、EUV露光では、波長13.5nmの光を、多層膜ミラーで複数回反射・集光し、レチクルに照射した後、その反射光をウエハー上のレジストに導く。このため、EUV光はペリクルを、往路と復路で2回透過することになる。
さらに問題となるのが、EUV光源からは、13.5nmだけでなく、深紫外線(DUV)などの広帯域光も同時に放射される点である。これらのDUV光がレジストに到達すると、パターン形成に深刻な影響を及ぼす。そこで、ウエハー直前にはDGL(Dynamic Gas Lock)と呼ばれる薄膜を配置し、DUV成分を遮断する必要がある。
その結果として、EUV露光装置では、13.5nmの光が、
ペリクル2回透過+DGL1回透過=合計3回透過
を経てレジストに到達する。従って、これらペリクルやDGL薄膜の透過率が低ければ、レジストへの照射強度が減少し、解像度の低下やスループットの悪化を招く。
では、現時点のEUVペリクルの透過率はどの程度なのだろうか?
EUVペリクルのRoadmap
図4に、ASMLにおけるEUVペリクルのRoadmapを示す。2018年頃は、ポリシリコン(p-Si)をコアとしたペリクルが開発されていた。その透過率は、1回だけペリクルを透過する場合(Pellicle EUV transmission、singlepass)は82%で、3回透過するとそのTotal EUV transmissionは57%になってしまう。要するに、レジスト上に到達するEUV光はペリクルとDGLのために約半分になってしまうわけだ。

図4:ASMLにおけるEUVペリクルのRoadmap[クリックで拡大] 出所:Anthony Yen (ASML), “EUV Lithography Overview and Outlook”, 次世代リソグラフィ研究会(2024年7月4日)のスライド
これが、2024年になると、EUV光の1回透過率が90%になり、3回透過する場合は73%に改善されていることが分かる。このペリクル材料には、図中に「Composite+」と書かれているが、恐らく、CNTが使われていると推察される。
ところが、CNTペリクルを量産に使うためには、解決しなければならない大きな問題が存在する。その詳細を次節で述べる。
Copyright © ITmedia, Inc. All Rights Reserved.