ヘリウム調達停止――AIブームを崩壊させる「見えない臨界点」(前編):湯之上隆のナノフォーカス(89-1)(6/6 ページ)
米国とイスラエルによるイラン攻撃に端を発した中東問題は、半導体業界にも多大な影響をもたらす。その最たるものがヘリウム(He)の供給停止だ。本稿では、ヘリウム調達停止が半導体業界に与える影響を前後編に分けて詳細に解説、考察する。【訂正あり】
Appendix:TELが開発したHF/PF3+Cryoエッチング
ここからは、TELが開発した極低温エッチング技術「HF/PF3+Cryoエッチング」の詳細を説明したい。
3D NANDでは、数百層以上に及ぶメモリセルの積層構造を貫通する、深さと直径の比(アスペクト比)が100を超えるメモリホールを開孔しなければならない。そのメモリホールは、12インチウエハー1枚当たり数兆個に達する。そして1本でも形状不良のホールがあれば、周辺のメモリセルが不良となる。従って、ウエハー全面にわたって面内均一なエッチング条件を維持する必要がある。
以下では、この深孔加工について、東京エレクトロン(TEL)が開発し、2023年のVLSIシンポジウムで発表した技術を解説する(詳細は拙稿を参照ください、EE Times Japan、『裏面電源供給がブレークする予感、そしてDRAMも3次元化に加速 〜VLSI2023』、2023年07月26日)。
3D NANDのHARエッチングで広く使われてきたCF系プラズマには、本質的なトレードオフがあった。CF系のポリマーが孔の側壁に堆積することによりボーイング(横方向へのエッチング)を防止する一方、孔が深くなるほどCFラジカルの孔底への到達量が減少し、エッチング速度が極端に低下する。
ここで、ポリマーの堆積を抑制すべくウエハー温度を上げれば、孔底へのラジカル輸送は改善するが、側壁保護が弱まりボーイングが発生する。すなわち、側壁保護と孔底到達はトレードオフの関係にあり、最適化が困難な状態にあった。
TELは2023年のVLSIシンポジウムにおいて、このトレードオフを打破する新手法を発表した(図3)。HFとPF3を混合させた新しいガス系を、−60℃の極低温と組み合わせることにより、孔の側壁への反応生成物などの堆積を大幅に低減しながらボーイングを抑制し、高速なHARエッチングを実現した。
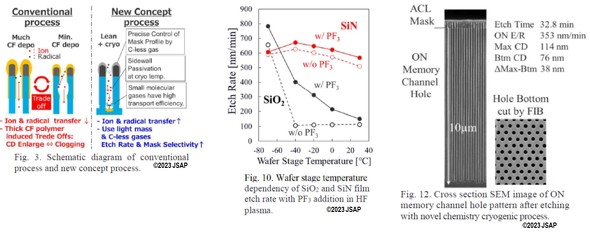
図3:TELが開発した新手法 出所:Yoshihide Kihara et al. (TEL) “Beyond 10 μm Depth Ultra-High Speed Etch Process with 84% Lower Carbon Footprint for Memory Channel Hole of 3D NAND Flash over 400 Layers”, 2023 Symposium on VLSI Technology and Circuits Digest of Technical Papers, T3-2
TELの発表論文の図3の中のFig.13には、従来のCF系プラズマとHF/PF3+Cryoのエッチングモデルが示されている。CF系プラズマでは、CF系のポリマーが孔の側壁などに分厚く堆積する。このポリマーはボーイングを防止するが、孔が深くなるほど、孔底に到達するCFラジカルが減少し、エッチング速度が極端に低下する。
一方、HF/PF3+Cryoの場合では、孔の側壁への堆積が非常に少ない。すなわち、反応種のHFは側壁にあまり"食われず"に孔底に供給される。そして、孔の側壁への堆積が少なくてもボーイングを防止できる。その結果、ボーイングなしで、高速なHARエッチングが可能となるわけだ。
図3の中のFig.10をみると、SiNのエッチング速度は温度であまり変わらず、PF3を添加してもしなくても、あまり変化はない。一方、SiO2は、低温にするほどエッチング速度が上がる。また、PF3を添加すると、より高速なエッチングが可能になる。この選択性の温度依存性がクライオエッチの技術的根拠であり、−80〜−100℃とさらに低温化できれば、一層の高速化が見込まれるとされる。
最終結果を図3の中のFig.12に示す。SiO2とSiNの積層膜10μmを、HF/PF3+Cryo(−60℃)の条件で、32.8分でエッチングできた。エッチング速度は353nm/minと非常に高速であり、孔の最大のCDは114nmで、最小のCDは76nmだった。
この発表の本質は、新しいガス系(HF/PF3)と極低温(−60℃)を組み合わせることにより、3D NANDメモリホールの実用的なHARエッチングを実現した点にある。その後、HARエッチングの分野で独占的地位にあった米Lam Researchも追随し、両社間で量産用装置の開発競争が本格化した。
注目すべきは、このプロセスが−60℃以下の極低温を前提条件としている点である。この極低温の維持を支えているのが、極低温チラーとHeによる裏面冷却にほかならない。
筆者プロフィール
湯之上隆(ゆのがみ たかし)微細加工研究所 所長
1961年生まれ。静岡県出身。京都大学大学院(原子核工学専攻)を修了後、日立製作所入社。以降16年にわたり、中央研究所、半導体事業部、エルピーダメモリ(出向)、半導体先端テクノロジーズ(出向)にて半導体の微細加工技術開発に従事。2000年に京都大学より工学博士取得。現在、微細加工研究所の所長として、半導体・電機産業関係企業のコンサルタントおよびジャーナリストの仕事に従事。著書に『日本「半導体」敗戦』(光文社)、『「電機・半導体」大崩壊の教訓』(日本文芸社)、『日本型モノづくりの敗北 零戦・半導体・テレビ』(文春新書)。2023年4月には『半導体有事』(文春新書)を上梓。
Copyright © ITmedia, Inc. All Rights Reserved.
関連記事
 AI普及で電力が足りない テック企業の電力会社投資が加速
AI普及で電力が足りない テック企業の電力会社投資が加速
生成AIの普及により深刻化する、データセンターの電力消費問題。ハイパースケーラー各社はどう取り組むのか。 AIは「バブル」ではない――桁違いの計算量が半導体に地殻変動を起こす
AIは「バブル」ではない――桁違いの計算量が半導体に地殻変動を起こす
昨今のAI関連投資の拡大傾向を「AI市場はバブルだろう」とみる向きは少なくない。だが筆者はそうは思わない。その理由を解説したい。 EUV露光に残された課題――ペリクルの現在地と展望とは
EUV露光に残された課題――ペリクルの現在地と展望とは
2025年11月に都内で開催されたimecのフォーラム「ITF Japan 2025」から、三井化学による極端紫外線(EUV)露光用ペリクル(保護膜)の講演を解説する。最先端の半導体製造に不可欠なEUV露光だが、実は、ペリクルに関しては依然として多くの課題がある。三井化学はそれをどう解決しようとしているのか。 TSMCはもはや世界の「中央銀行」 競争力の源泉は150台超のEUV露光装置
TSMCはもはや世界の「中央銀行」 競争力の源泉は150台超のEUV露光装置
2025年第3四半期、TSMCは過去最高の売上高と営業利益を記録した。なぜ、TSMCはここまで強いのか。テクノロジーノード別/アプリケーション別の同社の売上高と、極端紫外線(EUV)露光装置の保有台数を基に、読み解いてみたい。 赤信号灯るIntel、5年後はどうなっているのか
赤信号灯るIntel、5年後はどうなっているのか
Intelが極度の経営難に陥っている。AI半導体ではNVIDIAに全く追い付けず、x86 CPUでもAMDを相手に苦戦を強いられている。前CEO肝入りだったファウンドリー事業も先行きは暗い。Intelは今後どうなっていくのだろうか。【修正あり】