ヘリウム調達停止――AIブームを崩壊させる「見えない臨界点」(前編):湯之上隆のナノフォーカス(89-1)(1/6 ページ)
米国とイスラエルによるイラン攻撃に端を発した中東問題は、半導体業界にも多大な影響をもたらす。その最たるものがヘリウム(He)の供給停止だ。本稿では、ヘリウム調達停止が半導体業界に与える影響を前後編に分けて詳細に解説、考察する。【訂正あり】
カタールのLNG施設停止でHe供給の3割が消失
2026年3月、カタールの液化天然ガス(LNG)施設停止により世界のヘリウム(He)供給の33%が消失した。ヘリウムは静電チャック(ESC)というウエハステージを使うドライエッチング装置においてはウエハー裏面冷却を担う唯一無二の熱制御ガスであり、その途絶は「歩留り低下」ではなく「プロセス成立不能」を意味する。
3D NAND型フラッシュメモリの極低温エッチング、広帯域メモリ(HBM)のシリコン貫通電極(TSV)形成、GAA(Gate-All-Around)のナノシート形成につかわれる高選択比プラズマエッチングやプラズマによる表面処理といった工程など、先端・成熟を問わず半導体製造の全領域が影響を受ける。韓国メモリメーカーのHe在庫は5カ月を切り、TSMCはHe不足と電力制約の二重苦に直面する。産業ガス供給者から半導体メーカー、AIチップベンダー、ハイパースケーラーへと連鎖するフォース・マジュール(不可抗力条項)は、年間3000億米ドル超のAIインフラ投資を物理的に実行不能にしかねない。AIブームの最大のリスクは電力でも需要減退でもない。半導体を「つくれなくなる」ことそのものである。
第1章:中東情勢が引き起こした「ヘリウムショック」
中東情勢の緊迫化に伴い、ホルムズ海峡の封鎖リスクが現実のものとなりつつある。これに伴い、LNGおよびその副産物であるHeの調達が困難になりつつある。
2026年3月以降、ロイター通信や日本経済新聞などの複数の報道によれば、カタールのLNG関連施設は軍事的影響を受け、生産・輸出の双方に深刻な支障が生じている。HeはLNG精製過程の副産物であるため、LNGの生産停止はHe供給の制約に直結する。
米国の産業ガス大手Airgas社(仏Air Liquide傘下)は2026年3月17日にフォース・マジュール(不可抗力条項)を宣言しており、カタール由来のHe供給が実質的に停止状態にあることを裏付けている。
2026年4月1日付の日本経済新聞によれば、2025年の世界のHe生産シェアは、米国43%、カタール33%、ロシア9%、アルジェリア6%とされる(図1)。このうちカタールの供給が大きく毀損したことにより、単純計算でも世界供給の約3分の1が失われたに等しい状況となっている。
ただし重要なのは、この供給減が単なる「数量不足」にとどまらない点である。Heは代替が極めて難しく、かつ特定地域に生産が集中し、さらに極低温輸送という特殊な物流インフラに依存している。供給の途絶はサプライチェーン全体の機能不全へと直結する。
なぜヘリウムがこれほど重要なのか
Heは沸点が−269℃と極めて低く、高い熱伝導率、化学的不活性、極めて小さな原子半径を持つ。これらの特性から、医療(MRIの超伝導磁石冷却)、宇宙(ロケット燃料タンクのパージ)、半導体製造(ウエハー温度制御、パージガス)など幅広い産業で不可欠な資源となっている。しかし半導体製造においては、その役割は単なる材料ではなく、「プロセス成立条件」に近い意味を持つ。
半導体製造装置においてHeは、ドライエッチング装置、化学気相成長(CVD)装置、極端紫外線(EUV)露光装置などで使用される。その中でも供給途絶の影響が最も深刻なのがドライエッチング工程だ。
ドライエッチング装置では、プラズマによって加熱されるウエハーの温度をHeガスによって精密に制御しており、この機構が機能しなければエッチングプロセスそのものが成立しない。EUV露光装置におけるHe供給途絶の影響についても別途分析を進めているが、本稿ではまず、筆者の専門であるドライエッチング装置に焦点を当てる(なお、その後の有識者への調査によりEUV露光装置においてHeは必須のガスではないと伺った。一方で、ドライエッチング装置と同様に、レチクルのステージとして使われる静電チャックの温度制御にHeが必要とされる説もある。加えて、CVD装置においてはキャリアガスとしてHeが使われている模様だが、こちらも現時点で詳細を把握できていないので、今後鋭意調査を進めることとする)
ここで、Heの供給問題は特定の先端プロセスだけの話ではない。ドライエッチングはノードの世代やデバイスの種類を問わず使用される基幹工程であり、He供給の途絶は世界の半導体製造全体の根幹を揺るがす。
次章では、ドライエッチングにおけるウエハー温度制御の仕組みを解説し、なぜHeが技術的に代替不可能なのかを明らかにする。
第2章:ドライエッチング装置の温度制御の原理
ドライエッチング技術において、ウエハーの温度制御は常に重要な要素であったが、微細化が進み、最小加工寸法(Critical Dimension、CD)制御にナノメートル(nm)オーダーの精度が求められるようになった現在、その重要性はかつてないほど高まっている。本章では、ドライエッチング装置における温度制御の仕組みを、図2を用いて解説する。
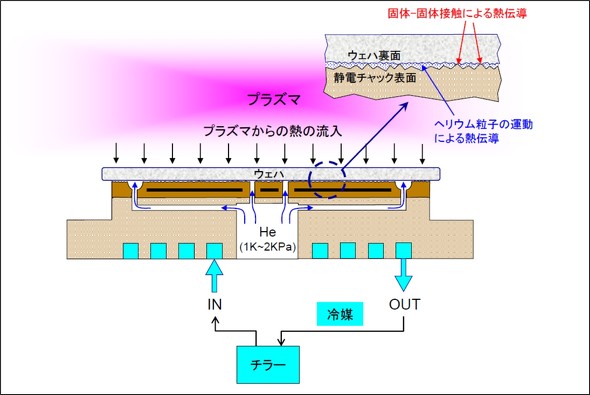
図2:ドライエッチング装置における温度制御の原理[クリックで拡大] 出所:野尻一男(Nanotech Research) 『はじめての半導体ドライエッチング技術』(技術評論社)、90ページの図4-16
2-1)プラズマからの入熱と温度上昇
ドライエッチング中には、プラズマからの放射熱に加え、イオン・中性ラジカル・電子の入射や各種波長の紫外線照射を介して、ウエハーに熱が流入する。この入熱に対して何ら措置を講じなければ、ウエハー温度は際限なく上昇し、エッチング速度(エッチレート)や選択比、パターン形状といったエッチング特性が制御不能となる。さらに、これらエッチング特性のウエハー面内均一性も損なわれる。
2-2)チラーによる静電チャックの温度制御
そこで、チラー(温調循環装置)によって温度制御された冷媒を、ウエハーのステージとなる静電チャック(Electrostatic Chuck、ESC)内部の流路に循環させ、ESC自体の温度を目標値に維持している。
2-3)Heによる裏面冷却
しかし、ESCとウエハーの間には微細な隙間(数十μm程度)が存在し、物理的接触だけでは十分な熱伝達が得られない。そこで、この隙間にHeガスを数〜数十Torrの圧力で導入し、気体熱伝導によってウエハーからESCへの熱輸送を補助している(図2の右上の図)。
Heが選ばれる理由は、その物理的特性にある。Heは単原子分子であり、原子量が4と極めて小さいため、同じ温度でも分子運動速度がN2やArより格段に速い。そして、気体の熱伝導率は分子運動速度に比例するため、Heの熱伝導率は常温で約0.15 W/(m・K)と、N2(約0.026 W/(m・K))の約6倍、Ar(約0.018 W/(m・K))の約8倍に達する。
加えて、Heは化学的に完全な不活性ガスであり、プラズマ環境下でもウエハーやESC表面と反応しない。この「高い熱伝導率」と「化学的不活性」の組み合わせが、Heを裏面冷却ガスとして代替不可能な存在にしている。
2-4)広い温度帯域への対応
なお、ドライエッチング装置における温度帯域は極めて広い。SiO2やSiNなどの絶縁膜エッチング工程では100℃近い高温が用いられる場合がある一方、3D NANDの高アスペクト比エッチングでは−60〜−80℃の極低温(クライオエッチング)が採用されている。
また、W、TiN、Al、Ta、ポリSiなどの導電膜のドライエッチングでは、材料ごとに最適温度は異なるものの、おおむね20〜80℃の範囲に制御される。ただし、いずれの温度帯域においても本質的に重要なのは、ウエハー面内の温度均一性を±1℃以下に維持することであり、それを支えているのがHe冷却である。
2-5)Heは「消耗品」として使い捨てされている
ここで注意すべきは、裏面冷却に使用されたHeが回収・循環されず、そのまま排気される点である。ESCとウエハーの隙間から漏れ出したHeは、チャンバー内のプロセスガスおよびエッチングによって生じた反応生成物と混合され、ターボ分子ポンプなどの真空ポンプを介して排気される。
そして、排気中のHe濃度は低く、プロセスガスとの分離・精製にはコストが掛かるため、多くの半導体工場ではHeを事実上の消耗品として扱っている。この「使い捨て」の構造が、ドライエッチング装置のHe消費量を押し上げている。
2-6)He途絶が意味するもの
以上から明らかなように、Heは単なる補助ガスではなく、ドライエッチング装置における「熱制御インフラ」そのものである。このことの重大さは、He供給が途絶した場合を想定すると明確になる。
- 裏面冷却Heガスがなくなると、ウエハーとESC間の熱伝達効率は大幅に低下する。
- プラズマからの入熱を十分に排熱できなくなり、ウエハー温度は上昇し、かつ面内の温度均一性が著しく悪化する。
- エッチング速度や選択比などのエッチング特性は温度に大きく依存するため、面内の温度不均一はCDのばらつきに直結する。
- 先端プロセスではnmオーダーのCD制御が求められており、Heなしでこの精度を維持することは事実上不可能である。これは性能の「低下」ではなく、プロセスの「成立不能」を意味する。
このように、ドライエッチング装置において、もはやHeは必要不可欠なガスであり、Heなしではドライエッチング工程が成立しないと言っても過言ではない。
Copyright © ITmedia, Inc. All Rights Reserved.
