複数のミニダイ(チップレット)を1つのパッケージに収容する:福田昭のデバイス通信(506) TSMCが解説する最新のパッケージング技術(3)(2/2 ページ)
2025年12月に開催された国際学会IEDMにおける、TSMCの講演を解説するシリーズ。今回は、前回に続き、「先進パッケージ技術の進化」を取り上げる。分割した複数のミニダイを同一パッケージに収容する際の、3つの接続手法を解説する。
中間基板を介したミニダイの近接接続と、ミニダイを積層する直接接続
巨大なシングルダイを複数のミニダイ(チップレット)に分割して製造コストの急増を抑えるという考え方は前回で述べた。分割した複数のミニダイは、同じパッケージに収容する。ここで3つの接続手法が候補となる。
1つは従来と同様に樹脂基板(パッケージ基板)にミニダイを横に並べて搭載し、樹脂基板を通じてミニダイ間を接続する手法である。「2次元(2D)パッケージング」とも呼ぶ。技術的には従来のパッケージング技術とほぼ変わらない。パッケージのコストは最も低くなる。一方でミニダイ間の距離を縮めにくい、ミニダイ間の接続数を多くしにくいといった弱点がある。ミニダイ間の信号伝送速度(あるいは信号伝送周波数)/ピンが高い場合、信号伝送数が多い場合などには向かない。
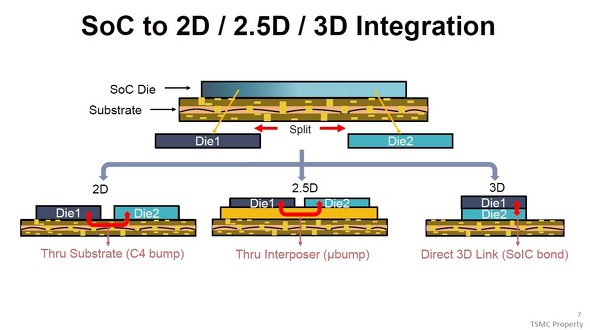
巨大なシングルダイ(SoCダイ)(上)を複数のミニダイ(チップレット)に分割してから同じパッケージに封止する。ここでは2つのミニダイ(Die1とDie2)に分ける場合を考える。従来と同様に樹脂基板(パッケージ基板)にミニダイを横にならべて載せる(左下、2Dパッケージング)、中間基板(インターポーザー)にミニダイを横に並べて載せる(中央下、2.5Dパッケージング)、ミニダイを積層接続する(右下、3Dパッケージング)、の3通りの候補がある[クリックで拡大] 出所:TSMC(IEDM 2025のショートコース(番号SC1-5)で公表された講演スライドから)
もう1つは中間基板(インターポーザー)にミニダイを横に並べて搭載し、中間基板を通じてミニダイ間とミニダイ・パッケージ基板間を接続する手法である。「2.5次元(2.5D)パッケージング」とも呼ぶ。中間基板の配線ピッチはパッケージ基板よりもはるかに短い。ミニダイを近接して配置できるとともに、ミニダイ間の信号数を多くできる。このため、高速・高周波数で信号をやりとりする高性能チップに向く。
3つ目はミニダイを積層接続する手法である。「3次元(3D)パッケージング」とも呼ぶ。ミニダイ間は微細なバンプ(マイクロバンプ)を介して接続したり、直接接合したりする。ミニダイ間の距離は最も短くなる。
⇒「福田昭のデバイス通信」連載バックナンバー一覧
Copyright © ITmedia, Inc. All Rights Reserved.
関連記事
 AIサーバの高性能化に不可欠となった先進パッケージング技術
AIサーバの高性能化に不可欠となった先進パッケージング技術
2025年12月の国際学会IEDMで、TSMCが最新のパッケージング技術について講演した。本シリーズは、その内容の一部を紹介する。 メモリとストレージの動向を示す11個のキーワード(前編)
メモリとストレージの動向を示す11個のキーワード(前編)
2025年8月に開催された「FMS」の講演を紹介するシリーズ。今回はメモリとストレージの市場アナリストとして知られるJim Handy氏の講演を前後編でご紹介する。 2026年のHBM市況、カギを握るのは最新世代「HBM4」
2026年のHBM市況、カギを握るのは最新世代「HBM4」
2025年8月に開催された「FMS(the Future of Memory and Storage)」の一般講演を紹介するシリーズ。今回はTrendForceのアナリストであるEllie Wang氏の講演を取り上げる。広帯域メモリ(HBM)の生産能力や容量、価格を予測する。 創刊前の20年間(1985年〜2005年)で最も驚いたこと:1985年の「不可能」二題
創刊前の20年間(1985年〜2005年)で最も驚いたこと:1985年の「不可能」二題
EE Times Japan 創刊20周年に合わせて、半導体業界を長年見てきたジャーナリストの皆さまや、EE Times Japanで記事を執筆していただいている方からの特別寄稿を掲載しています。今回は、40年以上にわたり半導体技術/電子技術を見守り、フリーの技術ジャーナリストとして活躍されている福田昭氏にご寄稿いただきます。EE Times Japan創刊からさらに20年さかのぼり、1985年の話からスタートします。 キオクシアの年度業績、3年ぶりの黒字転換で過去2番目の営業利益を計上
キオクシアの年度業績、3年ぶりの黒字転換で過去2番目の営業利益を計上
キオクシアホールディングスの2024会計年度通期(2024年4月〜2025年3月)の決算概要を説明する。 自動車通信システムの国際標準に合わせた周波数割り当ての再編成
自動車通信システムの国際標準に合わせた周波数割り当ての再編成
今回は、高度道路交通システム(ITS:Intelligent Transport Systems)の無線通信用周波数帯域の再編成について解説する。