小型化と薄型化、多機能化を後押しする部品内蔵基板:福田昭のデバイス通信(261) 2019年度版実装技術ロードマップ(69)(2/2 ページ)
» 2020年08月04日 10時30分 公開
[福田昭,EE Times Japan]
低コストで微細な配線を実現できる技術が求められる
プリント配線板の製造工程では、外形寸法が50cm×60cmといった巨大なワークパネルで複数のプリント配線板を一括して処理する。有機樹脂のプリント配線ワークパネルを使った一括処理は、製造コストが低いという大きな利点を備える。しかし配線ピッチは狭くても100μm〜10μmであり、高密度化には限界がある。
一方、シリコン(Si)やガラスなどのウエハーを基板とする部品内蔵基板(「ウエハーレベル部品内蔵基板」)は配線ピッチで10μm以下を容易に実現できる。ただし製造コストが非常に高くつく。このため、パネルレベルに近い製造コストで、ウエハーレベルに相当する微細な配線を形成可能な配線板技術(基板技術)が求められている。
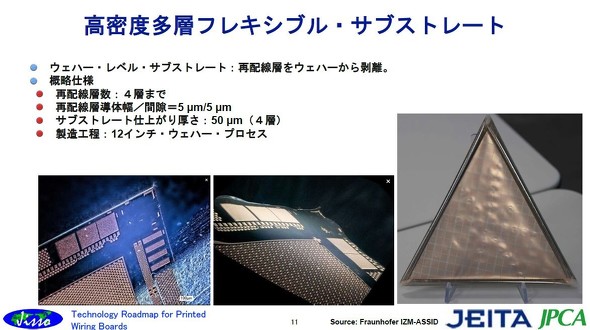 ウエハーレベルの多層プレキシブル・サブストレート(半導体パッケージ基板)。再配線層をシリコンウエハーから剥離することで、フレキシブルな基板を実現している。配線ピッチは10μmと狭い。出典:JEITAおよびJPCA(クリックで拡大)
ウエハーレベルの多層プレキシブル・サブストレート(半導体パッケージ基板)。再配線層をシリコンウエハーから剥離することで、フレキシブルな基板を実現している。配線ピッチは10μmと狭い。出典:JEITAおよびJPCA(クリックで拡大)(次回に続く)
⇒「福田昭のデバイス通信」連載バックナンバー一覧
関連記事
 プリント配線板の性能を大きく左右する絶縁材料
プリント配線板の性能を大きく左右する絶縁材料
プリント配線板では多種多様な絶縁基材が使われる。新世代のプリント配線板が採用した新しい絶縁基材について解説する。 新世代のプリント配線板と製造技術
新世代のプリント配線板と製造技術
今回から、従来型のプリント配線板と、付加価値を高めた新しいプリント配線板について解説する。 プリント配線板市場の成長を牽引する「機能集積基板」
プリント配線板市場の成長を牽引する「機能集積基板」
この10年減少傾向が続いている国内のプリント配線板では、知識集約型の新しいアーキテクチャによる、付加価値の高いプリント配線板が望まれている。 スマートフォンと車載情報機器の進化を支えるタッチパネル(前編)
スマートフォンと車載情報機器の進化を支えるタッチパネル(前編)
今回は、「入出力デバイス」からタッチパネルを取り上げる。タッチセンサーについて、主要な5つの方式を紹介する。 新材料で次々世代を狙う「強誘電体メモリ(FeRAM)」
新材料で次々世代を狙う「強誘電体メモリ(FeRAM)」
今回は「強誘電体メモリ(FeRAM)」を取り上げる。FeRAMの記憶原理と、60年以上に及ぶ開発の歴史を紹介しよう。
Copyright © ITmedia, Inc. All Rights Reserved.
Special ContentsPR
特別協賛PR
スポンサーからのお知らせPR
Special ContentsPR
Pickup ContentsPR
記事ランキング
- 「世界初」成果で1000層超3Dフラッシュに道筋、キオクシアとSandisk
- ナフサ危機で迫る「レジスト供給途絶」――世界の半導体工場を停止させる、もう一つの臨界点
- 次世代パワー半導体 「期待の5材料」の現在地
- パワー半導体世界市場、2035年は7兆円超え 酸化ガリウムも一定規模に
- 入学した瞬間終わったわ――「講義が英語」なんて一言も聞いてない!
- TSMCが次世代ロードマップ公表 A13/A12を29年投入へ
- SK hynixの四半期決算、驚異の売上高営業利益率70%超え
- 「データの死蔵に耐えられないエンジニア」がたどり着いたMASの沼
- TED、25年度は減収減益 「各事業磨き上げる」と新社長
- 村田製作所、25年度は売上高が過去最高 データセンター向けは70%増
Special SitePR
あなたにおすすめの記事PR