EUVリソ向けフォトマスク製造プロセスを開発:マルチビームマ電子スク描画装置利用
大日本印刷(DNP)は、マルチ電子ビームマスク描画装置を利用し、5nm対応EUV(極端紫外線)リソグラフィ向けのフォトマスク製造プロセスを開発した。
複雑なパターン形状でも、高い生産性と精度を実現
大日本印刷(DNP)は2020年7月、マルチ電子ビームマスク描画装置を利用し、5nm対応EUV(極端紫外線)リソグラフィ向けのフォトマスク製造プロセスを開発したと発表した。
EUVリソグラフィは、光源として波長13.5nmのEUVを用い、シリコンウエハー上に線幅数nmの回路パターンを形成することが可能となる。既に一部の半導体メーカーが最先端のマイクロプロセッサやメモリの製造工程で実用化している。
DNPは既に、半導体用フォトマスク製造にマルチ電子ビームマスク描画装置を活用している。今回、EUVリソグラフィ向けフォトマスクの製造工程に、マルチ電子ビームマスク描画装置を利用しても、高い生産性や精度が得られるよう、感光材料を含め新たなプロセス技術を開発し適用した。EUVマスクの微細構造に合わせ加工条件も最適化している。これらの技術によって、5nmプロセスに相当する高精度EUVリソグラフィ向けフォトマスクの製造を可能にした。
マルチ電子ビームマスク描画装置は、26万本の電子ビームを照射できるため、高解像レジストを利用できる。これにより、曲線を含む複雑な形状の回路パターンであっても、描画時間を大幅に短縮でき、描画精度も高いという。
DNPは今後、開発したプロセス技術を用いてEUVリソグラフィ向けフォトマスクを製造し、国内外の半導体メーカーや製造装置メーカーなどに供給する。2023年には年間60億円の事業規模を目指す。また、半導体の国際研究機関である「IMEC」との共同開発などを通じて、3nm以降の微細プロセスに対応する技術についても、引き続き開発に取り組む予定である。
関連記事
 5G向けに「透明アンテナフィルム」を開発、DNP
5G向けに「透明アンテナフィルム」を開発、DNP
大日本印刷(DNP)は、5G(第5世代移動通信)に対応した透明アンテナフィルムを開発したと発表した。2022年度に量産を開始し、2025年度に年間100億円の売り上げを目指すとしている。 ローカル5G向けSIMカードを20年3月から提供、DNP
ローカル5G向けSIMカードを20年3月から提供、DNP
大日本印刷(DNP)は2020年2月20日、ローカル5G(第5世代移動通信)向けのSIMカードを同年3月から提供開始する、と発表した。SIMカードのほか導入に関連するサービスなども提供していく予定で、2023年度までに5億円の売り上げを目指している。 ディスプレイ表面のぎらつき現象を正しく評価
ディスプレイ表面のぎらつき現象を正しく評価
大日本印刷(DNP)は、防眩フィルムを貼ったディスプレイ表面のぎらつき現象を、より正確に評価することができる「光学測定原理」を解明した。 DNP、ベゼルレスディスプレイ向けガラスカバー
DNP、ベゼルレスディスプレイ向けガラスカバー
大日本印刷(DNP)は、ベゼル(額縁)レスのディスプレイに向けた「高機能ガラスカバー」を開発した。 TSMCがEUV適用7nmプロセスを商用化
TSMCがEUV適用7nmプロセスを商用化
世界最大のファウンドリーであるTSMCは2019年10月7日(台湾時間)、「業界で初めてEUV技術を商用化」(同社)し、EUVを採用した7nmプロセス「N7+」を発表した。同社は報道向け発表資料の中で、「当社は現在、複数の顧客企業からのN7+プロセスへの需要に対応すべく、生産能力を迅速に拡大しているところだ」と述べている。 半導体製造プロセスは継続的な進化を
半導体製造プロセスは継続的な進化を
EUV(極端紫外線)リソグラフィの開発プロセスは、長期にわたって難しい道のりを進んできた。EUV開発については、EUVの新しいパターニング性能を採用するかしないかによって、半導体チップ製造プロセスが将来的にどのような技術になるのかを、一歩引いた所から検討する必要があるのではないだろうか。
Copyright © ITmedia, Inc. All Rights Reserved.
記事ランキング
- 「世界初」成果で1000層超3Dフラッシュに道筋、キオクシアとSandisk
- ナフサ危機で迫る「レジスト供給途絶」――世界の半導体工場を停止させる、もう一つの臨界点
- 次世代パワー半導体 「期待の5材料」の現在地
- 入学した瞬間終わったわ――「講義が英語」なんて一言も聞いてない!
- パワー半導体世界市場、2035年は7兆円超え 酸化ガリウムも一定規模に
- SK hynixの四半期決算、驚異の売上高営業利益率70%超え
- 「データの死蔵に耐えられないエンジニア」がたどり着いたMASの沼
- TSMCが次世代ロードマップ公表 A13/A12を29年投入へ
- 村田製作所、25年度は売上高が過去最高 データセンター向けは70%増
- パワー停滞も光デバイス堅調、三菱電機の半導体部門


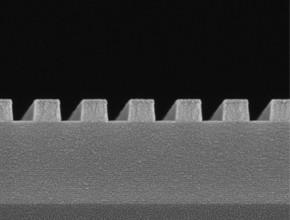 EUVリソグラフィ向け5nmプロセスに相当する高精度なフォトマスクと回路パターンの拡大写真 出典:DNP
EUVリソグラフィ向け5nmプロセスに相当する高精度なフォトマスクと回路パターンの拡大写真 出典:DNP