パナソニック、低温硬化性の実装補強材を開発:二次実装アンダーフィル材
パナソニックは、接合強度が要求される車載向け部品実装などの用途に向けて、低温硬化性の「二次実装アンダーフィル材」を開発、量産を始めた。
車載部品の実装信頼性を向上
パナソニックは2017年2月、低温で硬化する「二次実装アンダーフィル材」を開発し、量産を始めると発表した。接合強度が要求される車載向け部品実装などの用途に向ける。
新製品は、基板に部品を実装した後に、その周囲に塗布し硬化させることで接合強度を高める補強材である。従来品は80℃硬化でガラス転移温度(Tg)は100℃であった。これに対して今回は、独自の樹脂設計技術により、80℃で硬化しTgが140℃以上という材料特性を実現した。
このため、車載用途の電子部品実装に求められるような厳しい利用環境でも、高い信頼性を実現することができる。この材料は、150℃10分間でもTgは140℃を上回っており、短い硬化時間を要求する用途にも対応することができるという。
新製品は、低温時においても高いTgを実現できる反応性制御技術を採用している。これにより、他部材との熱収縮差が小さく、従来技術に比べてはんだボールにかかるストレスを58%も低減できるという。
ミリ波レーダーの部材などで用いられる金バンプなどの実装補強にも適している。金バンプはバンプ間の距離が短く、接合面積も小さい。このため、従来は温度サイクル試験で接合面の剥がれやクラックが発生し、それが原因で不具合が生じることもあった。新製品は高い流動性を確保し、金バンプなどとの密着性に優れているため、間隔の狭い実装であっても高い信頼性を実現できるという。
新製品は、車載カメラモジュールやミリ波レーダーなどの車載通信モジュール、車載ECUなどにおける電子部品の実装補強の用途に向ける。
関連記事
 パナソニックとUMC、40nm ReRAMの共同開発で合意
パナソニックとUMC、40nm ReRAMの共同開発で合意
パナソニック セミコンダクターソリューションズは、半導体ファウンドリである台湾UMCと、40nm量産プロセスの抵抗変化メモリ(ReRAM)共同開発に合意したと発表した。 パナソニック、画質を高めた透明スクリーン発売
パナソニック、画質を高めた透明スクリーン発売
パナソニックは、ショーウインドウの窓ガラスをデジタルサイネージとしても活用できる「透明スクリーン」を開発した。コントラストの高い映像表示が可能となる。複数のスクリーンを組み合わせると、4.9×2.75mの画面サイズを実現することもできる。 パナソニックの“魔法の鏡”が創り出す新たな美
パナソニックの“魔法の鏡”が創り出す新たな美
パナソニックは、非接触の肌センシング技術を用いた魔法の鏡「スノービューティミラー」と、貼るファンデーションを実現する「メイクアップシート」について技術セミナーを開催した。 消費電力0.01mWの水素センサー、ReRAMがヒントに
消費電力0.01mWの水素センサー、ReRAMがヒントに
パナソニックは「CEATEC JAPAN 2016」(2016年10月4〜7日、千葉・幕張メッセ)で、現在開発中の水素検知センサーを展示した。水素検知センサーは、パナソニックが開発した新しい検出原理を採用したもので、既存品と感度は同等だが、消費電力が1万分の1以下となっている。 4層のモジュール基板、総板厚0.2mm以下で実現
4層のモジュール基板、総板厚0.2mm以下で実現
パナソニックは、「JPCA Show 2016」で、モジュール基板のさらなる薄型化を可能とするフレキシブル基板材料(樹脂付き銅箔)「FELIOS FRCC」を展示した。 新ナノ合金を使った圧縮機が次世代省エネ実現へ
新ナノ合金を使った圧縮機が次世代省エネ実現へ
パナソニックの生産技術本部は、東北大学が研究開発を進める新ナノ結晶合金「NANOMET」を用いたモーターを搭載した圧縮機の試作に成功したと発表した。電磁鋼板を使用したモーターと比較して3.1%の効率向上を実証。これにより、圧縮機の高い省エネ性能を実現できるという。
Copyright © ITmedia, Inc. All Rights Reserved.
記事ランキング
- 「世界初」成果で1000層超3Dフラッシュに道筋、キオクシアとSandisk
- ナフサ危機で迫る「レジスト供給途絶」――世界の半導体工場を停止させる、もう一つの臨界点
- 次世代パワー半導体 「期待の5材料」の現在地
- パワー半導体世界市場、2035年は7兆円超え 酸化ガリウムも一定規模に
- 入学した瞬間終わったわ――「講義が英語」なんて一言も聞いてない!
- TSMCが次世代ロードマップ公表 A13/A12を29年投入へ
- SK hynixの四半期決算、驚異の売上高営業利益率70%超え
- 「データの死蔵に耐えられないエンジニア」がたどり着いたMASの沼
- TED、25年度は減収減益 「各事業磨き上げる」と新社長
- 村田製作所、25年度は売上高が過去最高 データセンター向けは70%増

 二次実装アンダーフィル材 出典パナソニック
二次実装アンダーフィル材 出典パナソニック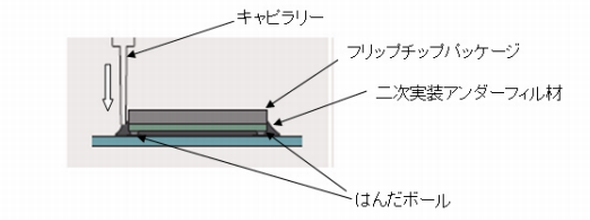 基板実装時の断面図 出典:パナソニック
基板実装時の断面図 出典:パナソニック