ミニダイ(チップレット)間接続におけるSTCO:福田昭のデバイス通信(509) TSMCが解説する最新のパッケージング技術(6)(1/2 ページ)
「IEDM 2025」におけるTSMCの講演内容を紹介する。前回に続き、アウトラインの第3項「System-Technology Co-Optimization (STCO)(システム・製造協調最適化)」の内容を解説する。
AI/HPC向けパッケージングで考慮すべき5つの項目
2025年12月に開催された国際学会IEDMのショートコース(技術解説)で、シリコンファウンドリー最大手のTSMCが最新のパッケージング技術を説明した。講演のタイトルは「Advanced Packaging and Chiplet Technologies for AI and HPC Applications(AIおよびHPCに向けた先端パッケージング技術と先端チップレット技術)」、講演者はAdvanced Package Integration Division R&DのディレクターをつとめるJames Chen氏である。大変に参考となる内容だったので、その一部をシリーズでご紹介している。ただし講演内容だけでは説明が不十分なところがあるので、本シリーズでは読者の理解を助けるために、講演内容を筆者が適宜、補足してある。あらかじめご了承されたい。
![講演「Advanced Packaging and Chiplet Technologies for AI and HPC Applications(AIおよびHPCに向けた先端パッケージング技術と先端チップレット技術)」のアウトライン[クリックで拡大] 出所:TSMC(IEDM 2025のショートコース(番号SC1-5)で公表された講演スライドから)](https://image.itmedia.co.jp/ee/articles/2603/05/mm260305_device01.jpg) 講演「Advanced Packaging and Chiplet Technologies for AI and HPC Applications(AIおよびHPCに向けた先端パッケージング技術と先端チップレット技術)」のアウトライン[クリックで拡大] 出所:TSMC(IEDM 2025のショートコース(番号SC1-5)で公表された講演スライドから)
講演「Advanced Packaging and Chiplet Technologies for AI and HPC Applications(AIおよびHPCに向けた先端パッケージング技術と先端チップレット技術)」のアウトライン[クリックで拡大] 出所:TSMC(IEDM 2025のショートコース(番号SC1-5)で公表された講演スライドから)タイトルスライドの次に示されたアウトラインは、「AI and HPC Market Outlook(AIとHPCの市場を展望)」「Advanced Package Technology Evolutions(先進パッケージ技術の進化)」「System-Technology Co-Optimization (STCO)(システムと製造の協調最適化)」「Emerging Advanced package technology(次世代の先進パッケージ技術)」「Summary(まとめ)」となっていた。
本シリーズの前回から、アウトラインの第3項「System-Technology Co-Optimization (STCO)(システム・製造協調最適化)」に相当する部分の説明を始めた。今回はその続きとなる。
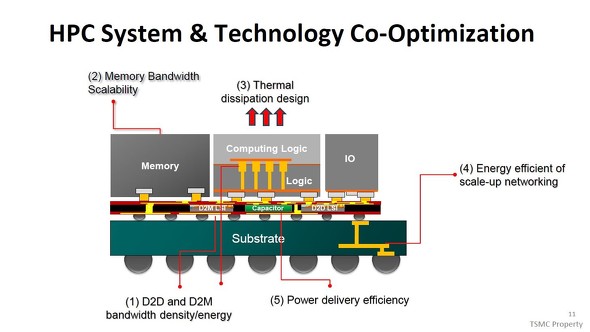 STCO(システムと製造の協調最適化)で考慮すべき事柄。先進パッケージ「CoWoS-L(LSI+RDL interposer)」の例[クリックで拡大] 出所:TSMC(IEDM 2025のショートコース(番号SC1-5)で公表された講演スライドから)
STCO(システムと製造の協調最適化)で考慮すべき事柄。先進パッケージ「CoWoS-L(LSI+RDL interposer)」の例[クリックで拡大] 出所:TSMC(IEDM 2025のショートコース(番号SC1-5)で公表された講演スライドから)前回でも述べたように、高性能コンピューティング(HPC)向けの先進パッケージングでは、STCOの導入が必須となっている。講演では、先進パッケージ「CoWoS-L(LSI+RDL interposer)」を例に、STCOで考慮すべき5つの項目を挙げていた。
5つの項目とは、
(1)D2D and D2M bandwidth density/energy(ロジックのミニダイ間接続(D2D)とロジックとメモリの接続(D2M)における、消費エネルギー当たりの接続帯域幅密度)
(2)Memory bandwidth scalability(メモリ入出力帯域幅の拡張性)
(3)Thermal dissipation design(消費電力および放熱の設計)
(4)Energy efficient of scale-up networking(ネットワークの大規模化おける消費エネルギー(転送データ当たり)の効率)
(5)Power delivery efficiency(電源供給の効率)
である。講演では、これら5つの項目について順番に説明していた。
Copyright © ITmedia, Inc. All Rights Reserved.
記事ランキング
- メモリも中国が猛追 YMTCは新工場建設
- 560億ドル投資でも「需要に追い付けない」 AI急成長でTSMC表明
- ローム・東芝・三菱電機のパワー半導体はどうなるか
- 「AI特需」の恩恵届かぬ日本企業 Gartnerが見る2026年半導体市場
- SAIMEMORYの垂直ビルド構造メモリ開発がNEDO採択
- He/ナフサ供給危機で工場新設も遅延? 装置/チップメーカーへの波及経路を探る
- 「装置は動くがプロセスが成立しない」――He供給危機とナフサ不足の本質
- 「Rapidusの隣」に光電融合パッケージ開発拠点、28年度の完成目指す
- データセンター用CPUでも勢力伸ばすRISC-V
- 半導体用の「沸騰冷却技術」 アプライドと九州大が実用化目指す

![STCO(システムと製造の協調最適化)で考慮すべき5つの項目。TSMCの講演スライドに記述された項目を、筆者が和訳したもの[クリックで拡大]](https://image.itmedia.co.jp/ee/articles/2603/05/mm260305_device03.jpg)