「装置は動くがプロセスが成立しない」――He供給危機とナフサ不足の本質:湯之上隆のナノフォーカス(90-1) He/ナフサ供給危機と半導体(1)(1/4 ページ)
半導体業界にとって、中東情勢に伴うヘリウム(He)供給逼迫(ひっぱく)およびナフサの不足は、思っている以上に深刻な影響をもたらす。本稿では、これら2つの材料の供給が途絶/不足するという危機の本質を、主要装置に与える影響を考察しながら、詳細に解説する。
ヘリウム/ナフサ供給危機と半導体
第3章:ナフサ不足とPFAS危機――装置を「組み立てる」ための素材が消える
第5章:危機のタイムライン――1カ月・3カ月・6カ月で何が起きるか
第6章:政策論議の本質的ずれ――「ナフサ4カ月在庫」議論が外している核心
プロローグ
半導体製造における真の脆弱性は、最も高価な300億円もする最先端の極端紫外線(EUV)装置ではなく、その装置を動かすために不可欠な、ごく一部の材料とガスに集中している。ヘリウム(He)供給途絶とナフサ供給逼迫は、起点を異にしながら、同じ結論に到達する。すなわち、「工場停止」ではなく「プロセス不成立」という、従来のBCP(事業継続計画、Business Continuity Plan)が想定していない新たな停止形態である。
装置は動作する。しかしプロセスが成立しない――これが、本稿で論じる危機の本質である。
より具体的に述べれば、こうである。装置は動作する。電力も供給されている。人員も配置されている。しかし、ウエハー上でレシピ通りのプロセスを再現できない。歩留まりは閾値を下回り、先端ノードでは製品として成立しない。工場は「止まっていない」にもかかわらず、事業としては「止まっている」のと同義である。
本稿では、図1に示した全貌をもとに、以下の順に論じる。なお第1〜第3章は本稿、第4〜第6章は別記事となる。
第1章では、He供給途絶が装置ごとにどのような状況で現れるかを、一次資料に基づいて詳細に分析する。ドライエッチング、化学気相成長(CVD)/原子層堆積(ALD)/物理気相成長(PVD)、先端エピタキシャル成長の各工程で、Heがどの段階で、なぜ代替不能なのかを明らかにする。
第2章では、なぜHeが代替困難なのか、その供給構造の制約を明らかにする。
第3章では、ナフサ不足がもたらす高機能ポリマー、PFASおよび、フォトレジスト供給問題の複合危機を論じる。ナフサ由来の芳香族・オレフィンと、PFAS由来のPAG(光酸発生剤)アニオンが交差する、フォトレジストという特異点を中心に据える。
第4章では、これらが装置メーカー(Lam Research、東京エレクトロン、ASML、KLA、アプライド マテリアルズ)とチップメーカーに与える波及経路を、FFKM、PFA、PFPEといった部材レベルで整理する。
第5章では、危機のタイムラインを月単位で示す。1〜3カ月、3〜6カ月、6カ月以上の各段階で、どの工程がどの順序で機能不全に陥るかを具体的に提示する。
第6章では、現在の政策論議――とりわけ「ナフサ4カ月在庫」に代表される「総量論」――がなぜ問題の本質を捉え損なっているかを批判的に検証し、「品番レベル」での戦略物資管理という新たな枠組みを提案する。
半導体産業が直面している事態は、筆者の当初の想像をはるかに超えて深刻である。世界の半導体工場が停止すれば、AIの進展が止まるだけでは済まない。自動車、家電、通信、医療機器、防衛装備に至るまで、あらゆる工業製品の製造が停止する。He産出国の政情不安とナフサ供給網の混乱が重なれば、これは誇張ではなく、現代文明の基盤そのものが揺らぐ事態となる。
本稿の目的は、この危機を「装置の問題」や「総量の問題」としてではなく、「分子レベルの再現性」と「品番レベルの依存性」という正しい解像度で可視化することにある。問題を正しく設定できなければ、対策もまた的を外す。残された時間は、決して多くない。
第1章:He供給途絶の本質――装置ごとの「止まり方」の違い
1.1 問うべきは「使っているか」ではなく「無いと何が崩れるか」
He供給途絶の影響を評価するうえで、最初に押さえておくべき視点がある。それは「どの装置がHeを使っているか」ではなく、「Heが無いと熱設計・反応設計がどこまで崩れるか」である。この視点に立つと、半導体前工程装置におけるHeの役割は、大きく二つに分かれることが分かる。
第一に、キャリアガス/パージガスとしての役割である。これはプロセスガスの搬送、チャンバー内のパージ、希釈などに使われる用途であり、ALD、CVD、エピの特許群を参照すると、He単独ではなくAr、N2、H2、Neなどと並列に記載されている場合が多い(US9576811B2、WO2020214732A1、US6562128B1等)。従って、この用途については条件変更を伴うが代替余地がある。
第二に、ウエハーステージの裏面から供給されたHeによる熱伝達・温度均一化の役割である。ウエハー裏面と静電チャック(ESC)またはペデスタル(CVD装置など成膜用のウエハーステージ)の間にHeを導入し、Heがウエハー裏面とウエハーステージの間の熱伝導を効率よく制御し、ウエハー面内の温度分布を精密に管理する。この用途は複数の装置系特許に共通して現れる思想であり、最も代表的な例がドライエッチング装置であるが(『ヘリウム調達停止――AIブームを崩壊させる「見えない臨界点」(前編)』の図2(下図)を参照)、それ以外でも、CVD、PVD、ALD系の成膜装置一般に広く見られる(US5624582A、US6159299A、US7674636B2等)。
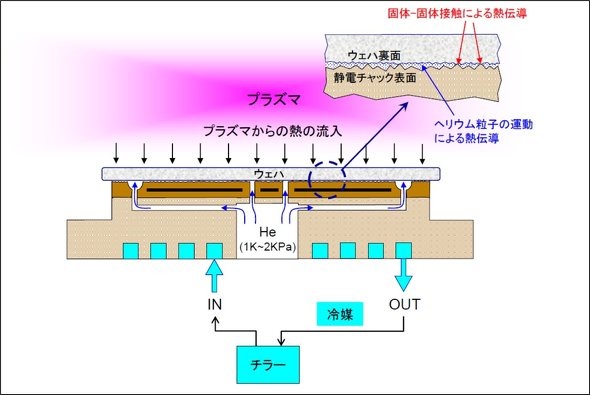 (既出)ドライエッチング装置における温度制御の原理[クリックで拡大] 出所:野尻一男(Nanotech Research) 『はじめての半導体ドライエッチング技術』(技術評論社)、90ページの図4-16
(既出)ドライエッチング装置における温度制御の原理[クリックで拡大] 出所:野尻一男(Nanotech Research) 『はじめての半導体ドライエッチング技術』(技術評論社)、90ページの図4-16Heの代替困難性は、後者において極めて高い。熱伝導率はHeが約0.152 W/m・Kに対し、Arが約0.0177 W/m・K、N2が約0.026 W/m・Kであり、HeはArの約8〜9倍、N2の約6倍に達する(NIST Chemistry WebBook)。かつ化学的に不活性、低分子量で微小ギャップに入り込むという性質を同時に備える気体は、実質的にHe以外に存在しない。
結論を先に述べれば、ドライエッチングが最もHe依存度が高く、CVD・ALD・PVD・エピなどの成膜はそれより依存性がやや低いかもしれない。ただし、その成膜装置の中でも、枚葉・高均一性・低温窓・高精度温度制御を要する装置ほどリスクは上がる。以下、順に見ていく。
1.2 ドライエッチング:Heは「冷却の本体」に近い
ドライエッチングにおけるHe依存は、他のどの装置よりも強い。このことを、前掲の拙著記事を基に復習する。
プラズマを使うドライエッチングでは、プラズマからの輻射熱・イオン・ラジカル・紫外線の入熱を受けながら、ウエハーを所望の温度に冷却し、かつウエハー面内の温度均一性を精密に制御しなければならない。US5624582A等の一次資料では、ウエハー裏面のHe冷却がエッチ速度、均一性、テーパー形状、寸法均一性を直接左右するとされている(Donnelly & Kornblit, "Plasma etching: Yesterday, today, and tomorrow," J. Vac. Sci. Technol. A 31, 050825, 2013も参照)。
つまり、エッチングにおいてHeは単なる補助ガスではなく、プロセス成立条件そのものの一部として組み込まれている。温度制御が崩れれば、加工形状が崩れ、CD(Critical Dimension)均一性が劣化し、選択比が変動する。
特に3nm/2nmの先端ロジックや3D NAND型フラッシュメモリとDRAMの高アスペクト比(High Aspect Ratio、HAR)エッチングおよび、ソニーのCMOSイメージセンサーと広帯域メモリ(HBM)用のTSV(Through Silicon Via)は、マージンが±0.2℃〜数℃レベルで管理されており、Heの代替はほぼ不可能である。
従ってHe供給が途絶した場合、上記に列挙したドライエッチング工程は「即死」する。これは歩留まり劣化ではなく、プロセスそのものが成立しない状態である。
Copyright © ITmedia, Inc. All Rights Reserved.
記事ランキング