WLCSP採用デバイスの薄化に対応する新ツール:FOWLP向け研削ツールなど
ディスコは2017年11月27日、半導体デバイスの薄化に対応する精密加工ツール2種を開発し、2018年から順次発売すると発表した。
ディスコ、2018年から順次発売へ
ディスコは2017年11月27日、半導体デバイスの薄化に対応する精密加工ツール2種を開発し、2018年から順次発売すると発表した。
開発したツールは、半導体パッケージ研削向けグラインディングホイール「GFCPシリーズ」と、ハイバンプ付シリコンウエハーの裏面研磨向けドライポリッシングホイール「DPEG-BP type」の2種。いずれもスマートフォンなど高密度に部品を実装する電子機器向け半導体デバイスで採用が拡大しているWLCSP(Wafer Level Chip Size Package)の生産に適したツールになる。
半導体パッケージ研削向けグラインディングホイールのGFCPシリーズは、WLCSPの一種であるFOWLP(Fan-Out Wafer Level Package)向けのツール。FOWLPにおけるパッケージ研削は、シリコン、銅、モールド樹脂、ポリイミドなど研削性の異なる素材を研削しなければならない。こうした素材を同時に、かつ、安定的に研削し、銅や樹脂などの延性材料のバリ発生を抑えることが難しかった。
GFCPシリーズは、延性材料の研削性にすぐれた有気孔のビトリファイドボンド砥石を採用。加えて、砥石の硬度を厳密にコントロールすることで、FOWLPを含むさまざまな構造、材料のパッケージの研削に対応できるようになったとする。
もう1つの新ツールであるDPEG-BP typeは、ウエハー上に100μm以上のハイバンプが形成されているWLCSPの薄化加工用途に向けたツール。
ハイバンプが形成されたウエハーの研磨を行う場合、厚い表面保護テープを貼ることでバンプの凹凸を吸収し、ウエハーの変形を抑えながら研削、研磨するのが一般的だ。ウエハー研削後は強度を上げるため、研削面にできた歪みを研磨して除去する必要がありますが、完全に歪みを除去するとゲッタリング効果が失われ、重金属汚染によるウエハーの特性不良が生じる可能性がある。
ディスコでは既に、ゲッタリング効果を維持しながら研磨が可能なドライポリッシングホイール「DPEGシリーズ」を展開しているが、厚い表面保護テープが貼られているウエハーでは、加工時に発生する熱が逃げにくくなり、研磨不良を誘発させるケースが出てきていた。
これに対し、DPEG-BP typeは、厚い表面保護テープが貼られたバンプ付きウエハーを研磨する際も、発熱を抑えることができ、安定した加工が可能になるという。ディスコでは「従来のDPEGシリーズ同様の高い抗折強度とゲッタリング効果の両立を実現している」としている。
新ツール2種については、2017年12月13〜15日に東京ビッグサイトで開催される展示会「SEMICON Japan 2017」のディスコブースで展示される予定だ。
関連記事
 “ディスコだから”開発できた純水リサイクル装置
“ディスコだから”開発できた純水リサイクル装置
半導体製造装置メーカーのディスコは2016年8月、ダイシングソー用の純水リサイクル装置「DWRシリーズ」の新製品を、電子部品メーカーに初納入したと発表した。純水を製造する装置を提供するメーカーはあるが、リサイクル機能まで集約した装置を提供するのはディスコのみとなっている。実現できた要因として、高性能フィルター「CC Filter」を独自に開発したことを挙げる。 SiCの生産効率を4倍にする装置、ディスコが展示
SiCの生産効率を4倍にする装置、ディスコが展示
ディスコは、「SEMICON Japan 2016」(2016年12月14〜16日/東京ビッグサイト)で、レーザー加工によるインゴットスライス手法を実現する製造装置を初めて展示した。 ディスコ、長野事業所・茅野工場を新たに開設
ディスコ、長野事業所・茅野工場を新たに開設
ディスコは、長野県茅野市に長野事業所・茅野工場を新設することを決めた。ダイシングソーの生産能力を増強する。これに伴い、新たに約550人を採用していく予定である。 FOWLP向け大型パッケージ基板対応のダイシングソー
FOWLP向け大型パッケージ基板対応のダイシングソー
ディスコは、「SEMICON Japan 2016」(2016年12月14〜16日/東京ビッグサイト)で、TSMCの「InFO」で注目を集めるFOWLP(Fan-Out Wafer Level Package)の生産ニーズに応えるべく、大判パッケージ基板に対応したダイシングソー「DFD6310」などを展示する。 V-LEDのサファイア基板剥離に固体レーザーを採用
V-LEDのサファイア基板剥離に固体レーザーを採用
ディスコは「SEMICON Japan 2015」において、垂直構造型LED(V-LED)チップの製造に適したフルオートマティックレーザーソー「DFL7560L」を展示した。レーザーリフトオフ(LLO)に固体レーザー技術を採用することで、高い加工品質やメンテナンス性を実現する。 120mの距離運ぶ「ミニマルファブ」搬送機が登場
120mの距離運ぶ「ミニマルファブ」搬送機が登場
産総研コンソーシアム・ファブシステム研究会などは、「SEMICON Japan 2016」(2016年12月14〜16日/東京ビッグサイト)で、ミニマルファブの開発成果を紹介した。
Copyright © ITmedia, Inc. All Rights Reserved.
記事ランキング
- ナフサ危機で迫る「レジスト供給途絶」――世界の半導体工場を停止させる、もう一つの臨界点
- 「装置は動くがプロセスが成立しない」――He供給危機とナフサ不足の本質
- He/ナフサ供給危機で工場新設も遅延? 装置/チップメーカーへの波及経路を探る
- 最新ノートPC5機種を分解 新旧MacBook Proの中身の違いは?
- 「AI特需」の恩恵届かぬ日本企業 Gartnerが見る2026年半導体市場
- 「Rapidusの隣」に光電融合パッケージ開発拠点、28年度の完成目指す
- Apple新CEOはエンジニア出身 製品開発重視への回帰か
- ローム・東芝・三菱電機のパワー半導体はどうなるか
- シリコンフォトニクスと先進パッケージの統合が描く未来
- TSMCが次世代ロードマップ公表 A13/A12を29年投入へ

 左=「GFCPシリーズ」 / 右=「DPEG-BP type」
左=「GFCPシリーズ」 / 右=「DPEG-BP type」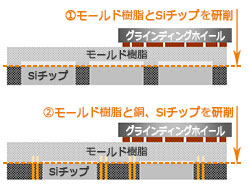 パッケージ研削の例 出典:ディスコ
パッケージ研削の例 出典:ディスコ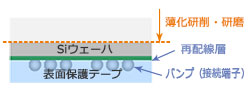 WLCSP薄化の例 出典:ディスコ
WLCSP薄化の例 出典:ディスコ