SiCウエハーの結晶欠陥、非破壊で検査:SEMICON Japan 2016レポート
日立ハイテクノロジーズは、「SEMICON Japan 2016」で、「先端微細化ソリューション」「IoT・パワーソリューション」などのセグメントに分け、新技術や新製品をパネルなどで紹介した。
電位面の凹凸を捕らえて欠陥などを検出
日立ハイテクノロジーズは、「SEMICON Japan 2016」(2016年12月14〜16日/東京ビッグサイト)において、「先端微細化ソリューション」「IoT・パワーソリューション」「アフターセールス/オフライン解析ソリューション」と、大きく3つのセグメントに分け、新技術や新製品をパネルなどで紹介した。
ブースで注目を集めた新製品の1つが、ミラー電子式検査装置「Mirelis VM1000」である。SiC(炭化ケイ素)ウエハーの結晶欠陥や加工ダメージの非破壊検査を可能とした。ウエハーの結晶欠陥などはウエハー内部に存在することから、表面検査で発見することが難しく、これまでは切断などによる破壊検査が主体であった
新開発のMirelis VM1000は、「ミラー電子式」と呼ぶ新たなコンセプトの検査装置となっている。測定対象のSiCウエハー試料にマイナスの電圧を印加すると、試料の表面に電位面が形成される。これによって、入射した電子線は、試料直上の電位面で反射する。電子線が試料に直接あたることはないという。
SiCウエハー試料に加工ダメージや結晶欠陥があると、電位面に凹凸が生じる。電位面ではね返った電子線からその変化を捕らえて欠陥像を形成すれば、非破壊でウエハー内部の欠陥結晶や加工ダメージを検出することが可能になる。
最大30kVの加速電圧で、オーバーレイ計測を実現
もう1つは、高加速測長装置「CV5000」シリーズである。電子線加速電圧が最大30kVの電子光学系を新たに開発し搭載した。また、計測時に試料から発生する二次電子(SE)や後方散乱電子(BSE)を、発生角度別やエネルギーの強弱別に選択する検出技術を採用している。これによって、アスペクト比が40以上の深い穴や溝底の回路線幅計測、高精度オーバーレイ計測を実現した。
これまでの計測装置では必要だった専用マークを用いなくても、高加速電圧を選択すれば、微細なデバイスパターン上における上下層間のオーバーレイ計測が可能となる。インチップ内における重ね合わせを、極めて高い精度で行うことができるという。
関連記事
 アドバンテスト、IoTデバイスに向けたテスト装置
アドバンテスト、IoTデバイスに向けたテスト装置
アドバンテストは、高速ミックスドシグナルICテストなど、主要な分野におけるIoT(モノのインターネット)デバイスに向けたテストソリューションを「SEMICON Japan 2016」で紹介した。 製造コスト「数十分の1」、卓上半導体工場
製造コスト「数十分の1」、卓上半導体工場
半導体製造の後工程に革新が生まれそうだ。コネクテックジャパンは製造プロセスを一新することで、後工程に必要なコストを抑え、実装時間を短縮するフリップチップ実装装置「MONSTER DTF」を開発した。特徴は低荷重、低温で半導体パッケージを基板に実装すること。例えばMEMSパッケージをフリップチップ実装できるようになり、最終製品の小型・軽量化にもつながるという。 新ブランドを訴求するTEL、鍵は「緑色の正方形」
新ブランドを訴求するTEL、鍵は「緑色の正方形」
東京エレクトロン(TEL)は、「SEMICON Japan 2016」(2016年12月14〜16日/東京ビッグサイト)で、2015年に新しくしたブランドロゴのイメージ定着を図る展示を行う。 フォトレジスト不要で直接パターニング、VUVユニット
フォトレジスト不要で直接パターニング、VUVユニット
ウシオ電機は、「SEMICON Japan 2016」(2016年12月14〜16日/東京ビッグサイト)で、フォトレジストが不要で直接パターニングができる真空紫外平行光ユニットなどを展示している。 銅配線プロセスとメタルハードマスクで新技術
銅配線プロセスとメタルハードマスクで新技術
アルバックは、「SEMICON Japan 2016」(2016年12月14〜16日/東京ビッグサイト)で、マルチチャンバー型スパッタリング装置として、メインプラットフォーム向け「ENTRON-EX W300」や、小規模量産ライン向け「MLX-3000N」などを紹介する。 「地図はここに」 40周年SEMICONが魅せる世界
「地図はここに」 40周年SEMICONが魅せる世界
マイクロエレクトロニクス製造サプライチェーンの国際展示会「SEMICON Japan 2016」(2016年12月14〜16日/東京ビッグサイト)は、2016年の開催で40周年を迎える。主催者であるSEMIジャパンの代表を務める中村修氏に、その見どころなどについて聞いた。
Copyright © ITmedia, Inc. All Rights Reserved.
記事ランキング
- オムロン、祖業の電子部品事業を売却へ 事業価値810億円
- 「世界2位」は実現するか、ローム、東芝、三菱電機とデンソーの選択は
- Musk氏は「半導体製造の再定義」を目指すのか
- Wi-Fi HaLow日本市場がついに加速か 850MHz帯解放も後押し
- ローム、8インチSiC MOSFET開発の技術目標を2年前倒しで達成
- 世界半導体市場は26年2月に大幅成長、日本のみ9カ月連続マイナスに
- JDIが鳥取工場を売却、車載用液晶パネル拠点
- ソニー、新会社「BRAVIA」にテレビ事業を承継 企業価値1028億円
- シャープ新社長は海外事業出身 鴻海と連携で「新たな成長ステージへ」
- 米Waymoの世界展開は東京から 「開始まで何年もかからない」

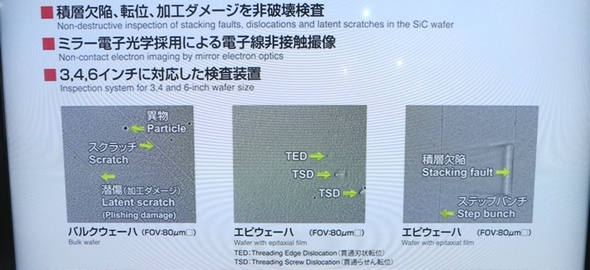 電位面ではね返った電子線から、その変化を捕らえて欠陥像を形成することで、SiCウエハーの非破壊検査が行える
電位面ではね返った電子線から、その変化を捕らえて欠陥像を形成することで、SiCウエハーの非破壊検査が行える