メモリチップの生産性を向上するダイセパレーター:ディスコが開発
ディスコは2019年12月2日、300mmウエハー対応のフルオートマチックダイセパレーター「DDS2320」を開発したと発表した。メモリ生産においてスループットと信頼性の向上を実現できると同社は述べる。
メモリチップ生産のスループットと信頼性を向上
ディスコは2019年12月2日、300mmウエハー対応のフルオートマチックダイセパレーター「DDS2320」を開発したと発表した。メモリ生産においてスループットと信頼性の向上を実現できると同社は述べる。DDS2320の販売開始は2020年7月を予定している。
DDS2320では、新たに開発したエキスパンドユニットを採用。効率的な薄チップ生産が可能になるとする。
従来機である「DDS2300」では、クールエキスパンドとヒートシュリンクを別々の加工ユニットで実施していたが、DDS2320では同一ユニットで加工を行う。これにより、従来機で必要だったユニット間のワーク搬送が不要になるので、生産性が向上し、搬送中の破損リスクも低減できる。
さらに、DDS2300では1カ所のみだったエキスパンドユニットを、DDS2320では2カ所に搭載している。これにより並列加工が可能になるので、さらなる生産性の向上が期待できる。なお、ヒートシュリンク後は、テープフレームのままダイボンディング工程へと移行が可能で、この点は従来機と変わらない。
DDS2320ではワーク面を下向きに反転させて加工、搬送を行うので、パーティクルの付着を低減できる。具体的には、ワーク面を下向きにしてクールエキスパンドとヒートシュリンクを行うことで、チップ分割やテープ収縮時に発生するパーティクルを落下させ、再付着を防止する。さらに、チップ化した後もそのままワーク面を下向きにしておき、スピンナ洗浄を行うので、パーティクルの再付着を抑えることができる。
その他、従来機で装置周辺に設置していた付帯機器を、DDS2320では装置内に収めたことで、占有面積を従来比で約40%削減したという。
ディスコは、2019年12月11〜13日に開催される「SEMICON Japan 2019」で、DDS2320を出展する。
関連記事
 ディスコ、長野・茅野工場内に新棟を建設
ディスコ、長野・茅野工場内に新棟を建設
ディスコは、長野県茅野市にある長野事業所・茅野工場内に免震構造の新棟を建設することを決めた。投資総額は約175億円を予定する。 SiCインゴットのスライス加工、完全自動化へ
SiCインゴットのスライス加工、完全自動化へ
ディスコは、「SEMICON Japan 2017」で、KABRAプロセスによるSiCインゴッドスライス工程を全自動化した装置などを実機展示した。 “他にないスライス技術”がSiCの生産効率を4倍へ
“他にないスライス技術”がSiCの生産効率を4倍へ
半導体製造装置メーカーであるディスコは、今までにない手法を用いたレーザー加工によるインゴットスライス手法「KABRA(カブラ)」プロセスを開発したと発表した。SiC(炭化ケイ素)ウエハー生産の高速化、取り枚数増を実現し、従来方式と比較して生産性を4倍向上させることが可能という。 SoitecとApplied、次世代SiC基板で共同開発へ
SoitecとApplied、次世代SiC基板で共同開発へ
高性能半導体材料の生成と製造を手掛けるフランスのSoitecと米国の半導体製造装置ベンダーであるApplied Materialsは2019年11月18日(フランス時間)、電気自動車や通信、産業機器などに対する需要の高まりを受け、パワーデバイス向けに次世代SiC基板の共同開発プログラムを実施すると発表した。 2020年の半導体市場、前年比5.9%増で回復基調に
2020年の半導体市場、前年比5.9%増で回復基調に
WSTS(World Semiconductor Trade Statistics:世界半導体市場統計)は2019年12月3日、2019年秋季の半導体市場予測を発表した。それによると、2020年の半導体市場は前年比5.9%増と回復基調になるという。 「半導体が産業の主役に」SEMICON Japan 2019の狙い
「半導体が産業の主役に」SEMICON Japan 2019の狙い
2019年12月11〜13日、マイクロエレクトロニクス国際展示会「SEMICON Japan 2019」が、東京ビッグサイトで開催される。今回のキーメッセージは、「次代のコアになる。」だ。主催者であるSEMIジャパンで代表を務める浜島雅彦氏に、SEMICON Japan 2019の狙いや見どころなどを聞いた。
Copyright © ITmedia, Inc. All Rights Reserved.
記事ランキング
- 「世界初」成果で1000層超3Dフラッシュに道筋、キオクシアとSandisk
- ナフサ危機で迫る「レジスト供給途絶」――世界の半導体工場を停止させる、もう一つの臨界点
- 次世代パワー半導体 「期待の5材料」の現在地
- パワー半導体世界市場、2035年は7兆円超え 酸化ガリウムも一定規模に
- 入学した瞬間終わったわ――「講義が英語」なんて一言も聞いてない!
- TSMCが次世代ロードマップ公表 A13/A12を29年投入へ
- SK hynixの四半期決算、驚異の売上高営業利益率70%超え
- TED、25年度は減収減益 「各事業磨き上げる」と新社長
- 「データの死蔵に耐えられないエンジニア」がたどり着いたMASの沼
- 村田製作所、25年度は売上高が過去最高 データセンター向けは70%増


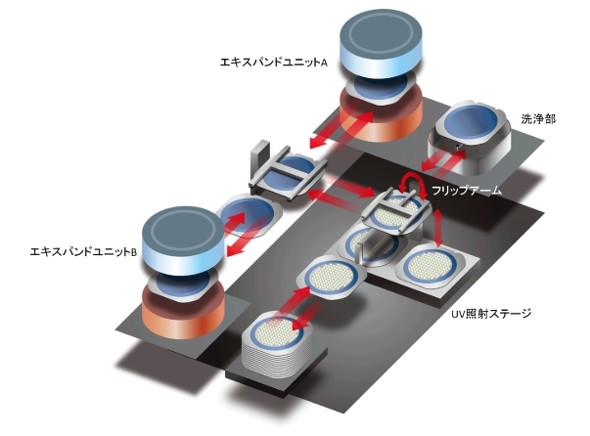 クールエキスパンドとヒートシュリンクを同一ユニットにした 出典:ディスコ
クールエキスパンドとヒートシュリンクを同一ユニットにした 出典:ディスコ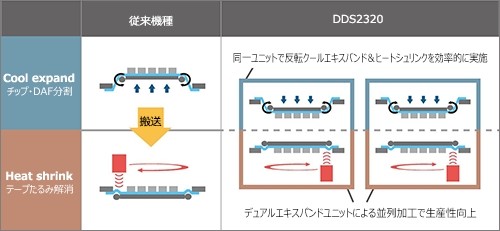 ワーク面を反転させて加工と搬送を行う 出典:ディスコ
ワーク面を反転させて加工と搬送を行う 出典:ディスコ