5Gの移動通信システムを支えるミリ波のパッケージ技術:福田昭のデバイス通信(215) 2019年度版実装技術ロードマップ(26)(2/2 ページ)
アンテナをフロントエンドに取り込んで損失を低減
ミリ波帯域の28GHz帯では、従来の電子デバイスパッケージ技術とは異なる、独自のパッケージ技術が使われる。
例えば28GHz帯の送受信を扱う「フロントエンドモジュール(FEM:Front End Module)」は、3次元構造の3D SiPとなる。モジュール基板の両面に送信用パワーアンプや受信用低雑音アンプ、集積化受動素子、スイッチ、位相シフタなどを搭載する。これらの部品は、はんだバンプでモジュール基板にフリップチップ接続される。既存のチップインダクターやチップコンデンサーなどの受動部品は、あまり搭載されない。モジュール基板の配線によって受動素子を形成する。モジュール基板の材料には、低温同時焼成セラミック(LTCC:Low Temperature Co-fired Ceramics)、ガラス、有機材料などがある。
28GHz帯で重要なのは、絶縁材料の選択である。比誘電率は3.0以下、誘電正接は0.01以下、吸水率は0.1%以下であることが望ましい。厚みは10μm前後である。配線に対しては幅のばらつきに対する制限が厳しくなる。±3%〜±5%以内に抑えたい。
さらに5Gでは、アンテナをFEMと一体化することが考えられている。4G/LTE移動通信システムではアンテナとFEMをフレキシブルプリント基板で接続していた。しかし28GHz帯の5Gではプリント基板の配線による電気的な損失が無視できない。また28GHz帯では波長が短くなるのでアンテナが小さくなることも、一体化には有利に働く。
このため、アンテナとFEMを積層した「AiP(Antenna in Package)」と呼ばれるSiPが開発され、実用化が始まっている。
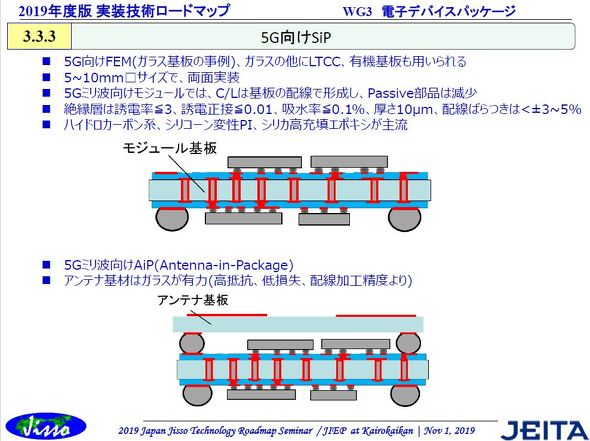 第5世代(5G)の移動通信システム用SiPの構造。上はFEM(フロントエンドモジュール)の例。モジュール基板の材料はガラス。下はFEMとアンテナを積層したAiP(Antenna in Package)の例。アンテナの基板材料はガラス。出典:JEITA(クリックで拡大)
第5世代(5G)の移動通信システム用SiPの構造。上はFEM(フロントエンドモジュール)の例。モジュール基板の材料はガラス。下はFEMとアンテナを積層したAiP(Antenna in Package)の例。アンテナの基板材料はガラス。出典:JEITA(クリックで拡大)(次回に続く)
⇒「福田昭のデバイス通信」連載バックナンバー一覧
関連記事
 1個のパッケージでシステムを実現するSiP
1個のパッケージでシステムを実現するSiP
今回は、SiP(System in Package)を実現する幾つかの手法のうち、2.X次元(2.XD)の実装技術を解説する。ここでカギとなるのは、インタポーザだ。 パッケージの多端子化と小型化、薄型化、低コスト化が進む
パッケージの多端子化と小型化、薄型化、低コスト化が進む
今回は第3章「電子デバイスパッケージ」から、各種パッケージの技術動向を紹介する。半導体パッケージの歴史は、多端子化と小型化、薄型化、低コスト化の歴史でもある。 IoT社会に向けて多様化する電子デバイスパッケージ
IoT社会に向けて多様化する電子デバイスパッケージ
今回から、第3章「電子デバイスパッケージ」の概要を説明していく。「2019年度版 実装技術ロードマップ」で約70ページが割かれている重要な章だ。序章では、年間で1兆個のセンサーが生産される「トリリオンセンサー」について言及している。【訂正あり】 Intelが3つの次世代パッケージング技術を明らかに
Intelが3つの次世代パッケージング技術を明らかに
Intelは、米国カリフォルニア州サンフランシスコで2019年7月9〜11日の日程で開催されている「SEMICON West 2019」に合わせて行われたイベントにおいて、3種類のパッケージング技術に関する同社のロードマップを初めて明らかにした。 5Gではデバイスのテストも変わる、「OTA」が重要に
5Gではデバイスのテストも変わる、「OTA」が重要に
5G(第5世代移動通信)実現に向けて高周波半導体デバイスを開発、供給するメーカーが直面している課題の一つがテストだ。今後のテストでは「OTA(Over-The-Air)」が鍵になるだろう。
Copyright © ITmedia, Inc. All Rights Reserved.
記事ランキング
- 「世界初」成果で1000層超3Dフラッシュに道筋、キオクシアとSandisk
- ナフサ危機で迫る「レジスト供給途絶」――世界の半導体工場を停止させる、もう一つの臨界点
- 次世代パワー半導体 「期待の5材料」の現在地
- パワー半導体世界市場、2035年は7兆円超え 酸化ガリウムも一定規模に
- 入学した瞬間終わったわ――「講義が英語」なんて一言も聞いてない!
- TSMCが次世代ロードマップ公表 A13/A12を29年投入へ
- SK hynixの四半期決算、驚異の売上高営業利益率70%超え
- TED、25年度は減収減益 「各事業磨き上げる」と新社長
- 「データの死蔵に耐えられないエンジニア」がたどり着いたMASの沼
- 村田製作所、25年度は売上高が過去最高 データセンター向けは70%増

