半導体の微細化は2035年まで続く 〜先端ロジックのトランジスタと配線の行方:湯之上隆のナノフォーカス(55)(4/5 ページ)
Ruの直接加工の優位性
前掲の図10の比較表から、RuとMoは、いずれも、Damasceneでも直接加工でも形成可能であることが分かる。ここで、Ruの微細配線については、Damasceneより直接加工の方が有利であることが、IBMの野上毅氏等の研究で明らかになった(図11)。
まず、DamasceneでRu配線を形成する場合、Low-k絶縁膜に溝を形成し、その溝をRuのCVDで埋め込み、不要な部分をCMPで除去することになる。この方法の場合、どうしてもRuの微細配線には、多数のグレインバウンダリが生じてしまう。それは配線抵抗を増大させる原因になる。
一方、Ruの直接加工で配線を形成する場合、ウエハ上にRu膜を成膜し、十分アニールすると、Ruのグレインを巨大化することができる。その上で、Ruの垂直加工を行えば、その微細配線のグレインバウンダリを極限まで少なくできる。従って、Ruについては、Damasceneより直接加工の方が微細配線の形成に有利であることが分かる。
しかし、これを実現するためには、Ruの垂直加工ができなくてはならない。Ruは、Pt族に類する安定な金属である。従って、その垂直なドライエッチングは簡単ではないはずだ。ところが、Ruの垂直加工ができないという話は聞こえてこない。それはなぜか?
1998年に開発されたRuのドライエッチング技術
Ruの垂直加工は、いつ、誰が実現したのか?
それは、1998年に、日立製作所のデバイス開発センタに所属していた筆者(湯之上隆)とその上司の野尻一男氏(2000年にLamResearchに転職、2019年からナノテクリサーチ代表)の共同開発によって実現された(図12)。
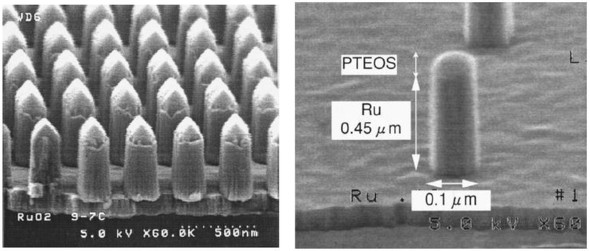 図12:1998年に日立製作所で実現したRuやRuO2の垂直加工[クリックで拡大] 出所:Takshi Yunogami and Kazuo Nojiri, “Anisotropic etching of RuO2/Ru with high aspect ratio for Giga-bit-DRAM”, J.Vac.Sci.Tech.,B18 (2000) pp.1914-1914.
図12:1998年に日立製作所で実現したRuやRuO2の垂直加工[クリックで拡大] 出所:Takshi Yunogami and Kazuo Nojiri, “Anisotropic etching of RuO2/Ru with high aspect ratio for Giga-bit-DRAM”, J.Vac.Sci.Tech.,B18 (2000) pp.1914-1914.筆者らはこのとき、1GビットDRAMの開発に従事していた。そのDRAMのキャパシタ絶縁膜には、Barium Strontium Titanium Oxide (BST)が使われる予定となっていたが、BSTは酸化力が強いため、キャパシタ電極にポリSiは使えない。BSTとの接触面が絶縁膜のSiO2になってしまうためである。
そこで、酸化されない安定な電極材料として、Pt属のRuが候補になった。しかし、安定なメタルということは、垂直なドライエッチングも難しいということである。そのような中で、筆者らは、Lamの誘導結合型プラズマエッチング装置(Lamの登録商標はTCP)を改良することによって、図12に示したピラーの垂直加工(正確に言うと89度)を実現した。そして、この結果を米真空学会で発表し、学術雑誌Journal of Vacuum Science and Technologyに投稿して、2000年に採択された。
それから22年が経過した現在、筆者らが開発したRuのドライエッチング技術がやっと陽の目を見ようとしている。いったん、半導体の舞台から退場したRuがここ数年、脚光を浴びるようになり、先端ロジックの微細配線に使われる可能性が濃厚になってきている。筆者としては、とても感慨深いものがある。
Copyright © ITmedia, Inc. All Rights Reserved.
記事ランキング
- 「世界初」成果で1000層超3Dフラッシュに道筋、キオクシアとSandisk
- ソニー半導体、26年度は減収見込み メモリ市況不透明
- ソニーセミコンCTOに聞く――イメージセンサー技術革新の核
- 「膿み出し切った」SiC関連減損で過去最大1584億円赤字 ローム
- ペロブスカイト/CIGSタンデム太陽電池で「世界最高」効率達成、東京都市大ら
- パワー半導体3社連合とデンソー提携のアナログ「両軸を強化」 ローム社長
- 26年3月の世界半導体市場は79%増、日本も10カ月ぶりプラス成長
- DRAM不足で変わるAIシステム設計 エッジAIや特化型モデルに追い風
- ナフサ危機で迫る「レジスト供給途絶」――世界の半導体工場を停止させる、もう一つの臨界点
- 「画素の製造もパートナーと」十時氏が語る、ソニー×TSMC合弁の狙いと期待