富士フイルムが後工程材料に攻勢 「PFASフリー」レジストを発表:半導体材料事業の売上高倍増へ(2/2 ページ)
ラミネートタイプの層間絶縁膜材料を開発
後工程向けの新規材料として、感光性層間絶縁膜フィルム(ポリイミドフィルム)と放熱シート(TIM:Thermal Interface Module)を開発した。
高い演算能力が必要とされるAI向け半導体では、高集積化や大型化が進む。それに伴い、チップレット集積や2.5D/3D実装などパッケージ構造も大きく変化しようとしている。特にインターポーザーは、シリコンインターポーザーから有機インターポーザーへの移行や、多層化、パネルサイズ(510×515mmなど)への大型化に向けた開発が活発になっている。こうした背景を受け、富士フイルムは有機インターポーザーの平坦化を実現する感光性層間絶縁膜フィルムを開発した。
現在、層間絶縁材料として使われている液状ポリイミドは、銅配線の形状によってどうしても、へこみ(アンジュレーション)ができてしまう。インターポーザーの層数が増えるとアンジュレーションによって微細な配線パターンを形成するのが難しくなる。富士フイルムが開発した層間絶縁膜フィルムは、ラミネートすることで、フィルム表面の平坦性を維持したまま多層化できるという。
野口氏は「510×515mmのサイズでは液状ポリイミドを使えるが、それ以上に大型化すると、多層化することが難しくなる。ポリイミドフィルムを導入する際は、新しい装置(ラミネーター)が必要になるが、基板メーカーにとってはなじみのある装置であり、インフラとして保有しているケースも多いので、そこまでの追加投資は必要ないと考えている」と説明した。
TIM材は、銅ナノワイヤと樹脂を混合したハイブリッドシートで、マテリアルズインフォマティクス(MI)を活用して開発した。
岩崎氏は「今後は後工程に、前工程の技術が適用されていく。前工程の材料で強みを持つ当社は、後工程に参入できる大きな競争優位性を持つ」と語った。なお、後工程新規材料の収益化の時期については明らかにせず、「まずはポリイミドフィルムが大きく成長し、その次がTIM材だとみている」と述べるにとどめた。
関連記事
 富士フイルム、ナノインプリントレジストを発売
富士フイルム、ナノインプリントレジストを発売
富士フイルムは、半導体製造技術「ナノインプリントリソグラフィ」に適合する半導体材料「ナノインプリントレジスト」を開発、2024年5月下旬より富士フイルムエレクトロニクスマテリアルズを通じて販売する。 富士フイルム、ベルギーでCMPスラリー生産へ 40億円投資
富士フイルム、ベルギーでCMPスラリー生産へ 40億円投資
富士フイルムは、ベルギーの同社生産拠点にCMPスラリーの生産設備を新たに導入すると発表した。既存のフォトリソ周辺材料生産設備も増強する。設備投資は総額約40億円。 富士フイルム、熊本でCMPスラリーの製造を開始
富士フイルム、熊本でCMPスラリーの製造を開始
富士フイルムは、富士フイルムマテリアルマニュファクチャリング九州エリア(FFMT九州、熊本・菊陽町)で、半導体製造プロセスに用いられる「CMPスラリー」の製造を始めたと発表した。同社は米国や韓国、台湾でCMPスリラーを製造しているが、国内拠点での生産は初めてとなる。 線幅サブミクロンも視野に パッケージ向け露光装置でウシオとAppliedが協業
線幅サブミクロンも視野に パッケージ向け露光装置でウシオとAppliedが協業
ウシオ電機とApplied Materialsは2023年12月、戦略的パートナーシップの締結を発表した。両社が「DLT(Digital Lithography Technology)」と呼ぶ、半導体パッケージ基板向けの新しいダイレクト露光装置を早期に市場に投入し、大型化や配線の微細化など半導体パッケージ基板への要求に応えることを目指す。 プロセッサやメモリなどの進化を支えるパッケージ基板
プロセッサやメモリなどの進化を支えるパッケージ基板
今回は第3章第4節第8項(3.4.8)「パッケージ基板」の概要を説明する。パッケージ基板の変遷と、パッケージ基板に対する要求仕様のロードマップを解説する。 Intelがガラス基板を本格採用へ、2020年代後半から
Intelがガラス基板を本格採用へ、2020年代後半から
Intelは、パッケージ基板の材料にガラスを採用することを発表した。データセンターやAI(人工知能)などワークロードが高い用途をターゲットに、ガラス基板パッケージを採用したチップを2020年代後半にも投入する計画だ。
Copyright © ITmedia, Inc. All Rights Reserved.
記事ランキング
- 「世界初」成果で1000層超3Dフラッシュに道筋、キオクシアとSandisk
- ナフサ危機で迫る「レジスト供給途絶」――世界の半導体工場を停止させる、もう一つの臨界点
- ソニー半導体、26年度は減収見込み メモリ市況不透明
- TSMCが次世代ロードマップ公表 A13/A12を29年投入へ
- 次世代パワー半導体 「期待の5材料」の現在地
- パワー半導体世界市場、2035年は7兆円超え 酸化ガリウムも一定規模に
- 入学した瞬間終わったわ――「講義が英語」なんて一言も聞いてない!
- TED、25年度は減収減益 「各事業磨き上げる」と新社長
- SK hynixの四半期決算、驚異の売上高営業利益率70%超え
- 「画素の製造もパートナーと」十時氏が語る、ソニー×TSMC合弁の狙いと期待

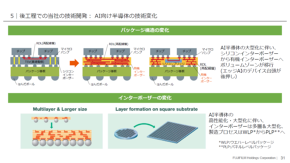


 富士フイルム 岩崎氏(左)と野口氏(右)
富士フイルム 岩崎氏(左)と野口氏(右)