複数のミニダイ(チップレット)を1つのパッケージに収容する:福田昭のデバイス通信(506) TSMCが解説する最新のパッケージング技術(3)(1/2 ページ)
2025年12月に開催された国際学会IEDMにおける、TSMCの講演を解説するシリーズ。今回は、前回に続き、「先進パッケージ技術の進化」を取り上げる。分割した複数のミニダイを同一パッケージに収容する際の、3つの接続手法を解説する。
高性能プロセッサは従来パッケージから先進パッケージに移行
2025年12月に開催された国際学会IEDMのショートコース(技術解説)で、シリコンファウンドリー最大手のTSMCが最新のパッケージング技術を説明した。講演のタイトルは「Advanced Packaging and Chiplet Technologies for AI and HPC Applications(AIおよびHPCに向けた先端パッケージング技術と先端チップレット技術)」、講演者はAdvanced Package Integration Division R&DのディレクターをつとめるJames Chen氏である。大変に参考となる内容だったので、その一部をシリーズでご紹介している。ただし講演内容だけでは説明が不十分なところがあるので、本シリーズでは読者の理解を助けるために、講演内容を筆者が適宜、補足してある。あらかじめご了承されたい。
 講演「Advanced Packaging and Chiplet Technologies for AI and HPC Applications(AIおよびHPCに向けた先端パッケージング技術と先端チップレット技術)」のアウトライン[クリックで拡大] 出所:TSMC(IEDM 2025のショートコース(番号SC1-5)で公表された講演スライドから)
講演「Advanced Packaging and Chiplet Technologies for AI and HPC Applications(AIおよびHPCに向けた先端パッケージング技術と先端チップレット技術)」のアウトライン[クリックで拡大] 出所:TSMC(IEDM 2025のショートコース(番号SC1-5)で公表された講演スライドから)講演でタイトルスライドの次に示されたアウトラインは、「AI and HPC Market Outlook(AIとHPCの市場を展望)」「Advanced Package Technology Evolutions(先進パッケージ技術の進化)」「System-Technology Co-Optimization (STCO)(システムと製造の協調最適化)」「Emerging Advanced package technology(次世代の先進パッケージ技術)」「Summary(まとめ)」となっていた。
本シリーズの前回は、アウトラインの第2項「Advanced Package Technology Evolutions(先進パッケージ技術の進化)」に相当する部分を述べた。今回はその続きとなる。
Chen氏の講演では、高性能コンピューティング(HPC)および人工知能(AI)の演算処理を担う主要なプロセッサ(アクセラレーター)の進化を振り返った。対象の西暦年は1998年から2023年までだ。
1998年の大規模高性能プロセッサはAI応用ではなく、HPC応用が主眼だった。事例として挙げられたプロセッサはCPU(Intel Xeon)である。パッケージは従来パッケージ技術のフリップチップピングリッドアレイ(FCPGA)が使われた。当時は高性能CPUの標準的なパッケージがPGAであり、プリント基板のソケットにPGAのピンを挿入する実装方式がふつうだった。主記憶は外付けのSDRAMである。
2006年になるとGPUが台頭する。事例として挙げられたプロセッサは汎用GPU(General purpose GPU)(NVIDIAのC870)である。従来パッケージ技術のフリップチップボールグリッドアレイ(FCBGA)に封止した。主記憶は外付けのGDDR3 SDRAMである。
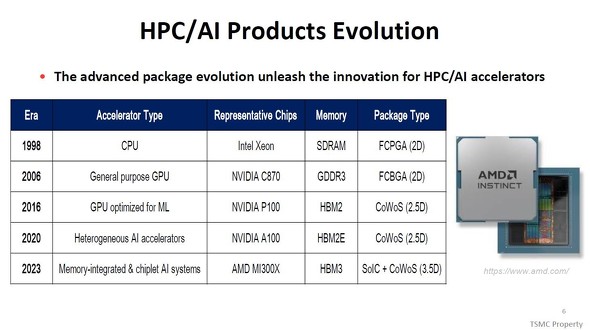 高性能コンピューティング(HPC)および人工知能(AI)の演算処理を担う主要なプロセッサ(アクセラレータ)と主記憶、パッケージの変遷[クリックで拡大] 出所:TSMC(IEDM 2025のショートコース(番号SC1-5)で公表された講演スライドから)
高性能コンピューティング(HPC)および人工知能(AI)の演算処理を担う主要なプロセッサ(アクセラレータ)と主記憶、パッケージの変遷[クリックで拡大] 出所:TSMC(IEDM 2025のショートコース(番号SC1-5)で公表された講演スライドから)2016年には、先進パッケージング技術の実用事例が登場する。機械学習向けに開発されたGPU(NVIDIA P100)である。GPUダイとメモリモジュール(HBM2規格)を中間基板(インターポーザー)経由で接続し、同一のパッケージ(BGAタイプ)に封止した(参考記事:「シリコンインターポーザを導入した高性能パッケージの製品例」)。TSMCはこの先進パッケージング技術を「CoWoS(Chip on Wafer on Substrate)」と呼んでいる。
2020年には、ヘテロジニアス集積化によるAIアクセラレーター(NVIDIA A100)にも先進パッケージング技術が使われる。GPUダイ(A100)とメモリモジュール(HBM2E規格)を中間基板(インターポーザー)経由で接続し、同一のパッケージ(BGAタイプ)に封止した。
2023年には、2枚のミニダイ(チップレット)を積層する技術(TSMCは「SoIC(System on Integrated Chips)」と呼称)を実用化する。事例となったプロセッサはAMDのGPU(AMD MI300X)であり、GPUとメモリモジュール(HBM3規格)を中間基板経由で接続している。
Copyright © ITmedia, Inc. All Rights Reserved.
記事ランキング
- 「世界初」成果で1000層超3Dフラッシュに道筋、キオクシアとSandisk
- ソニー半導体、26年度は減収見込み メモリ市況不透明
- 「膿み出し切った」SiC関連減損で過去最大1584億円赤字 ローム
- ペロブスカイト/CIGSタンデム太陽電池で「世界最高」効率達成、東京都市大ら
- ナフサ危機で迫る「レジスト供給途絶」――世界の半導体工場を停止させる、もう一つの臨界点
- 26年3月の世界半導体市場は79%増、日本も10カ月ぶりプラス成長
- DRAM不足で変わるAIシステム設計 エッジAIや特化型モデルに追い風
- パワー半導体3社連合とデンソー提携のアナログ「両軸を強化」 ローム社長
- 「画素の製造もパートナーと」十時氏が語る、ソニー×TSMC合弁の狙いと期待
- TSMCが次世代ロードマップ公表 A13/A12を29年投入へ
