製造コスト「数十分の1」、卓上半導体工場:IoTからIoEへ(4/5 ページ)
導電性ペーストとNCPがカギ
MONSTER PAC技術の特徴である低い接合荷重を実現するために、新規材料を開発し、材料を生かした工程を作り上げた。
材料面では2つある。銀を主成分とし、数種類のフィラと混合した導電ペーストが1つ。もう1つは非導電性ペースト(NCP:non conductive paste)だ。
MONSTER DTF装置では、最初の工程で基板上のパターンにスクリーン印刷の一種である凹版印刷を用いて導電ペーストを塗る(図5)。塗り回数は1回だ。この導電ペーストが半導体パッケージとパターンの間の導電路となる。「30μmピッチのバンプを形成でき、現在10μmピッチ対応品を開発中だ」(平田氏)
次の工程では、NCPを注入する。最後に半導体パッケージ(チップ)を載せる。すると、チップ側の端子と導電ペーストが接触する。余分なNCPはパターンの間に排出される。「従来のフリップチップ実装では毛管現象を利用して水のように粘度が低い液体をアンダーフィルとして用いている。当社の手法は全く異なる」(平田氏)
どう異なるのか。NCPが接合に必要な圧力を生み出すことだ。チップを載せた後、雰囲気の温度を高めるとNCPが硬化する。するとNCPが収縮し、チップ端子と導電ペーストが圧着する形で確実に接触する(図6)*3)。
*3) 従来のフリップチップ実装では端子間で金属結合が起こる。MONSTER PAC技術では接触によって導電性を確保する。このため、抵抗が高くなる。「80μmピッチの場合、1端子当たりの抵抗値は20mΩ。はんだと比較すると約10倍だが、実用性を考えれば問題ない値だと考えている」(平田氏)
MEMSパッケージの実装に役立つ
「各種半導体のうち、MEMSパッケージには実装に特に大きな課題がある。現在のスマートフォンですら10個以上のMEMSパッケージを(各種センサーとして)利用している。5G時代になると、SAWフィルターなどもMEMS化していくだろう。つまりMEMSパッケージの搭載数は増える。その一方でMEMSパッケージの実装手法は、実装密度が低いワイヤボンディングだ。最終製品の小型化ができない。矛盾がある。この矛盾を当社の技術であれば解決できる」(平田氏)
MEMSでフリップチップ実装を試みた場合、課題は大きく2つある。図7にあるようにめっきバンプはフォトレジストで囲まれた筒状の構造になる。さらにMEMSでは特有の段差がある。すると、バンプの高さがばらついてしまう。これでは基板との実装時にうまく接合しない。さらに、フォトレジストを剥離する際にMEMS内にある微細な金属部分が飛んでしまう。
「当社の技術を適用すればウエハー上のバンプがそもそも不要だ(図8)。MEMSの金属構造には触らない。これで課題は解決した。既に国内のメーカーでも当社の技術を採用しており、実装受託開発の引き合いの6割をMEMSのフリップチップ実装が占めているほどだ」(平田氏)
Copyright © ITmedia, Inc. All Rights Reserved.
記事ランキング
- 「世界初」成果で1000層超3Dフラッシュに道筋、キオクシアとSandisk
- ナフサ危機で迫る「レジスト供給途絶」――世界の半導体工場を停止させる、もう一つの臨界点
- 次世代パワー半導体 「期待の5材料」の現在地
- パワー半導体世界市場、2035年は7兆円超え 酸化ガリウムも一定規模に
- 入学した瞬間終わったわ――「講義が英語」なんて一言も聞いてない!
- TSMCが次世代ロードマップ公表 A13/A12を29年投入へ
- SK hynixの四半期決算、驚異の売上高営業利益率70%超え
- 「データの死蔵に耐えられないエンジニア」がたどり着いたMASの沼
- TED、25年度は減収減益 「各事業磨き上げる」と新社長
- 村田製作所、25年度は売上高が過去最高 データセンター向けは70%増

 図5 MONSTER DTF装置
図5 MONSTER DTF装置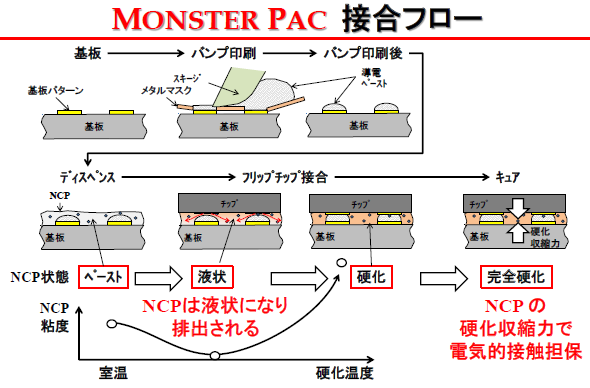 図6 MONSTER PAC技術を用いたフリップチップ実装の全工程 出典:コネクテックジャパン
図6 MONSTER PAC技術を用いたフリップチップ実装の全工程 出典:コネクテックジャパン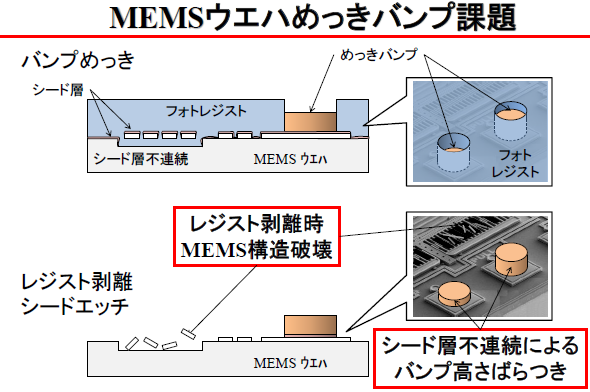 図7 MEMSにフリップチップ実装を適用した場合の課題 出典:コネクテックジャパン
図7 MEMSにフリップチップ実装を適用した場合の課題 出典:コネクテックジャパン 図8 MEMSパッケージに悪影響を与えない実装が可能に 出典:コネクテックジャパン
図8 MEMSパッケージに悪影響を与えない実装が可能に 出典:コネクテックジャパン