新材料「二酸化ハフニウム」を使った強誘電体メモリへの長い道:福田昭のストレージ通信(71) 強誘電体メモリの再発見(15)(2/2 ページ)
強誘電体キャパシターの特性が製品化の可能性を大きく左右
強誘電体不揮発性メモリ(FeRAM)のメモリセルが1T1C方式であろうと、FeFET方式であろうと、最も重要なのは、強誘電体キャパシターの特性である。強誘電体キャパシターの特性が優れていることが、全ての始まりとなる。
既に述べたように、二酸化ハフニウム(HfO2)が強誘電体になることが公に報告されたのは、2011年末のことである。この段階では、「10nm前後とこれまでの常識を覆す薄い膜で」「強誘電体になる」ことが分かっただけで、従来のペロブスカイト系材料と同様に不揮発性メモリ製品となるかどうかなど、全く未知数だった。といっても、「10nm前後の薄い膜で」強誘電体となる材料が発見されたこと自体が、基礎研究あるいは学問としては驚くべきブレークスルーである。
ただし厳しい見方をすれば、基礎研究から本格的な研究開発を経て製品化に至るまでの長い道のりが始まっただけであり、乗り越えなければならない課題は山積している。その課題を1つずつ地道に丁寧に解決していくことが、半導体製品の開発には欠かせない。
その最初の段階は、二酸化ハフニウムを絶縁膜とする強誘電体キャパシターが、優れた特性を備えているかどうかを確かめることである。優れた特性とは何か。粗くまとめてしまうと、残留分極の電荷量と分極反転の回数(寿命)である。他にも抗電界(Ec)の大きさやヒステリシス曲線の形状、そもそも物理的な構造がどのようになっているかなど、調べなければならないことは数多い。
そこで当初は、簡素な構造の強誘電体キャパシターを試作し、電圧(極性が変化する電圧サイクル)を加えて分極反転を繰り返すことが試みられた。そうして得られた特性の変化については、次回に詳しく述べたい。
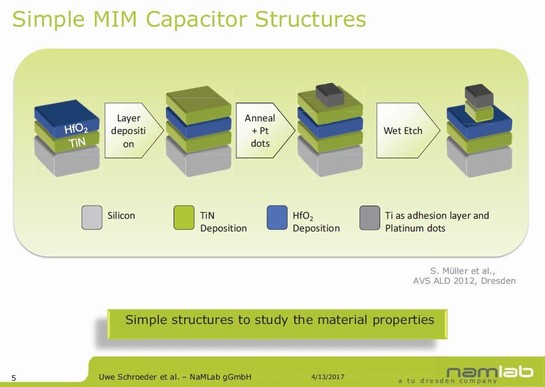 二酸化ハフニウム(HfO2)の強誘電体キャパシターを作製する手順の一例。シリコン基板に下部電極の窒化チタン(TiN)を成膜し、それから二酸化ハフニウムを成膜する。そして上部電極の窒化チタン薄膜を堆積する。熱処理をしてから取り出し、電極となる白金(Pt)薄膜ドットを最上部に形成する。そして白金をマスクとして上部電極の窒化チタンをエッチングする。出典:NaMLab(クリックで拡大)
二酸化ハフニウム(HfO2)の強誘電体キャパシターを作製する手順の一例。シリコン基板に下部電極の窒化チタン(TiN)を成膜し、それから二酸化ハフニウムを成膜する。そして上部電極の窒化チタン薄膜を堆積する。熱処理をしてから取り出し、電極となる白金(Pt)薄膜ドットを最上部に形成する。そして白金をマスクとして上部電極の窒化チタンをエッチングする。出典:NaMLab(クリックで拡大)(次回に続く)
⇒「福田昭のストレージ通信」連載バックナンバー一覧
関連記事
 シリコンの時代は「人類滅亡の日」まで続く(前編)
シリコンの時代は「人類滅亡の日」まで続く(前編)
私たちの日常に欠かせないものになっているシリコン半導体。シリコン半導体は、常に“文明の利器”の進化を支え続けてきたといっても過言ではないだろう。その地位は、今後も揺るがないはずだ。 SSDのフォームファクタ
SSDのフォームファクタ
SSDのフォームファクタは、HDDと大きく異なる。特に注目を集めている小型のフォームファクタ「m.2」など、SSD独自のフォームファクタを紹介していこう。 NANDフラッシュ、開発の視点はチップからソフトへ
NANDフラッシュ、開発の視点はチップからソフトへ
米国シリコンバレーで開催された「Flash Memory Summit 2017」では、3D(3次元) NANDフラッシュメモリや、フラッシュストレージ向けの新しいソフトウェアなどに注目が集まった。 エレクトロニクス産業を動かす“3大潮流”
エレクトロニクス産業を動かす“3大潮流”
変化の激しいエレクトロニクス産業の未来をIHS Markit Technologyのアナリストが予測する。連載第1回は、これからのエレクトロニクス産業を動かしていくであろう“3大潮流”を解説する。 2017Q2のDRAM世界売上高、過去最高の165億ドルに
2017Q2のDRAM世界売上高、過去最高の165億ドルに
2017年第2四半期(4〜6月期)のDRAM世界売上高が、過去最高の165億米ドル以上となった。DRAMeXchangeの予測によると、DRAMの販売価格は2017年の残りの期間、引き続き上昇し続けるという。 米州裁、東芝によるWDへの情報遮断禁止期間を延長
米州裁、東芝によるWDへの情報遮断禁止期間を延長
カリフォルニア州上級裁判所は、東芝がWestern Digital(ウエスタンデジタル/WD)に対して実施してきた情報遮断措置を禁止する予備的差止命令を発令した。
Copyright © ITmedia, Inc. All Rights Reserved.
記事ランキング
- 「世界初」成果で1000層超3Dフラッシュに道筋、キオクシアとSandisk
- ナフサ危機で迫る「レジスト供給途絶」――世界の半導体工場を停止させる、もう一つの臨界点
- 次世代パワー半導体 「期待の5材料」の現在地
- パワー半導体世界市場、2035年は7兆円超え 酸化ガリウムも一定規模に
- 入学した瞬間終わったわ――「講義が英語」なんて一言も聞いてない!
- TSMCが次世代ロードマップ公表 A13/A12を29年投入へ
- SK hynixの四半期決算、驚異の売上高営業利益率70%超え
- TED、25年度は減収減益 「各事業磨き上げる」と新社長
- 「データの死蔵に耐えられないエンジニア」がたどり着いたMASの沼
- 村田製作所、25年度は売上高が過去最高 データセンター向けは70%増
