TSMCの微細化は2nmまで? 以降はパッケージングが肝に:2021 Technology Symposium(3/3 ページ)
パッケージング技術への期待
TSMCは、3nm以降のイノベーションには、新しいトランジスタ構造と材料が必要だと述べる。
同社は、従来のプロセスに比べて銅の結晶粒径を7倍以上に大きく成長させる新しいアニールプロセスにより、バックエンドのインターコネクトのブレークスルーを実現したと主張する。TSMCによると、このプロセスは配線抵抗を約30%低減し、インターコネクトの微細化の範囲を拡大するという。
TSMCは、InFOの提供も拡張している。TSMCは、2021年後半にもスマートフォン向けの「InFO B」を認定する計画だ。Info Bは、厚さが450μm以下で、最大135mm2のサイズのモバイルSoC(System on Chip)を搭載できる。同社は、最も厳しいフォームファクター要件を満たすために、14×14mmのInFOパッケージを用意しているという。
TSMCはさらに、「InFO oS(InFO on Substrate)」も提供中だ。InFO oSは、「CoWoS R」「CoWoS L」同様に、HPC(High Performance Computing)のアプリケーションに向ける。
WoW(Wafer on Wafer)とCoW(Chip on Wafer)についてもアップデートがあった。CoWについては、2021年までに7nmプロセスのウエハーを利用する「N7-on-N7」を、2022年には5nmウエハーを使用する「N5-on-N5」を認定する計画だ。WoWについては、ディープトレンチキャパシター(DTC)にロジックを統合することを目指す。
【翻訳:田中留美、編集:EE Times Japan】
関連記事
 TSMCの最新プロセスまとめ、3nm以降の開発も進行中
TSMCの最新プロセスまとめ、3nm以降の開発も進行中
TSMCは2021年6月1〜2日に、自社イベント「2021 Technology Symposium」をオンラインで開催した。同イベントで発表された最新プロセスノードなどをまとめる。 IBMがプロセス開発の“契約不履行”でGFに賠償請求か
IBMがプロセス開発の“契約不履行”でGFに賠償請求か
IBMがGLOBALFOUNDRIES(GF)を契約不履行で訴え、25億米ドルの損害賠償を求めている。IBMはこの訴えをGLOBALFOUNDRIESに通告したが、米国EE Timesに対しては、まだ裁判所には提訴しておらず、従って世間に公表する準備もできていないと伝えてきた。GLOBALFOUNDRIESは既に米国ニューヨーク州最高裁判所に対し、この係属中の訴訟を価値がないものとして却下するよう申し立てを行った。 電源/接地線の埋め込みで回路ブロックの電圧降下を半分以下に低減
電源/接地線の埋め込みで回路ブロックの電圧降下を半分以下に低減
電源/接地配線を基板側に埋め込む「BPR(Buried Power Rails)」について解説する。 NXP、車載プロセッサをTSMCの16nm技術で量産
NXP、車載プロセッサをTSMCの16nm技術で量産
NXP Semiconductorsは、車載ネットワークプロセッサ「S32G2」とレーダープロセッサ「S32R294」について、TSMCの16nm FinFETプロセス技術を用いて、2021年第2四半期(4〜6月)より量産を始めた。 半導体不足は「ジャストインタイム」が生んだ弊害、TSMCが急所を握る自動運転車
半導体不足は「ジャストインタイム」が生んだ弊害、TSMCが急所を握る自動運転車
深刻な半導体不足が続く中、自動車メーカーは苦境に陥っている。だが、この苦境は自動車メーカー自らが生み出したものではないか。特に筆者は、「ジャストインタイム」生産方式が諸悪の根源だと考えている。
Copyright © ITmedia, Inc. All Rights Reserved.
記事ランキング
- オムロン、祖業の電子部品事業を売却へ 事業価値810億円
- もはや半導体メーカーの域を超えた NVIDIA最新エッジ機器を分解
- 魚津はTower、砺波はNuvotonに TPSCo事業の再編を発表
- パワー半導体再編が本格化 ローム・東芝・三菱電機が協議開始へ
- キオクシアがNanyaに774億円出資、DRAM長期供給契約を締結
- デンソー、ロームに対する株式取得提案を正式表明
- 「Renesas 365」がついに始動 「不可能だった規模」の検証、数分で
- Armが半導体の自社開発に参入、AIデータセンター向けCPU発表
- 「究極の半導体」ダイヤモンドを社会へ 動態展示も実現の早大発新興
- NVIDIAとメモリ3社、世界半導体売上高の42%占める

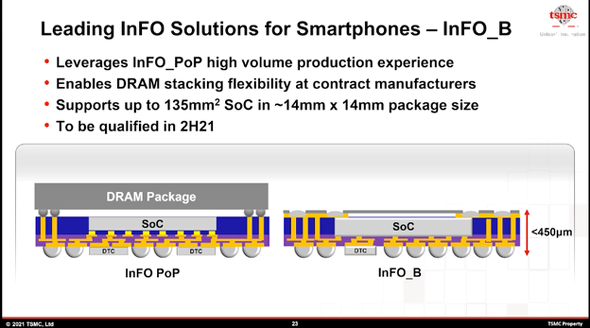 「InFO B」の概要。DRAMを積層することも可能だ 出典:TSMC
「InFO B」の概要。DRAMを積層することも可能だ 出典:TSMC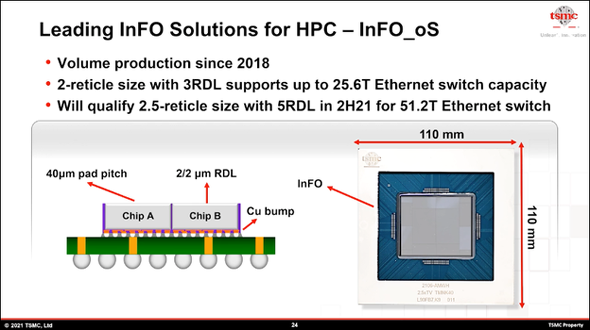 HPC向けの「InFO oS」 出典:TSMC
HPC向けの「InFO oS」 出典:TSMC HPC向けの3D積層技術 出典:TSMC
HPC向けの3D積層技術 出典:TSMC