AI/HPCシステムの死命を制する消費電力・放熱設計(後編):福田昭のデバイス通信(512) TSMCが解説する最新のパッケージング技術(9)(2/2 ページ)
放熱(冷却)技術がプロセッサの許容電力を大きく左右
AI/HPCプロセッサの許容電力を大きく左右するのが、放熱技術(冷却技術)である。ただし放熱性能の高い冷却技術は、一般的にはコストが高い。初期費用、運転費用とも、基本的に高くなる。
コストが最も低い放熱技術は、空気の自然対流を利用した「自然空冷(Natural convection air cooling)」である。ヒートシンクのないプラスチックパッケージ封止の半導体ダイでは、消費電力1W前後までが適用範囲とされる。
消費電力が数ワット以上の半導体ダイではヒートシンクに、空気の対流を強制的に促す「強制空冷(Forced convection air cooling)」を組み合わせることが多い。小さなファン(空冷ファン、送風機)によって空気の対流を促す。より大きな消費電力の半導体ダイに対しては、空気の対流速度(風速)を高めることで対応する。
さらに大きな消費電力を許容可能なのが、液体の自然対流を利用した「自然液冷(Natural convection liquid cooling)」である。液体は空気よりも熱伝導に優れていることが多い(例えば、水の熱伝達係数は空気の約25倍)。自然液冷でも不十分な場合は、液体の対流を強制的に実施する強制液冷(Forced convection liquid cooling)を駆使する。
 さまざまな放熱技術(冷却技術)と熱流束(縦軸)、熱伝達係数(横軸)の関係。左下から右上に向かって、空気冷却(空冷)、液体冷却(液冷)、液体から気体への相変化を利用した冷却(相変化冷却)と放熱技術が変化する[クリックで拡大] 出所:TSMC(IEDM 2025のショートコース(番号SC1-5)で公表された講演スライドから)
さまざまな放熱技術(冷却技術)と熱流束(縦軸)、熱伝達係数(横軸)の関係。左下から右上に向かって、空気冷却(空冷)、液体冷却(液冷)、液体から気体への相変化を利用した冷却(相変化冷却)と放熱技術が変化する[クリックで拡大] 出所:TSMC(IEDM 2025のショートコース(番号SC1-5)で公表された講演スライドから)強制液冷でも放熱能力が不足する場合は、液体が気体に変化するときの潜熱(Latent heat)を冷却に利用する「相変化冷却(Phase change cooling)」が選択肢となる。「二相冷却(Two-phase cooing)」とも呼ぶ。
強制液冷の改良で次世代のAI/HPCプロセッサに対応
ハイエンドのAI/HPCプロセッサは現在、強制液冷で放熱することが多い。「冷却プレート(Cold plate)」または「ヒートシンク」の内部に冷却用液体(水や非導電性液体など)を通し、プロセッサが発する熱を奪う。冷却プレート内部には数多くの薄いフィンを精密加工によって形成してあり、液体とプレートの接触面積を増やすことで放熱能力を高めている。
次世代の冷却モジュールでは、パッケージの外装であるリッドにも液体を通す。リッドの内部にはマイクロチャンネルと呼ばれる細長い流路を設けてある。さらに将来は、冷却プレートとパッケージを一体化してTIMを省略することが考えられている。
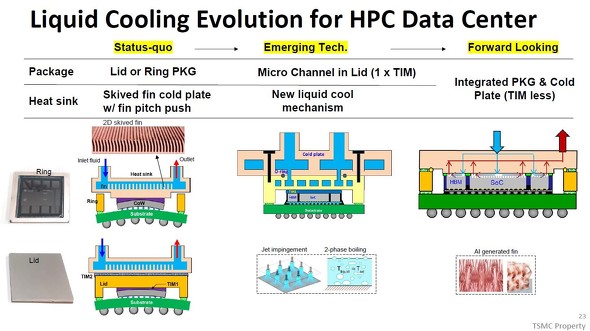 ハイエンドのAI/HPCプロセッサを冷却する強制液冷モジュールの進化。左は現在のモジュール構造例。中央は次世代向けのモジュール構造。リッド内部に液体の流路(マイクロチャンネル)を設ける。右はさらに将来のモジュール構造。冷却プレート(Cold plate)とパッケージを一体化する[クリックで拡大] 出所:TSMC(IEDM 2025のショートコース(番号SC1-5)で公表された講演スライドから)
ハイエンドのAI/HPCプロセッサを冷却する強制液冷モジュールの進化。左は現在のモジュール構造例。中央は次世代向けのモジュール構造。リッド内部に液体の流路(マイクロチャンネル)を設ける。右はさらに将来のモジュール構造。冷却プレート(Cold plate)とパッケージを一体化する[クリックで拡大] 出所:TSMC(IEDM 2025のショートコース(番号SC1-5)で公表された講演スライドから)⇒「福田昭のストレージ通信」連載バックナンバー一覧
関連記事
 AI/HPCシステムの死命を制する消費電力・放熱設計(前編)
AI/HPCシステムの死命を制する消費電力・放熱設計(前編)
「IEDM 2025」におけるTSMCの講演内容を紹介するシリーズ。「(3)Thermal dissipation design(消費電力および放熱の設計)」を前後編に分けて解説する。 ミニダイ(チップレット)間接続におけるSTCO
ミニダイ(チップレット)間接続におけるSTCO
「IEDM 2025」におけるTSMCの講演内容を紹介する。前回に続き、アウトラインの第3項「System-Technology Co-Optimization (STCO)(システム・製造協調最適化)」の内容を解説する。 インターポーザに複数のシリコンダイを近接して並べる2.5次元集積化
インターポーザに複数のシリコンダイを近接して並べる2.5次元集積化
前回に続き、「IEDM 2025」におけるTSMCの講演内容を紹介する。TSMCの2.5次元パッケージング技術「CoWoS(Chip on Wafer on Substrate)」において、インターポーザを低コスト化する技術を解説する。 「フラッシュメモリで」AI演算 消費電力はGPU比で1000分の1に
「フラッシュメモリで」AI演算 消費電力はGPU比で1000分の1に
フローディア(Floadia)が、SONOS構造のフラッシュメモリを用いて超低消費電力で推論を行うCiM(Computing in Memory)技術を開発中だ。GPUに比べ1000分の1ほどの消費電力で積和演算を実行できるという。2025年春ごろには試作チップができ上がる。 半導体メモリの地域別市場で2番目に大きくなった中国の現状
半導体メモリの地域別市場で2番目に大きくなった中国の現状
2025年8月に開催された「FMS(the Future of Memory and Storage)」の一般講演を紹介するシリーズ。Yole Groupのアナリストが中国のメモリ市場を解説した講演を取り上げる。 人工知能(AI)が牽引するHBM系DRAM市場
人工知能(AI)が牽引するHBM系DRAM市場
2025年8月に米国で開催された「FMS(the Future of Memory and Storage)」の講演を紹介する。今回は、TrendForceのシニアバイスプレジデントを務めるArvil Wu氏の講演概要を説明する。
Copyright © ITmedia, Inc. All Rights Reserved.
記事ランキング
- 「世界初」成果で1000層超3Dフラッシュに道筋、キオクシアとSandisk
- ソニー半導体、26年度は減収見込み メモリ市況不透明
- ソニーセミコンCTOに聞く――イメージセンサー技術革新の核
- 「膿み出し切った」SiC関連減損で過去最大1584億円赤字 ローム
- ペロブスカイト/CIGSタンデム太陽電池で「世界最高」効率達成、東京都市大ら
- 26年3月の世界半導体市場は79%増、日本も10カ月ぶりプラス成長
- パワー半導体3社連合とデンソー提携のアナログ「両軸を強化」 ローム社長
- ナフサ危機で迫る「レジスト供給途絶」――世界の半導体工場を停止させる、もう一つの臨界点
- DRAM不足で変わるAIシステム設計 エッジAIや特化型モデルに追い風
- 「画素の製造もパートナーと」十時氏が語る、ソニー×TSMC合弁の狙いと期待
