EE Times Japan >
テスト/計測 >
透過電子顕微鏡画像から結晶欠陥を容易に検出:産総研らが画像処理技術開発(2/2 ページ)
» 2017年09月26日 09時30分 公開
[馬本隆綱,EE Times Japan]
X軸格子は4倍に、Y軸格子は2.7倍にそれぞれ拡大
透過電子顕微鏡画像をフーリエ変換フィルタリング処理したX軸とY軸の格子像は、格子間隔が狭いためそのまま目視で転位を検出するのは難しい。そこで、サンプリングモアレ法を適用し、X軸格子とY軸格子のサンプリングモアレ縞の位相図を得た。この処理を行うことで、X軸格子は4倍に、Y軸格子は2.7倍にそれぞれ拡大され、転位を示すモアレ縞の終点や分岐点は明瞭となり、目視で確認できるようになったという。
転位分布図から、Y軸格子には多くの転位が見られた。GaN層では中心部の転位が少なく、保護層やAlGaN層との界面近くに多くの転位が存在している。AlGaN層では、均一に転位が分布しており、その密度は他の層より高いことが分かった。X軸格子の転位は、GaN層とAlGaN層の界面に集中していることなどが明らかとなった。
次世代半導体プロセスの改善に期待
今回の研究成果によって、広い領域の透過電子顕微鏡画像から、効率よく結晶欠陥を検出し、その分布を可視化することが可能となった。この技術を活用することで、次世代半導体デバイスの製造プロセスをさらに改善できるとみている。
関連記事
 産総研、リチウムイオン電池充放電機構を解明
産総研、リチウムイオン電池充放電機構を解明
産業技術総合研究所(産総研)の朝倉大輔主任研究員らは、軟X線発光分光を用いてリチウムイオン電池充放電機構を詳細に解析する手法を開発した。 産総研ら、STOを用いた人工ニューロンを開発
産総研ら、STOを用いた人工ニューロンを開発
産業技術総合研究所(産総研)の常木澄人研究員らによる研究グループは、スピントルク発振素子(STO)を用いた人工ニューロンを開発した。これを用いたニューロモロフィック回路音声認識システムの音声認識正答率は99.6%と高い。 産総研、加工用レーザーのパワーを高精度に制御
産総研、加工用レーザーのパワーを高精度に制御
産業技術総合研究所(産総研)の沼田孝之主任研究員は、機械加工や鋼板溶接などに用いる高出力レーザーのパワーを高精度に制御するシステムを開発した。この技術はレーザービームの形状制御にも応用できる。 産総研、「世界最高」の磁場中臨界電流密度実現
産総研、「世界最高」の磁場中臨界電流密度実現
産業技術総合研究所(産総研)は成蹊大学などと共同で、低コストの高温超電導線材を用いて、世界最高水準の磁場中臨界電流密度を実現した。 圧電性能を向上、RFスパッタ法でGaN薄膜作製
圧電性能を向上、RFスパッタ法でGaN薄膜作製
産業技術総合研究所(産総研)の上原雅人主任研究員らは村田製作所と共同で、RFスパッタ法を用いて、単結晶と同等の圧電性能を示すGaN(窒化ガリウム)薄膜を作製する方法を開発した。 MRAMの3次元積層プロセス技術を開発
MRAMの3次元積層プロセス技術を開発
産業技術総合研究所(産総研)の薬師寺啓研究チーム長らは、不揮発性磁気メモリー「MRAM」の大容量化、高性能化につながる3次元積層プロセス技術を開発した。
Copyright © ITmedia, Inc. All Rights Reserved.
Special ContentsPR
特別協賛PR
スポンサーからのお知らせPR
Special ContentsPR
Pickup ContentsPR
記事ランキング
- 「世界初」成果で1000層超3Dフラッシュに道筋、キオクシアとSandisk
- ソニー半導体、26年度は減収見込み メモリ市況不透明
- ナフサ危機で迫る「レジスト供給途絶」――世界の半導体工場を停止させる、もう一つの臨界点
- ペロブスカイト/CIGSタンデム太陽電池で「世界最高」効率達成、東京都市大ら
- 「画素の製造もパートナーと」十時氏が語る、ソニー×TSMC合弁の狙いと期待
- TSMCが次世代ロードマップ公表 A13/A12を29年投入へ
- DRAM不足で変わるAIシステム設計 エッジAIや特化型モデルに追い風
- ソニーセミコンとTSMCが合弁会社設立を検討
- 半導体検査装置向けレンズの研磨工程が稼働、生産能力2.6倍に
- 26年3月の世界半導体市場は79%増、日本も10カ月ぶりプラス成長
Special SitePR
あなたにおすすめの記事PR

 左はフーリエ変換フィルタリング処理から得られたX軸格子像、右はY軸格子像 出典:産総研
左はフーリエ変換フィルタリング処理から得られたX軸格子像、右はY軸格子像 出典:産総研 画像処理で得られたサンプリングモアレ縞の位相図。左はX軸格子、右はY軸格子 出典:産総研
画像処理で得られたサンプリングモアレ縞の位相図。左はX軸格子、右はY軸格子 出典:産総研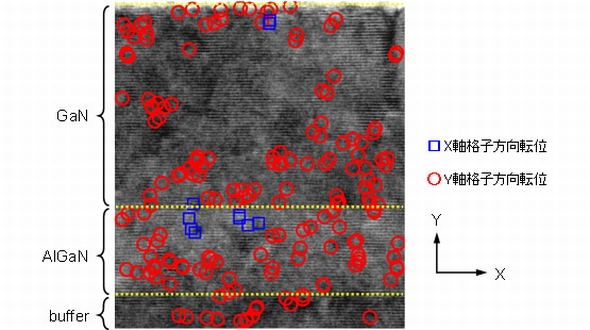 転位分布図 出典:産総研
転位分布図 出典:産総研