東大生研、大容量&低消費電力のFeFETを開発:IGZOと次世代機能性材料を融合
東京大学生産技術研究所は2019年6月10日、大容量で低消費電力な8nmの極薄IGZOチャネルを有するトランジスタ型強誘導体メモリ(FeFET)を開発した、と発表した。同所は、「IoTデバイスのエネルギー効率が飛躍的に向上し、より高度で充実したネットワーク、サービスの展開が期待される」としている。
IoTデバイスのエネルギー効率が飛躍的に向上
東京大学生産技術研究所は2019年6月10日、大容量で低消費電力な8nmの極薄IGZOチャネルを有するトランジスタ型強誘導体メモリ(以下、FeFET)を開発した、と発表した。同所は、「IoTデバイスのエネルギー効率が飛躍的に向上し、より高度で充実したネットワーク、サービスの展開が期待される」としている。
あらゆるものがインターネットにつながるIoT(モノのインターネット)の普及に向け、センサーや通信機能が備わったIoTデバイスは、低消費電力化が求めらている。そして、IoTデバイスの消費電力の多くを占めるリーク電力を削減するため、待機時の電力を抑えることができる低消費電力な不揮発性メモリの開発が重要となっている。
そうした中で、強誘電体をゲート絶縁膜とするFeFETは、低消費電力で大容量という特長があり、特に、集積回路作製プロセスと整合性が高く、10nm以下の膜厚でも強誘電性を示す強誘電体二酸化ハフニウム(HfO2)材料が開発されていることから、注目を集めているという。
しかし、シリコンをチャネルとする従来のFeFETデバイス構造では、ゲート絶縁膜とチャネルの間に誘電率の低い界面層が形成されるため、界面層に大きな電圧降下や界面層を通じた電荷トラップが起こり、低電圧動作と高信頼性動作を同時に実現することが困難だった。また、3次元積層構造にする場合にはチャネルは移動度の低いポリシリコンを用いる必要があるため、読み出し電流が小さく、アクセス時間が遅くなる懸念もあったという。
金属酸化物半導体IGZOをチャネルに
そこで、同所の准教授、小林正治氏らは今回、界面層の形成と電荷トラップの影響を抑制し、3次元積層構造でも高い読み出し電流を得るために、金属酸化物半導体IGZOをチャネルとする強誘電体HfO2ゲート絶縁膜FeFETを開発した。
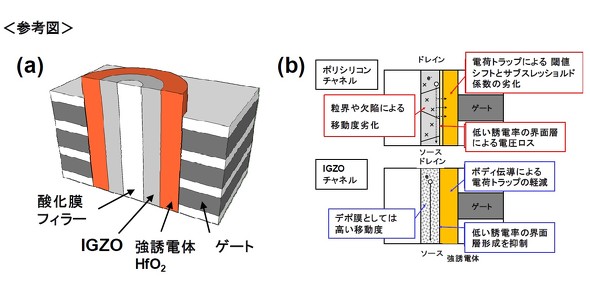 3次元積層型IGZOチャネル強誘電体HfO2FeFETの模式図(左)/ポリシリコンチャネルとIGZOチャネルのFeFETの特徴比較(右)IGZOチャネルを用いることで、界面層形成を抑制でき、電荷トラップを抑え、高移動度を実現できる。(クリックで拡大)出典:東京大学生産技術研究所
3次元積層型IGZOチャネル強誘電体HfO2FeFETの模式図(左)/ポリシリコンチャネルとIGZOチャネルのFeFETの特徴比較(右)IGZOチャネルを用いることで、界面層形成を抑制でき、電荷トラップを抑え、高移動度を実現できる。(クリックで拡大)出典:東京大学生産技術研究所このデバイス構造を用いると、IGZO自体が金属酸化膜のため、強誘電体HfO2との間で誘電率の低い界面層の形成を抑えることができるという。また、N型にドープされているIGZOをチャネルにすることで、キャリアの電荷トランプを抑制している。
ゲート電圧がゼロの時に電流が流れないようにするには、しきい値電圧を制御する必要があるため、IGZOの膜厚を10nm以下にしている。10nm以下の膜厚では、ポリシリコンの移動度は10cm2/Vs以下となるが、IGZOであれば10〜100cm2/Vsの高い移動度を維持することができるという。膜厚の適正化の結果、8nmが最適値となった。
電流伝達特性は電流のオンオフ比が5桁以上の良好な特性を示し、サブスレッショルド係数は60mV/dec、電界効果移動度は、同じ膜厚でのポリシリコンチャネルより50%以上高い、10cm2/Vs以上となっている。
小林氏らは今後、トップゲート型や積層型ゲート構造の開発、評価を行うほか、IoTやストレージクラスメモリへの応用のため、1.8V動作や書き換え速度の高速化、10年間のデータ保持、1012回の書き換え耐性、1〜10μAの読み出し電流を目指し、デバイス開発を行うという。
関連記事
 Siの限界を突破する! 3300V IGBTの5Vゲート駆動に成功
Siの限界を突破する! 3300V IGBTの5Vゲート駆動に成功
2019年5月、東京大学生産技術研究所の更屋拓哉助手、平本俊郎教授を中心とする研究グループは、耐圧3300VクラスのシリコンによるIGBT(絶縁ゲート型バイポーラトランジスタ)を、ゲート駆動電圧5Vで動作させることに成功したと発表。2019年5月28日に、東京都内で記者会見を開催し、開発技術の詳細を説明した。 室温で高速かつ高感度にテラヘルツ電磁波を検出
室温で高速かつ高感度にテラヘルツ電磁波を検出
東京大学生産技術研究所は、MEMS技術で作製した共振器構造を用い、室温環境で高速かつ高感度にテラヘルツ電磁波を検出できる素子を開発した。 航空電子と東大生研が連携研究協力協定を締結
航空電子と東大生研が連携研究協力協定を締結
東京大学生産技術研究所と日本航空電子工業は2019年3月22日、産学連携研究協力協定を締結したと発表した。同協定に基づき、両者は今後3年間にわたって、次世代モビリティ、IoT(モノのインターネット)社会の実現および、研究開発人材の育成を目的に包括的な共同研究を行う。 東京大学、熱の波動性を用いて熱伝導を制御
東京大学、熱の波動性を用いて熱伝導を制御
東京大学生産技術研究所の野村政宏准教授らは、熱の波動性を利用して、熱伝導を制御できることを初めて実証した。【訂正あり】 東京大学、固体中で特定方向への放熱に成功
東京大学、固体中で特定方向への放熱に成功
東京大学生産技術研究所の野村政宏准教授らは、固体中で熱流を一点に集中させる「集熱」に成功した。新たな熱制御方法として期待される。 鋼のように丈夫で薄い高弾性ガラス、東大が開発
鋼のように丈夫で薄い高弾性ガラス、東大が開発
東京大学生産技術研究所の助教を務める増野敦信氏らの研究チームは、無色透明でヤング率が160GPaという高弾性率ガラスの開発に成功した。薄くて丈夫な新素材として、電子回路基板、各種カバーガラスなどへの応用が期待される。
Copyright © ITmedia, Inc. All Rights Reserved.
記事ランキング
- 「世界初」成果で1000層超3Dフラッシュに道筋、キオクシアとSandisk
- ナフサ危機で迫る「レジスト供給途絶」――世界の半導体工場を停止させる、もう一つの臨界点
- 次世代パワー半導体 「期待の5材料」の現在地
- パワー半導体世界市場、2035年は7兆円超え 酸化ガリウムも一定規模に
- 入学した瞬間終わったわ――「講義が英語」なんて一言も聞いてない!
- TSMCが次世代ロードマップ公表 A13/A12を29年投入へ
- SK hynixの四半期決算、驚異の売上高営業利益率70%超え
- 「データの死蔵に耐えられないエンジニア」がたどり着いたMASの沼
- TED、25年度は減収減益 「各事業磨き上げる」と新社長
- 村田製作所、25年度は売上高が過去最高 データセンター向けは70%増