裏面電源供給がブレークする予感、そしてDRAMも3次元化に加速 〜VLSI2023:湯之上隆のナノフォーカス(64)(6/7 ページ)
Samsungの236層3D NAND
Samsungが、“Novel Strategies for Highly Uniform and Reliable Cell Characteristics of 8th Generation 1Tb 3D-NAND Flash Memory”(論文番号T3-1)という題目で、236層の3D NANDについて発表した(図12)。
 図12[クリックで拡大] 出所:Changhwan Lee et al. (Samsung) “Novel Strategies for Highly Uniform and Reliable Cell Characteristics of 8th Generation 1Tb 3D-NAND Flash Memory”, 2023 Symposium on VLSI Technology and Circuits Digest of Technical Papers, T3-1
図12[クリックで拡大] 出所:Changhwan Lee et al. (Samsung) “Novel Strategies for Highly Uniform and Reliable Cell Characteristics of 8th Generation 1Tb 3D-NAND Flash Memory”, 2023 Symposium on VLSI Technology and Circuits Digest of Technical Papers, T3-1Samsungは、第4世代(64層)、第5世代(92層)、第6世代(128層)、第7世代(176層)、第8世代(236層)と、3D NANDの積層数を増やしてきた。その際、Fig.1に示したように、毎世代、縦方向のセルピッチを縮小した。また、第6世代から第7世代に進む際に、横方向のセルピッチを7%縮小した。
従って、今回発表した第8世代の236層を製造するに当たっては、第7世代(176層)と比べて、横方向のセルピッチは同じだが、縦方向には7%縮小したセルを形成する必要があった。
そして、微細なセル用の深いメモリホールの高アスペクト比(High Aspect Ratio、HAR)エッチングにおいては、アスペクト比の増大とともに、その困難さが指数関数的に難しくなることをFig.2は示している。ところが、“Advanced Etching”によって、その困難さが一気に低下していることが分かる。では、この“Advanced Etching”とは一体何か?
Samsungは発表の中で何も述べなかったが、その正体はウエハーを極低温(Cryo)に冷却するエッチングだと思われる。そして、その温度は−40℃(もしかしたら−60〜80℃)と推測している。つまり、Samsungは、極低温エッチング技術を用いることにより、高速で、高精度なHARエッチングを実現したと考えられる。
この極低温エッチング技術により、メモリホールのHARエッチング後の孔のプロファイルが明らかに向上した(Fig.3)。その結果、第7世代に比べて、第8世代では、ワードラインの閾値電圧(Vth)のばらつきが17%改善された(Fig.4)。さらに、第7世代では、プログラム速度などの情報のWLのセル特性劣化が48%だったが、第8世代では16%の劣化に改善された(Fig.6)。
要するにSamsungは、極低温エッチング技術を、メモリセルのHARエッチングに適用することにより、176層の第7世代よりも、セル特性が良好な236層の第8世代を開発したというわけである。
そして、メモリホール用のHARエッチングはさらなる進化を遂げそうである。以下で説明する。
東京エレクトロン(TEL)が発見した新しい絶縁膜エッチング
通常、VLSIシンポジウムでは、新しいデバイスを考案し、それを試作して、そのデバイス特性を明らかにした内容の論文が採択される。ところが、TELの発表“Beyond 10 μm Depth Ultra-High Speed Etch Process with 84% Lower Carbon Footprint for Memory Channel Hole of 3D NAND Flash over 400 Layers”(論文番号T3-2)は、「3D NANDのメモリホール用のHARエッチングを行った」というだけの内容で論文が採択された。これは極めて異例なことである。
しかし、そのHARエッチングは、ドライエッチングの歴史に残るほど、優れた業績だと筆者は評価している。では、TELのHARエッチングは、どこが秀逸なのか?
筆者は1987年に日立製作所に入社して、半導体のドライエッチング技術者になった。その頃から、SiO2などの絶縁膜のエッチングにはCF系のガスが使われてきた。具体的に言うと、CF4、CHF3、C4F8、C4F6、CH2F2などである。これらのガスによるプラズマから発生するCF系の反応種(ラジカル)が、SiO2のエッチングに有効だからだ(例えば、『最大の半導体製造装置市場となった「ドライエッチング」とは』の図5などを参照ください)。
要するに、40年以上の長期間にわたって、絶縁膜エッチングにはCF系のガスが使われてきた。そのような中で、TELは、HF+PF3という新たなガス系を発見した。そして、このガス系と極低温(発表では−60℃)を組み合わせることにより、3D NANDのメモリホール用の高速エッチングを実現したのである。
HF/PF3+Cryoエッチングの実力
TELは、Fig.3で、従来のCF系プラズマを使った場合と、今回のHF/PF3+Cryoの場合のエッチングのモデルを示している(図13)。CF系プラズマでは、CF系のポリマーが孔の側壁などに分厚く堆積する。このポリマーは横方向へのエッチング(ボーイングと呼ぶ)を防止するが、孔が深くなるほど、孔底に到達するCFラジカルが減少し、孔のエッチング速度が極端に低下する。
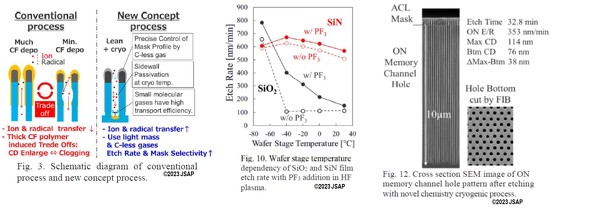 図13[クリックで拡大] 出所:Yoshihide Kihara et al. (TEL) “Beyond 10 μm Depth Ultra-High Speed Etch Process with 84% Lower Carbon Footprint for Memory Channel Hole of 3D NAND Flash over 400 Layers”, 2023 Symposium on VLSI Technology and Circuits Digest of Technical Papers, T3-2
図13[クリックで拡大] 出所:Yoshihide Kihara et al. (TEL) “Beyond 10 μm Depth Ultra-High Speed Etch Process with 84% Lower Carbon Footprint for Memory Channel Hole of 3D NAND Flash over 400 Layers”, 2023 Symposium on VLSI Technology and Circuits Digest of Technical Papers, T3-2これらの対策のために、ウエハーの温度を上げるなどして、CF系のポリマーが孔の側壁に堆積しにくい条件にすると、孔の横方向へのエッチングが進行し、ボーイングが発生してしまう。要するに、孔底へのCF系ラジカルの輸送とボーイングの防止はトレードオフの関係にあるため、最適化することが難しい。
ところが、HF/PF3+Cryoの場合では、孔の側壁への堆積が非常に少ない。すなわち、反応種のHFは側壁にあまり“食われず“に孔底に供給される。そして、孔の側壁への堆積が少なくてもボーイングを防止できる。その結果、ボーイングなしで、高速なHARエッチングが可能となるわけだ。
Fig.10をみると、SiNのエッチング速度は、温度であまり変わらないし、PF3を添加してもしなくても、あまり変化はない。一方、SiO2は、低温にするほどエッチング速度が上がる。また、PF3を添加すると、より高速なエッチングが可能になる。今回の発表では、マイナス60℃で実験を行ったが、−80〜100℃と、さらに低温化できれば、もっと高速にエッチングができる可能性がある。
最終結果をFig.12に示す。SiO2とSiNの積層膜10μmを、HF/PF3+Cryo(−60℃)の条件で、32.8分でエッチングできた。エッチング速度は353nm/min、孔の最大のCDは114nmで、最小のCDは76nmだった。
今回のTELの発表の功績は、新しいガス系(HF/PF3)と極低温(−60℃)を組み合わせることにより、3D NANDのメモリホールに使用可能なHARエッチングを実現したことにある。今まで、HARエッチングの分野は米Lam Researchが独占してきたが、今後はTELが大きく成長する可能性がある。
Copyright © ITmedia, Inc. All Rights Reserved.
記事ランキング
- ナフサ危機で迫る「レジスト供給途絶」――世界の半導体工場を停止させる、もう一つの臨界点
- TSMCが次世代ロードマップ公表 A13/A12を29年投入へ
- 入学した瞬間終わったわ――「講義が英語」なんて一言も聞いてない!
- 最新ノートPC5機種を分解 新旧MacBook Proの中身の違いは?
- 「装置は動くがプロセスが成立しない」――He供給危機とナフサ不足の本質
- 「世界初」成果で1000層超3Dフラッシュに道筋、キオクシアとSandisk
- He/ナフサ供給危機で工場新設も遅延? 装置/チップメーカーへの波及経路を探る
- 次世代パワー半導体 「期待の5材料」の現在地
- ローム・東芝・三菱電機のパワー半導体はどうなるか
- Apple新CEOはエンジニア出身 製品開発重視への回帰か
