解像力200nmのX線イメージング検出器を開発:解像力の理論限界に迫る
高輝度光科学研究センター(JASRI)と理化学研究所、神島化学工業らの研究グループは、200nmの解像力を持つ「高解像度X線イメージング検出器」の開発に成功した。
産業用X線撮像装置への適用に期待
高輝度光科学研究センター(JASRI)と理化学研究所、神島化学工業らの研究グループは2019年3月、200nmの解像力を持つ「高解像度X線イメージング検出器」の開発に成功したことを発表した。半導体デバイスの微細な内部配線を非破壊で検査することが可能となる。
今回の研究成果は、JASRI計測技術開発チームの亀島敬研究員(理化学研究所放射光科学研究センターデータ処理系開発チーム客員研究員)、理化学研究所放射光科学研究センターデータ処理系開発チームの初井宇記チームリーダーおよび、神島化学工業セラミックグループの柳谷高公グループマネジャーと村松克洋チームリーダーらによるものである。
高い解像度のX線画像を得たい場合には、薄膜のシンチレーターでX線を可視光に変換したあと、レンズを用いて拡大し撮像をする手法が用いられている。ただし従来手法だと、X線によるイメージング検出の解像力は、約500nmが限界といわれてきた。
研究グループは、最新の透明セラミックス技術を用いて、膜厚が5μmで接合層の無い透明なシンチレーターを開発、光学特性を大きく改善した。透明セラミックスは空孔を除去し、結晶粒界を蛍光波長よりも十分に小さく抑えた。これにより、単結晶とほぼ同じ透明性を得ることができた。さらに、焼結現象を利用した固相拡散接合により直接接合を行い、これまでの課題であった光の散乱や反射の問題を解決した。
具体的な工程はこうだ。不純物Ceを添加しシンチレーターとして活性化したLu3Al5O12:Ce(LuAG:Ce)セラミックスと、支持基板のLu3Al5O12(LuAG)セラミックスを接合する。LuAG:Ceシンチレーター層は研磨して薄くすることもできる。LuAG:CeとLuAGは屈折率差が0.1%以下のため、接合面で光の反射はほとんど生じないという。仕上げは、基板両面に光学コーティングを行った。
 上図は開発した薄膜シンチレーターの製法と、開発した透明LuAG:Ce/LuAG複合セラミックスの接合面付近の電子顕微鏡像。下図は開発した薄膜シンチレーターとX線イメージング検出器の写真 出典:JASRI他
上図は開発した薄膜シンチレーターの製法と、開発した透明LuAG:Ce/LuAG複合セラミックスの接合面付近の電子顕微鏡像。下図は開発した薄膜シンチレーターとX線イメージング検出器の写真 出典:JASRI他開発した技術を用いて、200nmプロセスで製造された半導体デバイスの内部配線などについて撮像をした。この結果、最小線幅300nmのアルミ配線やタングステン貫通電極が埋め込まれていることを可視化することに成功したという。
今回開発した高い解像力を持つX線イメージング検出器は、産業用X線撮像装置への適用も可能である。微細加工技術を適用して製造された電子デバイスなどを、非破壊で容易に検査することができるという。
関連記事
 理研ら、シリコン量子ビットの高温動作に成功
理研ら、シリコン量子ビットの高温動作に成功
理化学研究所(理研)や産業技術総合研究所(産総研)らの共同研究グループは2019年1月、シリコン量子ビットを最高温度10K(約−263℃)で動作させることに成功した。 外部磁場がなくても磁気渦を生成、理研らが発見
外部磁場がなくても磁気渦を生成、理研らが発見
理化学研究所(理研)らによる国際共同研究グループは、磁気渦の新しい生成機構を発見した。磁気渦を情報担体とする磁気記憶素子の実現につながる研究成果と期待されている。 理研、パルス電流で超電導状態の制御に成功
理研、パルス電流で超電導状態の制御に成功
理化学研究所(理研)の研究チームは、パルス電流を用いて「超電導状態」の生成と消去に成功した。書き換え可能な超電導量子コンピュータ向け回路の実現につながる可能性が高い。 長期間、皮膚に貼り付けて心電計測が可能に
長期間、皮膚に貼り付けて心電計測が可能に
理化学研究所(理研)は、極めて薄い有機太陽電池で駆動する「皮膚貼り付け型の心電計測デバイス」を開発した。 正データと正信頼度の情報だけで分類境界を学習
正データと正信頼度の情報だけで分類境界を学習
理化学研究所(理研)の研究チームは、人工知能(AI)を用いた機械学習の分類問題で、正のデータとその信頼度(正信頼度)情報だけで、分類境界を学習できる手法を開発した。 量子ビットの高精度制御と高速読み出しを両立
量子ビットの高精度制御と高速読み出しを両立
理化学研究所(理研)らの国際共同研究グループは、高精度制御に適した「スピン1/2量子ビット」と高速読み出しに適した「ST量子ビット」を結合させ、両方式の互換性を確保することに成功した。
Copyright © ITmedia, Inc. All Rights Reserved.
記事ランキング
- 「世界初」成果で1000層超3Dフラッシュに道筋、キオクシアとSandisk
- ナフサ危機で迫る「レジスト供給途絶」――世界の半導体工場を停止させる、もう一つの臨界点
- 次世代パワー半導体 「期待の5材料」の現在地
- 入学した瞬間終わったわ――「講義が英語」なんて一言も聞いてない!
- パワー半導体世界市場、2035年は7兆円超え 酸化ガリウムも一定規模に
- SK hynixの四半期決算、驚異の売上高営業利益率70%超え
- 「データの死蔵に耐えられないエンジニア」がたどり着いたMASの沼
- TSMCが次世代ロードマップ公表 A13/A12を29年投入へ
- 村田製作所、25年度は売上高が過去最高 データセンター向けは70%増
- パワー停滞も光デバイス堅調、三菱電機の半導体部門

 撮像をしたしま形状試料のX線画像。上図の左は線幅が200nm、中央は400nm、右は600nmのパターン。下図は、上から順に各線幅の射影データ 出典:JASRI他
撮像をしたしま形状試料のX線画像。上図の左は線幅が200nm、中央は400nm、右は600nmのパターン。下図は、上から順に各線幅の射影データ 出典:JASRI他
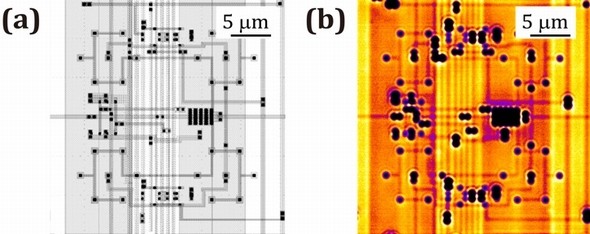 左は半導体デバイスの設計図、右は設計図に基づき製造した素子のX線透過像 出典:JASRI他
左は半導体デバイスの設計図、右は設計図に基づき製造した素子のX線透過像 出典:JASRI他