3nm以降のCMOSロジックを支える多層配線技術:福田昭のデバイス通信(318) imecが語る3nm以降のCMOS技術(21)(2/2 ページ)
微細化限界が近づく銅(Cu)の多層配線
最近のCMOSロジックを支える多層配線技術は、銅(Cu)配線である(参考記事:「オンチップの相互接続技術を過去から将来まで概観」)。製造プロセスとしてはダマシン技術(絶縁膜をエッチングして溝に金属をメッキする技術)とCMP技術(平坦化技術)を駆使する。
銅(Cu)配線の欠点は、微細化によって配線抵抗が急激に増加することだ。Cu原子は周囲に拡散しやすいので、拡散を防ぐバリア層をCu金属層と絶縁膜の境界に成膜する。このバリア層は電気抵抗が高く、さらには薄くしづらい。このため、Cu配線層の断面寸法を縮小すると、バリア層(高抵抗層)の比率が増えてしまう(参考記事:「銅(Cu)配線の微細化と抵抗値の増大」)。
微細化による電気抵抗の増大を緩和する方法は2つある。1つは、Cu配線層を高くすること。もう1つは、配線金属をバリア層が不要な材料に変更することである。imecは講演で主に、配線金属をCuからルテニウム(Ru)に変更する試みを述べていた。
現行のリソグラフィ技術でも、2nm以下の技術世代に相当する、16nmという非常に狭いピッチの平行配線パターンを形成できる。ArFの液浸露光技術と、マルチパターニング技術を組み合わせる。マルチパターニング技術は、SAOP(自己整合8回パターニング)を選択する。これらの要素技術によってimecは2018年に、16nmピッチの平行配線パターンを試作発表済みだ。
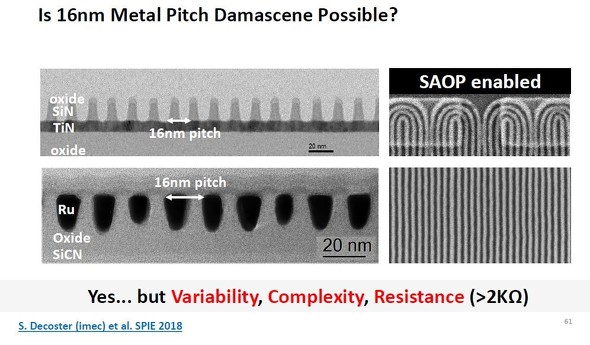 16nmと狭いピッチの平行配線パターンを形成した断面の電子顕微鏡観察像。出典:imec(IEDM2020のチュートリアル講演「Innovative technology elements to enable CMOS scaling in 3nm and beyond - device architectures, parasitics and materials」の配布資料)
16nmと狭いピッチの平行配線パターンを形成した断面の電子顕微鏡観察像。出典:imec(IEDM2020のチュートリアル講演「Innovative technology elements to enable CMOS scaling in 3nm and beyond - device architectures, parasitics and materials」の配布資料)ただし、試作した平行配線パターンは実用的とは言い難い。SAOPは製造のスループットを著しく低下させる。また配線寸法のばらつきが大きく、抵抗値と容量値が配線ごとに大きく変化する。さらには配線抵抗そのものが高い。これらの課題を解決する必要がある。
(次回に続く)
⇒「福田昭のデバイス通信」連載バックナンバー一覧
関連記事
 ルネサス、供給確保で21年7〜9月期売上高2400億円目指す
ルネサス、供給確保で21年7〜9月期売上高2400億円目指す
ルネサス エレクトロニクスは2021年7月29日、2021年12月期第2四半期(4〜6月)業績(Non-GAAPベース)を発表した。第2四半期3カ月間の売上高は2179億円で前年同期比30.7%増、営業利益は614億円で同2.03倍と大幅な増収増益になった。売上総利益率は52.0%、営業利益率は28.2%だった。 高層化の継続で、製造コストを爆下げする3D NANDフラッシュ
高層化の継続で、製造コストを爆下げする3D NANDフラッシュ
今回からは、半導体メモリのアナリストであるMark Webb氏の「Flash Memory Technologies and Costs Through 2025(フラッシュメモリの技術とコストを2025年まで展望する)」と題する講演の概要をご紹介する。 埋め込みDRAMが大容量キャッシュの製造コスト低減に貢献
埋め込みDRAMが大容量キャッシュの製造コスト低減に貢献
今回はDRAMをロジックLSIに埋め込む技術「eDRAM」の製品化事例を解説する。 前進し続けるIntel
前進し続けるIntel
Intelは2021年1月21日(米国時間)、業績発表を行った。それを見ると、同社の“終末時計”のカウントダウンに、少なくとも数秒は追加されたといえるだろう。ただし、完全に楽観視できるわけではなさそうだ。スピンドクター(情報操作が得意な人)たちは、Intelの2020年の業績のマイナス面だけを簡単に強調することができる。また、プラス面よりも欠点の方に反応を示す投資家たちもいる。 HDD大手Western Digitalの業績、前年同期比の営業利益が3四半期連続で増加
HDD大手Western Digitalの業績、前年同期比の営業利益が3四半期連続で増加
今回は、米Western Digitalの2021会計年度第1四半期の業績を紹介する。 新材料で次々世代を狙う「強誘電体メモリ(FeRAM)」
新材料で次々世代を狙う「強誘電体メモリ(FeRAM)」
今回は「強誘電体メモリ(FeRAM)」を取り上げる。FeRAMの記憶原理と、60年以上に及ぶ開発の歴史を紹介しよう。
Copyright © ITmedia, Inc. All Rights Reserved.
記事ランキング
- 「世界初」成果で1000層超3Dフラッシュに道筋、キオクシアとSandisk
- ナフサ危機で迫る「レジスト供給途絶」――世界の半導体工場を停止させる、もう一つの臨界点
- 次世代パワー半導体 「期待の5材料」の現在地
- パワー半導体世界市場、2035年は7兆円超え 酸化ガリウムも一定規模に
- 入学した瞬間終わったわ――「講義が英語」なんて一言も聞いてない!
- TSMCが次世代ロードマップ公表 A13/A12を29年投入へ
- SK hynixの四半期決算、驚異の売上高営業利益率70%超え
- 「データの死蔵に耐えられないエンジニア」がたどり着いたMASの沼
- TED、25年度は減収減益 「各事業磨き上げる」と新社長
- 村田製作所、25年度は売上高が過去最高 データセンター向けは70%増
