日本電子、集束イオンビーム加工観察装置を開発:TEMなどの観察試料を自動作製
日本電子は、集束イオンビーム加工観察装置(FIB)「JIB-4000PLUS」を開発し、販売を始めた。TEM(透過電子顕微鏡)などで行う試料観察に必要な、前処理の作業効率を高めることが可能となる。
ハイパワーFIBカラム、オプションで最大90nAまで対応
日本電子は2019年1月、集束イオンビーム加工観察装置(FIB)「JIB-4000PLUS」を開発し、販売を始めると発表した。TEM(透過電子顕微鏡)などで行う試料観察に必要となる前処理を自動化でき、作業効率をさらに高めることが可能となる。
材料のナノスケール組織制御やパワー半導体、CMOSセンサーの開発、製造工程では、SEM(走査電子顕微鏡)やTEM(透過電子顕微鏡)、STEM(走査透過電子顕微鏡)などを用いて、作製した試料の表面や内部の観察を行う。このための前処理にFIBが利用される。
FIBは、加速したGaイオンビームを集束させて試料に照射することで、試料表面のSIM(走査イオン顕微鏡)像を観察したり、ミリング加工、カーボンやタングステンなどのデポジションを行ったりすることができる。ただ、現行の装置だと、前処理には高度なスキルを必要とし、加工に時間がかかるなど、課題もあった。
JIB-4000PLUSは、これらの課題を解決した。その1つが新たに開発した自動TEM試料作製機能「STEMPLING」(オプション)である。STEMPLINGを搭載することで、複数のSEM、TEM、STEM観察に必要な試料を無人で、連続的に自動作製することが可能になるという。この機能によって、作業者の高度なスキルは必要なくなり、夜間などに大量の試料を作製することができる。
もう1つはハイパワーFIBカラムを採用したことである。イオンビームの最大電流値は標準仕様で60nA(30kV時)だが、オプションにより最大電流値を90nA(30kV時)まで拡張することができる。これによって試料作製の時間短縮や、直径100μmを超える広い領域への対応を可能にした。
さらに、三次元観察を行うための連続スライス断面観察機能を標準で搭載した。この結果、シングルビームFIBでありながら、SIM像による三次元観察を可能とした。オプションの三次元再構築ソフトウェアを活用すると、収集した断面画像を三次元画像に再構築することができる。
この他、回路修正などに有用なCADナビゲーションシステムや、特殊形状の加工に有用なベクタースキャンシステムなど、さまざまな用途に適用できるアッタッチメントを用意した。また、FIB加工とTEM観察の繰り返し作業を容易にするため、標準装備のバルク試料モーターステージに、TEM用のチップオンホルダーを直接挿入できるサイドエントリーゴニオメーターステージを追加することが可能である。
JIB-4000PLUSは加速電圧が1〜30kV、倍率は200〜30万倍(視野探し時は60倍)、像分解能は5nm(30kV時)。最大試料サイズは外形28mm(高さ13mm)と外形50mm(高さ2mm)である。本体標準価格は4600万円より。同社は年間20台の販売を見込む。
関連記事
 ミニマルファブ、半導体チップの試作も活発に
ミニマルファブ、半導体チップの試作も活発に
ミニマルファブ推進機構は、「SEMICON Japan 2018」で、「ミニマルファブ、先端へ」をキャッチフレーズに、新開発のミニマルファブ向け製造装置や、ミニマルファブ装置で製作した実チップなどを展示した。 「飲む体温計」、胃酸で発電し睡眠中に体温測定
「飲む体温計」、胃酸で発電し睡眠中に体温測定
東北大学の中村力研究室と慶應義塾大学の仰木裕嗣研究室は、「SEMICON Japan 2018」で、錠剤型の「飲む体温計」を展示した。胃酸で発電したエネルギーで動作し、睡眠中に基礎体温(深部体温)を測定できる。 BLE機能も内蔵したマウスピース型センサー
BLE機能も内蔵したマウスピース型センサー
東京医科歯科大学は、「SEMICON Japan 2018」で、歯科医療用のマウスピースに、口腔温や咬合力を測定するセンサーやBLE(Bluetooth Low Energy)無線機能を組み込んだウェアラブルセンサーを紹介した。 ディスコ、「切る、削る、磨く」工程の効率向上へ
ディスコ、「切る、削る、磨く」工程の効率向上へ
ディスコは、「SEMICON Japan 2018」で、後工程の自動化、作業効率の改善に向けた「並列加工搬送システムver.2」や、スマートフォンで「精密加工装置を監視、制御できるシステム」などを提案した。 「テクノロジーで人体の限界を超える」 SEMICON講演
「テクノロジーで人体の限界を超える」 SEMICON講演
「SEMICON Japan 2018」では、「テクノロジーと身体の未来」をテーマにした「みらいビジョン フォーラム」が開催され、ロボットの開発などを手掛ける講演者たちが、テクノロジーとサイエンスをいかに活用して、未来の社会を実現するかについて語った。 SEMICON Japan、2013年以降最大規模で開催へ
SEMICON Japan、2013年以降最大規模で開催へ
SEMIジャパンは2018年12月11日に記者会見を開催し、同月12日から始まるエレクトロニクス製造サプライチェーンの国際展示会「SEMICON Japan 2018」の概要を説明した。
Copyright © ITmedia, Inc. All Rights Reserved.
記事ランキング
- ナフサ危機で迫る「レジスト供給途絶」――世界の半導体工場を停止させる、もう一つの臨界点
- TSMCが次世代ロードマップ公表 A13/A12を29年投入へ
- 最新ノートPC5機種を分解 新旧MacBook Proの中身の違いは?
- 「装置は動くがプロセスが成立しない」――He供給危機とナフサ不足の本質
- He/ナフサ供給危機で工場新設も遅延? 装置/チップメーカーへの波及経路を探る
- Apple新CEOはエンジニア出身 製品開発重視への回帰か
- ローム・東芝・三菱電機のパワー半導体はどうなるか
- ルネサス26年1Qは増収増益 車載/AI好調で「足元は当面強い」
- 「Rapidusの隣」に光電融合パッケージ開発拠点、28年度の完成目指す
- 「3社のパワー半導体事業を切り出し合弁設立したい」三菱電機社長

 JIB-4000PLUSの外観
JIB-4000PLUSの外観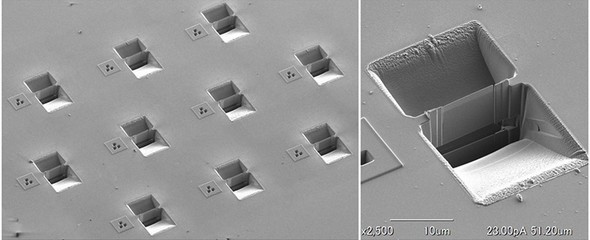 STEMPLINGによる加工例(試料はシリコンウエハー) 出典:日本電子
STEMPLINGによる加工例(試料はシリコンウエハー) 出典:日本電子 100μm径はんだバンプの断面試料作製と断面観察の例 出典:日本電子
100μm径はんだバンプの断面試料作製と断面観察の例 出典:日本電子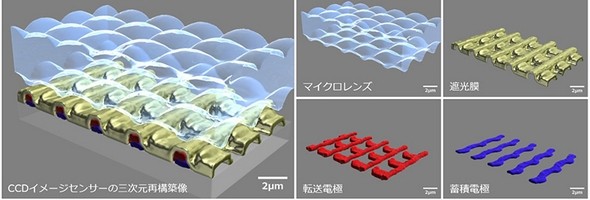 CCDイメージセンサーの断面画像を三次元画像に再構築した例 出典:日本電子
CCDイメージセンサーの断面画像を三次元画像に再構築した例 出典:日本電子