EE Times Japan >
LSI >
電源供給配線網(PDN)をシリコンダイの裏面に配置して電源をさらに安定化:福田昭のデバイス通信(302) imecが語る3nm以降のCMOS技術(5)(2/2 ページ)
» 2021年06月17日 11時30分 公開
[福田昭,EE Times Japan]
BPRとBS-PDNの組み合わせが電源雑音を45%低減
埋め込み電源線(BPR)と裏面の電源供給配線網(BS-PDN)を製造する工程は、かなり複雑だ。微細なTSV(μTSVあるはnTSV)によってBPRとBS-PDNを接続するとともに、シリコンウエハー裏面に金属配線を形成する工程が必要である。
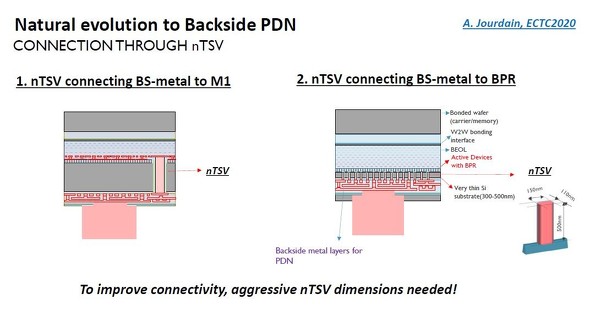 微小なTSV(nano-TSV(nTSV))を介した裏面側配線と表面側配線の接続構造例。左は一般的な接続構造。右は裏面側配線(電源供給配線網(PDN))と埋め込み電源線(BPR)をnTSVで接続した構造。出典:imec(IEDM2020のチュートリアル講演「Innovative technology elements to enable CMOS scaling in 3nm and beyond - device architectures, parasitics and materials」の配布資料) (クリックで拡大)
微小なTSV(nano-TSV(nTSV))を介した裏面側配線と表面側配線の接続構造例。左は一般的な接続構造。右は裏面側配線(電源供給配線網(PDN))と埋め込み電源線(BPR)をnTSVで接続した構造。出典:imec(IEDM2020のチュートリアル講演「Innovative technology elements to enable CMOS scaling in 3nm and beyond - device architectures, parasitics and materials」の配布資料) (クリックで拡大)例えば、BPRを形成済みのシリコンウエハー(1stウエハー)を、別のシリコンウエハー(2ndウエハー)に貼り合わせる。それから1stウエハーを研削し、さらにはエッチングによって10μm前後にまで薄くする。
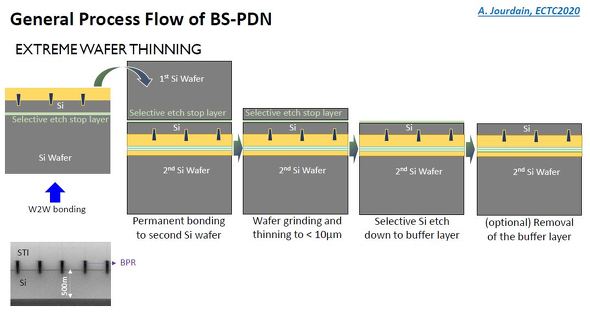 裏面側に電源供給配線網(BS-PDN)を製造する工程(前半)。出典:imec(IEDM2020のチュートリアル講演「Innovative technology elements to enable CMOS scaling in 3nm and beyond - device architectures, parasitics and materials」の配布資料) (クリックで拡大)
裏面側に電源供給配線網(BS-PDN)を製造する工程(前半)。出典:imec(IEDM2020のチュートリアル講演「Innovative technology elements to enable CMOS scaling in 3nm and beyond - device architectures, parasitics and materials」の配布資料) (クリックで拡大)それからBPRと接続するnTSVを形成する。nTSVの埋め込み金属は銅(Cu)である。nTSVを形成後に、シングルダマシンプロセスによってCu配線層のBS-PDNを製造する。
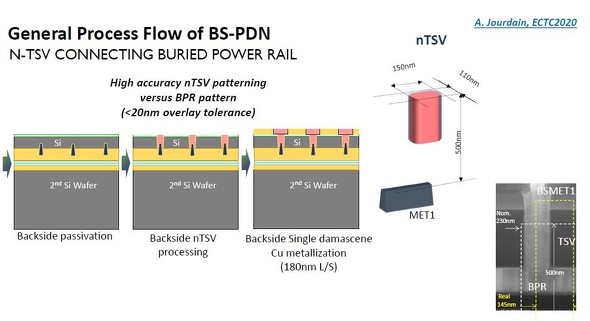 裏面側に電源供給配線網(BS-PDN)を製造する工程(後半)。出典:imec(IEDM2020のチュートリアル講演「Innovative technology elements to enable CMOS scaling in 3nm and beyond - device architectures, parasitics and materials」の配布資料) (クリックで拡大)
裏面側に電源供給配線網(BS-PDN)を製造する工程(後半)。出典:imec(IEDM2020のチュートリアル講演「Innovative technology elements to enable CMOS scaling in 3nm and beyond - device architectures, parasitics and materials」の配布資料) (クリックで拡大)CMOSロジックの基本セル(スタンダードセル)でBPRおよびBS-PDNの効果を評価してみた。6トラック(6T)の基本セル(BPRなし、FS-PDN)を基準にすると、BPRを導入した5トラック(5T)の基本セル(FS-PDN)は回路ブロックの面積が19%減少し、電源電圧降下が45mVから35mVに減少した。ここでBS-PDNを追加すると回路ブロックの面積は変わらないものの、電源電圧降下は25mVとさらに低下した。6Tセルに比べ、電源電圧の変動を約45%に抑えられる。
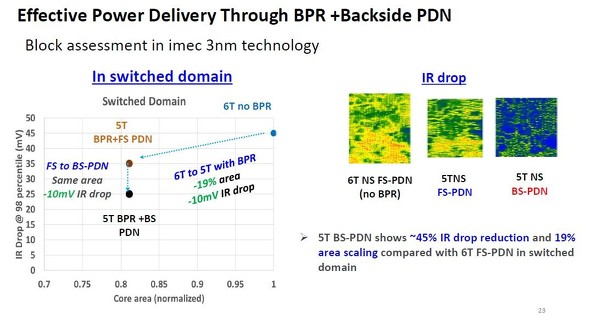 BPRとBS-PDNの効果。左は回路ブロック(コア)の面積と電源電圧降下の関係。右は回路ブロックの温度分布(IRドロップの大きさを反映)。出典:imec(IEDM2020のチュートリアル講演「Innovative technology elements to enable CMOS scaling in 3nm and beyond - device architectures, parasitics and materials」の配布資料)
BPRとBS-PDNの効果。左は回路ブロック(コア)の面積と電源電圧降下の関係。右は回路ブロックの温度分布(IRドロップの大きさを反映)。出典:imec(IEDM2020のチュートリアル講演「Innovative technology elements to enable CMOS scaling in 3nm and beyond - device architectures, parasitics and materials」の配布資料)(次回に続く)
⇒「福田昭のデバイス通信」連載バックナンバー一覧
関連記事
 埋め込み電源配線の構造と材料選択
埋め込み電源配線の構造と材料選択
今回は、BPR(Buried Power Rail)の複雑な構造を説明する略語を定義するとともに、金属材料の候補を解説する。 埋め込みDRAMが大容量キャッシュの製造コスト低減に貢献
埋め込みDRAMが大容量キャッシュの製造コスト低減に貢献
今回はDRAMをロジックLSIに埋め込む技術「eDRAM」の製品化事例を解説する。 高層化の継続で、製造コストを爆下げする3D NANDフラッシュ
高層化の継続で、製造コストを爆下げする3D NANDフラッシュ
今回からは、半導体メモリのアナリストであるMark Webb氏の「Flash Memory Technologies and Costs Through 2025(フラッシュメモリの技術とコストを2025年まで展望する)」と題する講演の概要をご紹介する。 ソニーが20年度通期業績を上方修正、CMOSセンサーも想定上回る
ソニーが20年度通期業績を上方修正、CMOSセンサーも想定上回る
ソニーは2021年2月3日、2021年3月期(2020年度)第3四半期(2020年10〜12月期)決算を発表するとともに、2020年度通期業績予想を上方修正した。 前進し続けるIntel
前進し続けるIntel
Intelは2021年1月21日(米国時間)、業績発表を行った。それを見ると、同社の“終末時計”のカウントダウンに、少なくとも数秒は追加されたといえるだろう。ただし、完全に楽観視できるわけではなさそうだ。スピンドクター(情報操作が得意な人)たちは、Intelの2020年の業績のマイナス面だけを簡単に強調することができる。また、プラス面よりも欠点の方に反応を示す投資家たちもいる。 HDD大手Western Digitalの業績、前年同期比の営業利益が3四半期連続で増加
HDD大手Western Digitalの業績、前年同期比の営業利益が3四半期連続で増加
今回は、米Western Digitalの2021会計年度第1四半期の業績を紹介する。
Copyright © ITmedia, Inc. All Rights Reserved.
Special ContentsPR
特別協賛PR
スポンサーからのお知らせPR
Special ContentsPR
Pickup ContentsPR
記事ランキング
- 「世界初」成果で1000層超3Dフラッシュに道筋、キオクシアとSandisk
- ソニー半導体、26年度は減収見込み メモリ市況不透明
- ナフサ危機で迫る「レジスト供給途絶」――世界の半導体工場を停止させる、もう一つの臨界点
- ペロブスカイト/CIGSタンデム太陽電池で「世界最高」効率達成、東京都市大ら
- 「画素の製造もパートナーと」十時氏が語る、ソニー×TSMC合弁の狙いと期待
- TSMCが次世代ロードマップ公表 A13/A12を29年投入へ
- DRAM不足で変わるAIシステム設計 エッジAIや特化型モデルに追い風
- ソニーセミコンとTSMCが合弁会社設立を検討
- 半導体検査装置向けレンズの研磨工程が稼働、生産能力2.6倍に
- 26年3月の世界半導体市場は79%増、日本も10カ月ぶりプラス成長
Special SitePR
あなたにおすすめの記事PR
