半導体チップの高密度3次元積層を加速するハイブリッド接合:福田昭のデバイス通信(442) 2022年度版実装技術ロードマップ(66)(1/2 ページ)
今回から、第3章第4節(3.4)「パッケージ組立プロセス技術動向」の内容を紹介する。本稿では、ハイブリッドボンディングを解説する。
パッケージを組み立てるための要素技術
電子情報技術産業協会(JEITA)が3年ぶりに実装技術ロードマップを更新し、「2022年度版 実装技術ロードマップ」(書籍)を2022年7月に発行した。本コラムではロードマップの策定を担当したJEITA Jisso技術ロードマップ専門委員会の協力を得て、ロードマップの概要を本コラムの第377回からシリーズで紹介している。
前回は第3章第3節第10項(3.3.10)「その他の表面実装パッケージ」の概要を報告した。今回から、第3章第4節(3.4)「パッケージ組立プロセス技術動向」の内容説明に入る。第3章第4節は、第1項から第9項までの9個の項目で構成される。内容は、パッケージを組み立てるための要素技術の説明である。
今回は第3章第4節第2項(3.4.2)「ハイブリッドボンディング」の概要をご報告する。「ハイブリッドボンディング」は「ハイブリッド接合」とも呼ばれる。シリコンのウエハー同士を重ね合わせる、あるいはシリコンダイ(チップ)をシリコンウエハーに載せることで両者を接続する。接続はダイレクトであり、バンプやはんだボールなどの接続用電極は不要である。
ハイブリッドボンディング(ハイブリッド接合)の特徴は、原理的に接続ピッチを狭くできることだ。バンプ接続やボール接続などではバンプやボールなどの接続用電極の大きさが接続ピッチを制限する。ハイブリッド接合はシリコン表面に形成する銅電極(Cu電極)が接続電極となる。このため、シリコンウエハーのプロセス技術によって微細な電極を作れる。
絶縁膜と電極が異なる原理で接合を形成
ハイブリッド接合における接続面は電極部分と絶縁膜部分で構成される。絶縁膜には二酸化シリコン(SiO2)、テトラエトキシシラン(TEOS:tetra ethoxy silane)、SiCNなどが使われる。表面は電極部分がわずかにへこむように形成する。
接合工程について簡単に説明しよう。始めは活性化処理によって表面の絶縁膜を親水化する。それから常温で2枚のウエハーを圧着する。すると相対する絶縁膜の表面同士が一部でシロキサン結合を形成して接合する。続いて300℃〜400℃のアニーリングを実施する。絶縁膜の接合部界面付近の水分が拡散して欠陥を埋めることで共有結合部が増え、接合強度が高まる。一方、絶縁膜の収縮によって相対する電極表面が接触し、電極表面の銅(Cu)が相互拡散して接合を形成する。
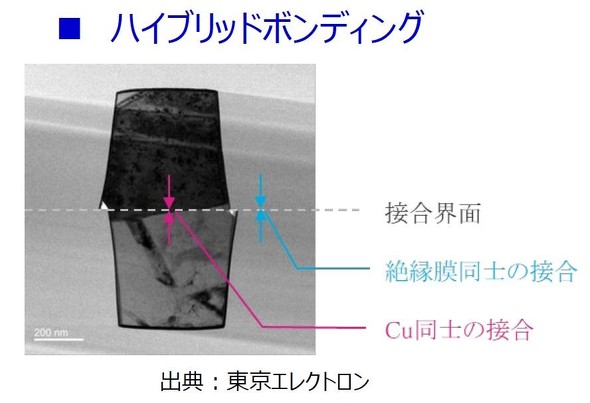 ハイブリッドボンディング(ハイブリッド接合)の接合界面を透過型電子顕微鏡(TEM)で観察した画像。画像提供:東京エレクトロン[クリックで拡大] 出所:JEITA Jisso技術ロードマップ専門委員会(2022年7月7日に開催された完成報告会のスライド)
ハイブリッドボンディング(ハイブリッド接合)の接合界面を透過型電子顕微鏡(TEM)で観察した画像。画像提供:東京エレクトロン[クリックで拡大] 出所:JEITA Jisso技術ロードマップ専門委員会(2022年7月7日に開催された完成報告会のスライド)このように絶縁膜と電極が異なる原理で接合を形成することから、「ハイブリッドボンディング(ハイブリッド接合)」と呼ばれる。
Copyright © ITmedia, Inc. All Rights Reserved.
記事ランキング
- 「世界初」成果で1000層超3Dフラッシュに道筋、キオクシアとSandisk
- ナフサ危機で迫る「レジスト供給途絶」――世界の半導体工場を停止させる、もう一つの臨界点
- 次世代パワー半導体 「期待の5材料」の現在地
- パワー半導体世界市場、2035年は7兆円超え 酸化ガリウムも一定規模に
- 入学した瞬間終わったわ――「講義が英語」なんて一言も聞いてない!
- TSMCが次世代ロードマップ公表 A13/A12を29年投入へ
- SK hynixの四半期決算、驚異の売上高営業利益率70%超え
- 「データの死蔵に耐えられないエンジニア」がたどり着いたMASの沼
- TED、25年度は減収減益 「各事業磨き上げる」と新社長
- 村田製作所、25年度は売上高が過去最高 データセンター向けは70%増

