EE Times Japan >
プロセス技術 >
ASMLがEUVリソグラフィ開発の最新状況を公表(1)〜ArF液浸の限界:SEMICON West 2015リポート(4)(2/2 ページ)
» 2015年08月24日 10時00分 公開
[福田昭,EE Times Japan]
10nm世代でもEUVがArF液浸に比べて良好なパターンを形成
ArF液浸リソグラフィとEUVリソグラフィを比較すると、重要な違いがもう1つ存在する。ニコンの講演でも指摘されていた、レイアウトのパターンとレジスト露光パターンのずれ(EPE:Edge Placement Error)である。
Lercel氏は講演で、ArF液浸のトリプルパターニング(LELELE方式)とEUVのシングルパターニングを第1層金属配線のリソグラフィで比較したスライドを見せていた。縦48nmピッチ×横48nmピッチの最小ピッチで配線パターンを形成した事例である。両者のパターンは明確に違う。EUVのシングルパターニングによる配線パターンが、レイアウトのパターンに近い。ArF液浸のトリプルパターニング(LELELE方式)による配線パターンは、かなり劣る。
この事例のロジック配線は、10nm世代に相当する。10nm世代でも、EUVリソグラフィが良好なパターンを形成しやすい。ArF液浸リソグラフィ(マルチパターニング)は、かなり無理をしていることが分かる。
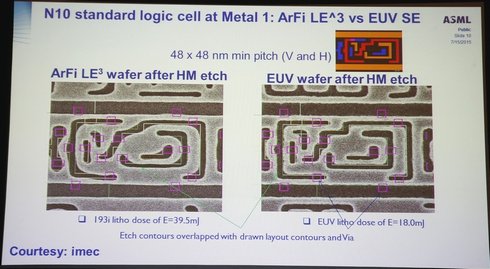 10nm世代のロジック配線を異なるリソグラフィ技術で形成した結果。左はArF液浸のトリプルパターニング(LELELE方式)で形成したもの。右はEUVのシングルパターニングで形成したもの。EUV露光装置には、ASMLが開発した装置を使用した(クリックで拡大)
10nm世代のロジック配線を異なるリソグラフィ技術で形成した結果。左はArF液浸のトリプルパターニング(LELELE方式)で形成したもの。右はEUVのシングルパターニングで形成したもの。EUV露光装置には、ASMLが開発した装置を使用した(クリックで拡大)(次回に続く)
関連記事
- ⇒「福田昭のデバイス通信」バックナンバーはこちら
 ARMから見た7nm CMOS時代のCPU設計(1)
ARMから見た7nm CMOS時代のCPU設計(1)
ARMにとって「IEDM」は非常に重要だ。この会議で議論されるトランジスタ技術が同社のCPUアーキテクチャの行方を左右するからである。ARMは「IEDM 2014」で、CPU設計とデバイス・プロセス技術の関わりを解説する講義を行った。今回から、その内容を複数回にわたってお届けする。 「20nmプロセスはダブルパターニングがコスト増要因に」、TSMCのCTOが明かす
「20nmプロセスはダブルパターニングがコスト増要因に」、TSMCのCTOが明かす
TSMCは、20nmプロセスの試験生産を2012年第3四半期から開始する。しかし、同プロセスに採用したダブルパターニングによって、28nmプロセスと比べて製造コストが増える見込みだ。 FinFET以降の半導体製造技術はどう進む? IBMの見解
FinFET以降の半導体製造技術はどう進む? IBMの見解
「Common Platform Technology Forum」において、IBMが半導体製造技術の将来展望について発表を行った。液浸リソグラフィによるダブルパターニング技術やFD-SOI技術に加え、カーボンナノチューブ、シリコンフォトニクス、ナノワイヤーなどのキーワードを交えて半導体製造の将来像や課題などが示された。
Copyright © ITmedia, Inc. All Rights Reserved.
Special ContentsPR
特別協賛PR
スポンサーからのお知らせPR
Special ContentsPR
Pickup ContentsPR
記事ランキング
- 「世界初」成果で1000層超3Dフラッシュに道筋、キオクシアとSandisk
- ナフサ危機で迫る「レジスト供給途絶」――世界の半導体工場を停止させる、もう一つの臨界点
- 次世代パワー半導体 「期待の5材料」の現在地
- 入学した瞬間終わったわ――「講義が英語」なんて一言も聞いてない!
- パワー半導体世界市場、2035年は7兆円超え 酸化ガリウムも一定規模に
- SK hynixの四半期決算、驚異の売上高営業利益率70%超え
- 「データの死蔵に耐えられないエンジニア」がたどり着いたMASの沼
- TSMCが次世代ロードマップ公表 A13/A12を29年投入へ
- 村田製作所、25年度は売上高が過去最高 データセンター向けは70%増
- パワー停滞も光デバイス堅調、三菱電機の半導体部門
Special SitePR
あなたにおすすめの記事PR
