モバイル向け小型薄型パッケージ「InFO」が進化:福田昭のデバイス通信(330) TSMCが開発してきた最先端パッケージング技術(3)
TSMCが開発してきた先進パッケージング技術の最新動向を紹介する。始めは全体のトレンドを示す。
CoWoS、InFOにSoICを組み合わせる
高性能プロセッサとその関連技術に関する国際学会「Hot Chips」がことし(2021年)8月22日〜24日にオンラインで開催された。「Hot Chips」は高性能プロセッサの最新技術情報を入手できる貴重な機会として知られている。会期は3日間で、初日が「チュートリアル(Tutorials)」と呼ぶ技術講座、2日目と3日目が「カンファレンス(Conference)」と呼ぶ技術講演会となっており、講演会とは別にポスター発表の機会も用意される。オンライン開催となったことしは、あらかじめ録画されたビデオをプログラムに沿って公開する形式となった。参加登録者は開催後も一定の期間は、オンデマンドで講演を聴講できる。
初日の「チュートリアル(Tutorials)」では、13件の講演が実施された。その中で「先進パッケージング技術」に関する講演「TSMC packaging technologies for chiplets and 3D(チップレットと3次元集積に向けたTSMCのパッケージング技術)」が極めて興味深かった。講演者はTSMCで研究開発担当バイスプレジデント(現在はシステム集積化手法開発担当バイスプレジデント)をつとめるDouglas Yu氏である。
そこで本講演の概要を前々回から、シリーズでお届けしている。なお講演の内容だけでは説明が不十分なところがあるので、本シリーズでは読者の理解を助けるために、講演の内容を適宜、補足している。あらかじめご了承されたい。
前々回と前回は、半導体パッケージング技術の最先端動向を説明した。過去に半導体の集積密度向上をけん引してきた微細化だけでは、巨大化するシステムの性能を従来通りには伸ばせない。チップレット化や2.5/3次元集積化などの先進パッケージング技術の併用が不可欠となる。
 講演「TSMC packaging technologies for chiplets and 3D(チップレットと3次元集積に向けたTSMCのパッケージング技術)」のアウトライン[クリックで拡大]出所:TSMC(Hot Chips 33の講演「TSMC packaging technologies for chiplets and 3D」のスライドから)
講演「TSMC packaging technologies for chiplets and 3D(チップレットと3次元集積に向けたTSMCのパッケージング技術)」のアウトライン[クリックで拡大]出所:TSMC(Hot Chips 33の講演「TSMC packaging technologies for chiplets and 3D」のスライドから)今回からは、TSMCが開発してきた先進パッケージング技術の最新動向を紹介していく。始めは全体のトレンドを示す。
TSMCの先進パッケージング技術は、高性能コンピューティング向けの「CoWoS(Chip on Wafer on Substrate、コワース)」とモバイル向けの「InFO(Integrated Fan-Out、インフォ)」から始まった。CoWoSは2012年ころから製品に採用されており、10年の量産実績がある(参考記事:「高性能コンピューティング向けの2.nD(2.n次元)パッケージング技術」)。InFOは2016年にスマートフォン「iPhone 7」用アプリケーションプロセッサ「A10」に採用されたことで、良く知られるようになった(参考記事:「TSMC、Apple「A10/A11」をほぼ独占的に製造か」)。
 TSMCの最先端パッケージング技術とその進化。横軸は時間、縦軸は相互接続の密度とパッケージの大きさ[クリックで拡大] 出所:TSMC(Hot Chips 33の講演「TSMC packaging technologies for chiplets and 3D」のスライドから)
TSMCの最先端パッケージング技術とその進化。横軸は時間、縦軸は相互接続の密度とパッケージの大きさ[クリックで拡大] 出所:TSMC(Hot Chips 33の講演「TSMC packaging technologies for chiplets and 3D」のスライドから)CoWoSとInFOはオリジナルの開発から10年を経過しており、これまでにいくつかの派生品を生み出してきた。また最近では、SoIC(System on Integrated Chips)の開発によってCoWoSあるいはInFOとSoICを組み合わせた3次元(3D)パッケージが登場した。
フリップチップCSPよりも高性能な「InFO_B」を開発
ここからはInFOの派生品に注目しよう。InFOのオリジナルは、「InFO PoP(Package on Package)」と呼ぶInFOの上に低消費電力版DRAM(パッケージ封止品)を搭載することが標準的だった。主な用途はスマートフォンのアプリケーションプロセッサ(AP)である。APをInFOに封止してメインメモリ(DRAM)を搭載することで、1つの小型薄型モジュールにまとめていた。
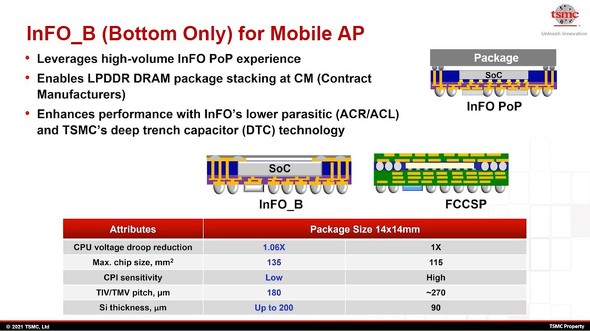 InFO PoPとInFO_B、FCCSPの概略。下の表はInFO_BとFCCSPの比較(外形寸法はいずれも14mm角)[クリックで拡大] 出所:TSMC(Hot Chips 33の講演「TSMC packaging technologies for chiplets and 3D」のスライドから)
InFO PoPとInFO_B、FCCSPの概略。下の表はInFO_BとFCCSPの比較(外形寸法はいずれも14mm角)[クリックで拡大] 出所:TSMC(Hot Chips 33の講演「TSMC packaging technologies for chiplets and 3D」のスライドから)最近では、DRAMの搭載をTSMC以外の企業で可能にした「InFO_B(Bottom Only)」を開発した(TSMCのニュースリリース)。フリップチップCSP(FCCSP)と比べ、高い性能を実現したとする。14mm角と同じ外形寸法のパッケージでInFO_BとFCCSPを比較すると、InFO_Bは電源電圧降下の抑制、収容可能なダイサイズとダイ厚みの拡大、といった点で優位に位置した。
InFOではもう1つ重要な開発に、高性能コンピューティング(HPC)向けへの改良がある。こちらについては次回以降に述べたい。
(次回に続く)
⇒「福田昭のデバイス通信」連載バックナンバー一覧
関連記事
 「システム・製造協調最適化(STCO)」の実現技術(前編)
「システム・製造協調最適化(STCO)」の実現技術(前編)
7nm以降の技術ノードでは、「設計・製造協調最適化(DTCO)」だけでなく、「システム・製造協調最適化(STCO:System Technology Co-Optimization)」も利用することでPPAあるいはPPACのバランスを調整することが求められるようになってきた。 「システム・製造協調最適化(STCO)」の実現技術(後編)
「システム・製造協調最適化(STCO)」の実現技術(後編)
本シリーズの最終回となる今回は、前回に続き「システム・製造協調最適化(STCO)」を解説する。 欧州が欧州半導体法「European Chips Act」の策定へ
欧州が欧州半導体法「European Chips Act」の策定へ
欧州委員会委員長であるUrsula von der Leyen氏が2021年9月15日(現地時間)、一般教書演説の中で、「European Chips Act(欧州半導体法)」の策定に関する発表を行った。中国政府が半導体イノベーションに数十億米ドル規模の資金を投じていることや、米国議会が半導体の戦略的価値について合意に達したことなどを受け、EUは、主体的な最先端技術の実現を目指す法案を策定し、競争に参入していく考えを表明した。 第4世代R-Car SoCも発表、ルネサスが語る車載戦略
第4世代R-Car SoCも発表、ルネサスが語る車載戦略
ルネサス エレクトロニクスは2021年10月6日、オンラインで記者説明会を実施。同社オートモーティブソリューション事業本部の事業本部長、片岡健氏が車載事業戦略について語った。 埋め込みDRAMが大容量キャッシュの製造コスト低減に貢献
埋め込みDRAMが大容量キャッシュの製造コスト低減に貢献
今回はDRAMをロジックLSIに埋め込む技術「eDRAM」の製品化事例を解説する。 前進し続けるIntel
前進し続けるIntel
Intelは2021年1月21日(米国時間)、業績発表を行った。それを見ると、同社の“終末時計”のカウントダウンに、少なくとも数秒は追加されたといえるだろう。ただし、完全に楽観視できるわけではなさそうだ。スピンドクター(情報操作が得意な人)たちは、Intelの2020年の業績のマイナス面だけを簡単に強調することができる。また、プラス面よりも欠点の方に反応を示す投資家たちもいる。
Copyright © ITmedia, Inc. All Rights Reserved.
記事ランキング
- キオクシア25年度 驚異の決算 Q4純利益は前年比30倍
- iPhone好調で過去最高も、「世界一」維持へ動くソニー半導体
- 加賀電子が新光商事にTOB、完全子会社化へ
- SiC LSIの事業化に挑む 28年以降ADCのサンプル出荷へ
- Cerebrasが上場 NVIDIA対抗馬の「試金石」となるか
- ソニーセミコンCTOに聞く――イメージセンサー技術革新の核
- AIの「トンデモ判断」で本番DBが全飛び! 他山の石にしたいAIコーディングの落とし穴
- サンケン電気26年3月期は赤字転落 中国の「自前主義」響く
- JDI、25年度Q4は4年ぶり黒字 上場廃止は「必ず阻止」
- 「技術ナンバーワンであり続ける」 ソニーセミコンCTOが語る技術戦略
