EE Times Japan >
LSI >
ウエハースケールの超巨大プロセッサを実現した「InFO」技術:福田昭のデバイス通信(333) TSMCが開発してきた最先端パッケージング技術(6)(2/2 ページ)
» 2021年11月16日 11時30分 公開
[福田昭,EE Times Japan]
数多くのシリコンダイと電源、コネクターを高い密度で相互に接続
「InFO_SoW」技術の特長は、数多くのシリコンダイで構成した大規模なシステムを、直径が300mm前後の円板状モジュール(ウエハー状モジュール)に集積していることだ。InFO技術の利用によって、従来のモジュールに比べると小型かつ高密度のシステムを実現した。
 「InFO_SoW」技術の特長(上)と構造(左下)、開発例(右下)[クリックで拡大] 出所:TSMC(Hot Chips 33の講演「TSMC packaging technologies for chiplets and 3D」のスライドから)
「InFO_SoW」技術の特長(上)と構造(左下)、開発例(右下)[クリックで拡大] 出所:TSMC(Hot Chips 33の講演「TSMC packaging technologies for chiplets and 3D」のスライドから)モジュールはウエハー状の放熱モジュール(プレート)、シリコンダイ群、InFOによる再配線層(RDL)、電源モジュール、コネクターなどで構成する。シリコンダイ群の相互接続と、シリコンダイ群と電源モジュールおよびコネクターとの電気的な接続には、RDLを介する。
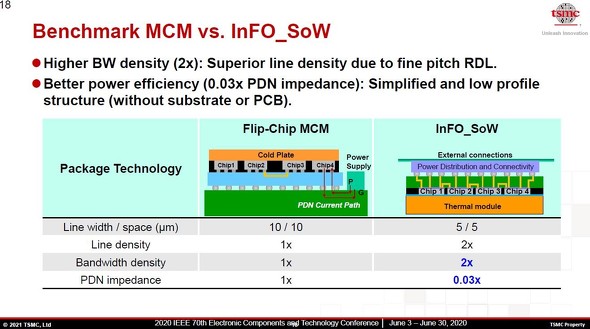 フリップチップ技術によるマルチチップモジュール(MCM)と「InFO_SoW」の比較[クリックで拡大] 出所:TSMC(Hot Chips 33の講演「TSMC packaging technologies for chiplets and 3D」のスライドから)
フリップチップ技術によるマルチチップモジュール(MCM)と「InFO_SoW」の比較[クリックで拡大] 出所:TSMC(Hot Chips 33の講演「TSMC packaging technologies for chiplets and 3D」のスライドから)講演では、フリップチップ技術によるMCM(Multi-Chip Module)とInFO_SoWの性能を比較してみせた。相互接続の配線幅/間隔はMCMの2分の1と狭くなる。配線密度は2倍に高まる。また単位面積当たりのデータ転送速度も2倍に増加する。さらに、電源供給ネットワーク(PDN)のインピーダンスはMCMのわずか3%と大幅に低くなるとする。
(次回に続く)
⇒「福田昭のデバイス通信」連載バックナンバー一覧
関連記事
 「システム・製造協調最適化(STCO)」の実現技術(前編)
「システム・製造協調最適化(STCO)」の実現技術(前編)
7nm以降の技術ノードでは、「設計・製造協調最適化(DTCO)」だけでなく、「システム・製造協調最適化(STCO:System Technology Co-Optimization)」も利用することでPPAあるいはPPACのバランスを調整することが求められるようになってきた。 「システム・製造協調最適化(STCO)」の実現技術(後編)
「システム・製造協調最適化(STCO)」の実現技術(後編)
本シリーズの最終回となる今回は、前回に続き「システム・製造協調最適化(STCO)」を解説する。 欧州が欧州半導体法「European Chips Act」の策定へ
欧州が欧州半導体法「European Chips Act」の策定へ
欧州委員会委員長であるUrsula von der Leyen氏が2021年9月15日(現地時間)、一般教書演説の中で、「European Chips Act(欧州半導体法)」の策定に関する発表を行った。中国政府が半導体イノベーションに数十億米ドル規模の資金を投じていることや、米国議会が半導体の戦略的価値について合意に達したことなどを受け、EUは、主体的な最先端技術の実現を目指す法案を策定し、競争に参入していく考えを表明した。 第4世代R-Car SoCも発表、ルネサスが語る車載戦略
第4世代R-Car SoCも発表、ルネサスが語る車載戦略
ルネサス エレクトロニクスは2021年10月6日、オンラインで記者説明会を実施。同社オートモーティブソリューション事業本部の事業本部長、片岡健氏が車載事業戦略について語った。 埋め込みDRAMが大容量キャッシュの製造コスト低減に貢献
埋め込みDRAMが大容量キャッシュの製造コスト低減に貢献
今回はDRAMをロジックLSIに埋め込む技術「eDRAM」の製品化事例を解説する。 前進し続けるIntel
前進し続けるIntel
Intelは2021年1月21日(米国時間)、業績発表を行った。それを見ると、同社の“終末時計”のカウントダウンに、少なくとも数秒は追加されたといえるだろう。ただし、完全に楽観視できるわけではなさそうだ。スピンドクター(情報操作が得意な人)たちは、Intelの2020年の業績のマイナス面だけを簡単に強調することができる。また、プラス面よりも欠点の方に反応を示す投資家たちもいる。
Copyright © ITmedia, Inc. All Rights Reserved.
Special ContentsPR
特別協賛PR
スポンサーからのお知らせPR
Special ContentsPR
Pickup ContentsPR
記事ランキング
- 中国SiCの進化「日本は追い付けないレベル」 競わず活用を
- 日本メーカー製、でも中身は……カメラなど最新6製品を分解
- Lam ResearchがPLP特化拠点 「共に未来を」とRapidus
- キオクシア25年度 驚異の決算 Q4純利益は前年比30倍
- AI半導体で「パネルは新たなフロンティア」、Lamの装置戦略
- 「ディスプレイ1本では経営厳しい」 起死回生図るJDIの戦略
- 立体配線でSiCの体積/損失を半減 富士電機の新パッケージ技術
- AI用半導体とメモリの奪い合いに 自動車業界が供給難に直面
- AI時代を切り開くNVIDIAの戦略に脱帽 受注残1兆ドル超の衝撃
- 社会人大学院生にしか見えない「ドブ板経験」と「学問」のあいだ
Special SitePR
あなたにおすすめの記事PR
