DRAM各社のプロセスを比較、さらなる微細化は可能か:メモリ/ストレージ技術(2/2 ページ)
ストレージキャパシタの微細化
ストレージキャパシタでは、3Xnm世代のセルの鍵になるのは、ZrO2の間に挟み込む、非常に薄いAl2O3の層だ。4社とも同様のマルチレイヤースタックを採用している。このマルチレイヤースタックは、ZAZ TITと呼ばれるもので、TiN/ZrO2/Al2O3/ZrO2/TiNの層から成る*1)。
*1)TiN(窒化チタン)、ZrO2(酸化亜鉛)、Al2O3(酸化アルミニウム)
薄膜のAl2O3層は、リーク電流を抑えるために、ZrO2の間に挟まれている。
3次元のシリンダ型キャパシタの絶縁体の厚さは、さらなる微細化におけるもう1つの課題だ。3XnmのDRAMセルの多くは、厚さ7〜9nmのマルチレイヤー絶縁体を用いている。将来的に1XnmクラスまでDRAMのセルアーキテクチャを微細化するには、これよりもさらに薄くすることが必須となるだろう。
Micron/Nanya以外のメーカーは、TiNプレートの上にSiGe(シリコンゲルマニウム)層がある。Micron/Nanyaは、SiGeではなくタングステン(W)層を形成している。SK-Hynixは、二重層にしたポリSiプラグをドレイン領域のストレージノードに接続している。一方のエルピーダは、二重層のタングステン/TiNとポリSiプラグを用いている。
埋め込みワード線を採用したSDRAMの多くは、アレイ領域にトリプルウェルを用いている。トリプルウェルとは、p型基板上に設けたNウェルの上に、Pウェルを形成したものである。
しかし、Micron/Nanyaの31nm SDRAMセルアレイは、4重のウェル(quadruple well)の構造を持つ。これは、n型基板にドープしたPウェルの上にNウェルを、さらにその上に浅いPウェルを形成したものだ。
PCに加え、スマートフォンやタブレット端末といったPC以外の機器での需要が高まっていることから、DRAMセルのさらなる微細化が求められている。最新のプロセス技術やリソグラフィ技術の進歩のおかげで、DRAMセルアレイは、30nm、20nmクラスまで微細化される可能性がある。
【翻訳:滝本麻貴、編集:EE Times Japan】
- Type-C対応デュアルUSBメモリ、サンディスクが7月から出荷開始
- HyperBus対応「HyperRAM」、ボード設計を簡素化しシステム性能を向上
- 「経験で設計すると失敗する」、ルネサスが提示する16nm FinFET SRAMの課題
- NANDフラッシュ、売価下落も市場規模は拡大――2014年10〜12月
- 平均レスポンスタイム1ms以下、ネットアップのオールフラッシュアレイ
- 磁気メモリの新材料が登場か――ビスマスフェライトで新方向の電気分極を発見
- 高速書き込み/読み出しと優れた耐久性を実現、UHS-I U3対応microSDカード
- 16×20mmサイズ、256GB容量のPCIe対応SSD
- スパンションがMLC NANDメモリに参入――eMMCを製品化
- BDで1ラック当たり1ペタバイトを実現、HLDSの光ディスクライブラリ
関連記事
 スピン注入式の新型MRAMがいよいよ製品化、2015年にはギガビット品が登場へ
スピン注入式の新型MRAMがいよいよ製品化、2015年にはギガビット品が登場へ
DRAMに近い高速性と書き換え耐性が得られる次世代不揮発メモリとして注目されるMRAM。これまでに製品化されていたトグル方式のMRAMは記憶容量に制約がありDRAMを置き換える応用は難しかった。この状況が変わる。大容量化の有力手段として期待がかかるスピン注入方式を使った、新型MRAMの製品化が始まった。 Samsung、1Xnm世代の128GビットNANDフラッシュ量産へ
Samsung、1Xnm世代の128GビットNANDフラッシュ量産へ
Samsung Electronicsが、1Xnm世代のNAND型フラッシュメモリの量産を開始すると発表した。だが、Samsungは同製品について、読み出し/書き込み性能や、書き換え耐性などを一切明らかにしていない。 12個の原子で磁気メモリを構成、HDDの記録密度が100倍に高まる可能性も
12個の原子で磁気メモリを構成、HDDの記録密度が100倍に高まる可能性も
わずか12個の磁性原子に1ビットの情報を記録する技術を、IBMの研究グループが開発した。現在のハードディスク装置や半導体メモリチップに比べて、100倍以上もの高い記憶密度を実現できるという。
Copyright © ITmedia, Inc. All Rights Reserved.
記事ランキング
- 「世界初」成果で1000層超3Dフラッシュに道筋、キオクシアとSandisk
- ナフサ危機で迫る「レジスト供給途絶」――世界の半導体工場を停止させる、もう一つの臨界点
- 次世代パワー半導体 「期待の5材料」の現在地
- パワー半導体世界市場、2035年は7兆円超え 酸化ガリウムも一定規模に
- 入学した瞬間終わったわ――「講義が英語」なんて一言も聞いてない!
- TSMCが次世代ロードマップ公表 A13/A12を29年投入へ
- SK hynixの四半期決算、驚異の売上高営業利益率70%超え
- 「データの死蔵に耐えられないエンジニア」がたどり着いたMASの沼
- TED、25年度は減収減益 「各事業磨き上げる」と新社長
- 村田製作所、25年度は売上高が過去最高 データセンター向けは70%増

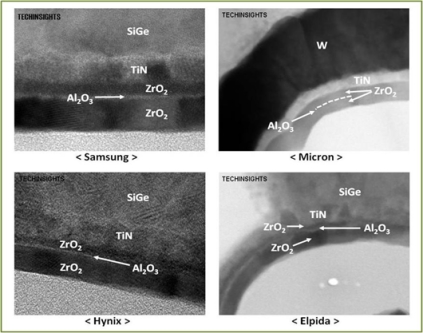 各社のメモリセルのプレート/絶縁体の構造
各社のメモリセルのプレート/絶縁体の構造